Московский государственный технический университет
им. Н.Э.Баумана
Калужский
филиал
Ю.П.Головатый
ОСНОВЫ ПОЛУПРОВОДНИКОВОЙ ЭЛЕКТРОНИКИ
Калуга
СОДЕРЖАНИЕ
7. Полупроводниковая электроника
7.1.
Генерация и рекомбинация носителей заряда
7.2.
Равновесные концентрации носителей
7.3.
Токи и поля в полупроводниках
7.3.1.
Дрейфовые и диффузионные токи
7.3.2.
Полупроводник в однородном электрическом поле
7.4.
Уравнения для зарядов, токов и полей в полупроводниках
7.5.
Электрические переходы
7.5.1.
Классификация электрических переходов
7.5.2.
Методы формирования p-n - переходов
7.5.2.1.
Сплавные p-n - переходы
7.5.2.2.
Диффузионные p-n – переходы
7.5.2.3.
Эпитаксиальные p-n – переходы
7.5.2.4.
Имплантированные p-n – переходы
7.6.Физика p-n – перехода
7.6.1. Процессы в неравновесном p-n – переходе
7.6.1.1.
Энергетическая диаграмма
7.6.1.2.
Диффузионный потенциал
7.6.1.3.
Поле и потенциал в ОПЗ
7.6.2.
Процессы в неравновесном p-n – переходе
7.6.2.1.
Обратное смещение
7.6.2.2.
Прямое смещение
7.6.3. Вольтамперная характеристика p-n–перхода
7.6.3.1.
Идеальный p-n-переход
Шокли
7.6.3.2.
Вычисление распределения инжектированных носителей
7.6.3.3.
ВАХ идеального p-n –перехода
7.6.3.4.
ВАХ реального p-n – перехода
7.6.3.5.
Пробой p-n – перехода
7.6.4. Реакция p-n – перехода на переменное смещение
7.6.4.1 Прямое гармоническое смещение
7.6.4.2.
Обратное гармоническое смещение
7.6.4.3.Импульсное
смещение
7.6.5. Полупроводниковые диоды
7.6.5.1.
Выпрямительные диоды
7.6.5.2.
Стабилитроны
7.6.5.3.
Импульсные диоды
7.6.5.4.
Высокочастотные диоды
7.6.5.5.
Варикапы
7.6.5.6.
Другие типы диодов
7.
ПОЛУПРОВОДНИКОВАЯ ЭЛЕКТРОНИКА
Полупроводниковая электроника использует для преобразования энергии и
обработки информации эффекты, возникающие при протекании тока в полупроводниковых
структурах. Для анализа этих эффектов необходимо знать, сколько при данных
условиях имеется в полупроводнике носителей заряда – электронов и дырок, и
каков механизм их движения, или переноса, в структуре. Поэтому вначале мы рассмотрим последовательно механизмы
образования свободных носителей заряда, способы расчёта их концентраций,
механизмы переноса и математические уравнения, описывающие перенос и распределение
носителей в полупроводниках. Эти представления будут затем использованы при
анализе полупроводниковых диодов и транзисторов.
7.1.
ГЕНЕРАЦИЯ И РЕКОМБИНАЦИЯ НОСИТЕЛЕЙ ЗАРЯДА
Свободные носители заряда в полупроводниках образуются
в результате отрыва электронов от собственных или примесных атомов. Этот
процесс называется генерацией носителей и на энергетической диаграмме представляется
следующим образом (рис. 7.1).

Рис. 7.1 Процессы генерации носителей заряда
в полупроводнике
Генерация
носителей может происходить под воздействием тепловых колебаний атомов,
поглощённого электромагнитного излучения или быстрых частиц - электронов и ионов. Количественно процесс
генерации характеризуется скоростью
генерации G – числом пар
заряженных частиц, создаваемых в единице объёма за единицу времени (обычно за 1
с). Размерность ![]() или
или ![]() . Скорость генерации можно
представить в виде суммы вкладов различных по физической природе источников,
. Скорость генерации можно
представить в виде суммы вкладов различных по физической природе источников,
![]() (7.1.1)
(7.1.1)
где
![]() - скорость тепловой генерации,
- скорость тепловой генерации, ![]() - скорость генерации фотонами,
- скорость генерации фотонами, ![]() - скорость генерации быстрыми электронами,
- скорость генерации быстрыми электронами, ![]() - скорость
генерации энергичными ионами.
- скорость
генерации энергичными ионами.
Мощность парциальных источников определяются внешними
факторами – температурой, энергиями частиц и фотонов и плотностями их потоков.
По крайней мере, один из источников – тепловая генерация – действует постоянно,
однако опыт показывает, что концентрации носителей остаются при данных условиях
постоянными. Это указывает на существование процесса, обратного генерации – рекомбинации носителей. Рекомбинация состоит
в исчезновении пары свободных носителей и образовании заполненной химической
связи между собственными атомами. Она может происходить по двум механизмам.
Свободные носители – электрон и дырка – в процессе
хаотического теплового движения могут оказаться столь близко друг от друга, что
кулоновское притяжение не позволит им разойтись вновь, и они сольются с образованием
нейтральной химической связи. Такая рекомбинация называется межзонной. Вероятность межзонной
рекомбинации тем выше, чем больше концентрации и электронов, и дырок. Количественно
она характеризуется скоростью межзонной рекомбинации ![]() - числом пар электрон-дырка, рекомбинирующих в
единице объёма за одну секунду. Размерность её такая же, как и у скорости
генерации.
- числом пар электрон-дырка, рекомбинирующих в
единице объёма за одну секунду. Размерность её такая же, как и у скорости
генерации.
Второй механизм рекомбинации действует через
посредника – примесный атом, отличный от легирующих примесей. Посредник служит ловушкой – он захватывает свободный
носитель одного типа, который является неосновным в данном полупроводнике, и удерживает его некоторое время. Таковы,
например, атомы золота, меди, марганца в кремнии. За время удержания к ловушке
успеет приблизиться основной носитель противоположного знака и
прорекомбинировать с ранее захваченным носителем. Такая рекомбинация называется
рекомбинацией через ловушки. Она, как
видим, состоит из двух этапов. Скорость её ![]() определяется скоростью первого захвата - она
тем выше, чем больше концентрация неосновных носителей и концентрация атомов-ловушек.
Второй захват происходит намного быстрее, так как концентрация основных носителей намного
больше концентрации неосновных. Межзонная рекомбинация и рекомбинация через
ловушки изображены на рис. 7.2.
определяется скоростью первого захвата - она
тем выше, чем больше концентрация неосновных носителей и концентрация атомов-ловушек.
Второй захват происходит намного быстрее, так как концентрация основных носителей намного
больше концентрации неосновных. Межзонная рекомбинация и рекомбинация через
ловушки изображены на рис. 7.2.
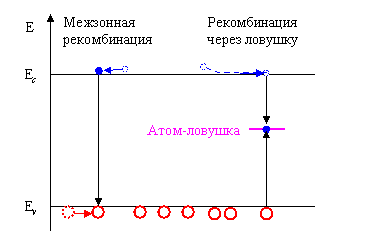
Рис.
7.2. Два механизма рекомбинации
электронов и дырок
Суммарная скорость рекомбинации ![]() равна сумме скоростей межзонной рекомбинации и
рекомбинации через ловушки
равна сумме скоростей межзонной рекомбинации и
рекомбинации через ловушки
![]() (7.1.2)
(7.1.2)
В
реальном полупроводнике, как правило, доминирует одно из слагаемых. В кремнии
рекомбинация идёт по второму механизму, тогда как в арсениде галлия – по
первому. Причина кроется в особенностях электронной структуры полупроводников,
по которым кремний и арсенид галлия относятся к разным типам полупроводников. Эти
вопросы изучаются в курсе «Физика
твёрдого тела».
В результате одновременного протекания процессов
генерации и рекомбинации в полупроводнике устанавливаются стационарные, то есть
не зависящие от времени при неизменных внешних условиях, концентрации
электронов ![]() и дырок
и дырок ![]() . Рассмотрим процесс установления
стационарного состояния подробнее и введём важные параметры этого процесса.
. Рассмотрим процесс установления
стационарного состояния подробнее и введём важные параметры этого процесса.
Пусть рекомбинация идёт только через ловушки. Её
скорость пропорциональна частоте встреч неосновных носителей (будем считать,
что ими являются электроны) с ловушками, которая, в свою очередь, пропорциональна
произведению концентраций электронов ![]() и ловушек
и ловушек ![]() ,
,
![]() (7.1.3)
(7.1.3)
где
![]() - коэффициент пропорциональности, называемый
коэффициентом рекомбинации. Его размерность
- коэффициент пропорциональности, называемый
коэффициентом рекомбинации. Его размерность ![]() или
или ![]() . Условием установления
стационарной концентрации
. Условием установления
стационарной концентрации ![]() является равенство скоростей генерации и
рекомбинации
является равенство скоростей генерации и
рекомбинации
![]() (7.1.4)
(7.1.4)
или ![]() (7.1.5)
(7.1.5)
Из
всех источников генерации только один – тепловая генерация - является постоянно
действующим. В то время как другие источники легко выключить, тепловая
генерация прекращается только при очень низких температурах, далеко за
пределами практически важной области рабочих температур. При умеренных
температурах под действием теплового движения в полупроводнике устанавливаются
стационарные концентрации носителей, являющиеся, с точки зрения термодинамики, равновесными. Все остальные источники
генерации создают неравновесные носители. Равновесные концентрации носителей
обозначаются ![]() и
и ![]() . Из (7.5) получаем
. Из (7.5) получаем
![]() (7.1.6)
(7.1.6)
Предположим,
что нетепловые источники действовали до момента времени ![]() , создали стационарные концентрации
носителей
, создали стационарные концентрации
носителей ![]() и
и ![]() , а затем выключились.
Концентрации электронов и дырок начнут убывать, стремясь к
, а затем выключились.
Концентрации электронов и дырок начнут убывать, стремясь к ![]() и
и ![]() . Изменение концентраций во
времени описывается уравнением
. Изменение концентраций во
времени описывается уравнением
![]() (7.1.7)
(7.1.7)
В
(7.1.7) введено обозначение
![]() (7.1.8)
(7.1.8)
Решение
уравнения (7.1.7) тривиально,
![]() (7.1.9)
(7.1.9)
Величина
![]() имеет размерность времени,
имеет размерность времени,
![]() .
.
За
![]() секунд концентрация избыточных неосновных
носителей
секунд концентрация избыточных неосновных
носителей ![]() уменьшается в
уменьшается в ![]() раз, поэтому
раз, поэтому ![]() называется
временем жизни электронов в полупроводнике p-типа. Рекомбинацию носителей можно в равной степени
характеризовать как временем жизни, так и коэффициентом рекомбинации. Физический смысл последнего установим из
соотношения (7.1.8). При
называется
временем жизни электронов в полупроводнике p-типа. Рекомбинацию носителей можно в равной степени
характеризовать как временем жизни, так и коэффициентом рекомбинации. Физический смысл последнего установим из
соотношения (7.1.8). При ![]() имеем
имеем ![]() , то есть коэффициент рекомбинации численно равен обратному времени жизни
неосновного носителя в полупроводнике с одной ловушкой в единице объёма. По
порядку величины время жизни носителей при рекомбинации через ловушки
составляет
, то есть коэффициент рекомбинации численно равен обратному времени жизни
неосновного носителя в полупроводнике с одной ловушкой в единице объёма. По
порядку величины время жизни носителей при рекомбинации через ловушки
составляет ![]() .
.
Аналогично можно рассмотреть и кинетику межзонной
рекомбинации. Пусть начальное состояние создаётся так же, как и в предыдущем
случае. Тогда имеем уравнение
![]() (7.1.10)
(7.1.10)
В течение
некоторого времени концентрации избыточных носителей намного больше равновесных
концентраций, ![]() ,
, ![]() , причём
, причём ![]() , поэтому уравнение (7.1.10) упрощается,
, поэтому уравнение (7.1.10) упрощается,
![]()
![]() (7.1.11)
(7.1.11)
Решение
уравнения (7.11) имеет вид
![]() (7.1.12)
(7.1.12)
то
есть при межзонной рекомбинации концентрации неравновесных носителей убывают на
первом этапе по гиперболическому закону.
Когда они уменьшатся настолько, что ![]() ,
, ![]() тогда уравнение (7.1.10) также можно
упростить,
тогда уравнение (7.1.10) также можно
упростить,
![]()
![]() (7.1.13)
(7.1.13)
где
![]() . Решение снова имеет
экспоненциальный характер,
. Решение снова имеет
экспоненциальный характер,
![]() (7.1.14)
(7.1.14)
а ![]() есть
время жизни неравновесных носителей при межзонной рекомбинации. По порядку
величины время жизни при межзонной рекомбинации
в
есть
время жизни неравновесных носителей при межзонной рекомбинации. По порядку
величины время жизни при межзонной рекомбинации
в ![]() составляет
составляет ![]() .
.
При рекомбинации электрон переходит в валентную зону,
следовательно, его энергия скачком меняется на ![]() . Судьба этой выделившейся
энергии различна при межзонной рекомбинации и рекомбинации через ловушки. В
первом случае она передаётся кристаллической решётке в виде колебаний атомов и
в конечном итоге превращается в тепловую энергию, кристалл немного нагреется.
Во втором случае эта энергия выделяется в виде кванта электромагнитного
излучения - фотона. Фотон может с заметной вероятностью покинуть кристалл, который,
таким образом, превращается в источник излучения.
. Судьба этой выделившейся
энергии различна при межзонной рекомбинации и рекомбинации через ловушки. В
первом случае она передаётся кристаллической решётке в виде колебаний атомов и
в конечном итоге превращается в тепловую энергию, кристалл немного нагреется.
Во втором случае эта энергия выделяется в виде кванта электромагнитного
излучения - фотона. Фотон может с заметной вероятностью покинуть кристалл, который,
таким образом, превращается в источник излучения.
7.2.
РАВНОВЕСНЫЕ КОНЦЕНТРАЦИИ НОСИТЕЛЕЙ
Значения равновесных концентраций носителей абсолютно
необходимы для оценки свойств
полупроводников. Поэтому важно уметь вычислять их по известным параметрам
полупроводника. Это можно сделать следующим образом.
Пусть в полупроводнике имеется ![]() электронов и
электронов и ![]() дырок. Они распределены
определённым образом по энергетическим уровням зоны проводимости и валентной
зоны соответственно. Число уровней в зонах порядка
дырок. Они распределены
определённым образом по энергетическим уровням зоны проводимости и валентной
зоны соответственно. Число уровней в зонах порядка ![]() , поэтому не все из них заняты носителями, концентрации
которых редко превосходят
, поэтому не все из них заняты носителями, концентрации
которых редко превосходят ![]() . Подсчитать число носителей в
зоне можно, если разбить её на одинаковые энергетические интервалы, найти число
носителей в каждом интервале, а затем просуммировать полученные числа.
Разбиение зоны проводимости на интервалы и их заполнение электронами показано
на рис. 7.3.
. Подсчитать число носителей в
зоне можно, если разбить её на одинаковые энергетические интервалы, найти число
носителей в каждом интервале, а затем просуммировать полученные числа.
Разбиение зоны проводимости на интервалы и их заполнение электронами показано
на рис. 7.3.

Рис. 7.3. К подсчёту равновесной концентрации электронов
Если
интервалы достаточно малы, то каждый из них можно характеризовать одним
значением энергии ![]() . Число уровней неодинаково в
разных интервалах, поэтому обозначим его
. Число уровней неодинаково в
разных интервалах, поэтому обозначим его ![]() для интервала в
окрестности энергии
для интервала в
окрестности энергии ![]() . Оно тем больше, чем больше
интервал
. Оно тем больше, чем больше
интервал ![]() , и для малых интервалов может быть представлено
в виде
, и для малых интервалов может быть представлено
в виде
![]() (7.2.1)
(7.2.1)
где
![]() - плотность
состояний, то есть число уровней энергии в пересчёте на единичный интервал
энергии
- плотность
состояний, то есть число уровней энергии в пересчёте на единичный интервал
энергии ![]() . Вероятность обнаружить
электрон на одном из уровней также не
одинакова для разных интервалов. По определению, вероятность
. Вероятность обнаружить
электрон на одном из уровней также не
одинакова для разных интервалов. По определению, вероятность![]() обнаружить электрон в интервале
энергий
обнаружить электрон в интервале
энергий ![]() равна отношению числа электронов с энергиями в
этом интервале к числу уровней энергии
равна отношению числа электронов с энергиями в
этом интервале к числу уровней энергии ![]() в нём,
в нём,
![]() (7.2.2)
(7.2.2)
Из
(7.2.1) и (7.2.2) находим
![]() (7.2.3)
(7.2.3)
Суммарное
число электронов в зоне проводимости в единице объёма полупроводника равно
![]() (7.2.4)
(7.2.4)
Переходя
к пределу ![]() , получаем окончательно,
, получаем окончательно,
 (7.2.5)
(7.2.5)
Совершенно
аналогично можно получить выражение для концентрации свободных дырок в
валентной зоне,
 (7.2.6)
(7.2.6)
В
(7.2.6) ![]() - функция распределения дырок по энергиям,
- функция распределения дырок по энергиям, ![]() - плотность состояний в валентной зоне,
- плотность состояний в валентной зоне, ![]() - минимальная энергия (дно) валентной зоны.
- минимальная энергия (дно) валентной зоны.
В теории полупроводников показывается, что зонные
плотности состояний равны
 (7.2.7)
(7.2.7)
 (7.2.8)
(7.2.8)
Величины
![]() и
и ![]() называются эффективными
зонными плотностями состояний,
называются эффективными
зонными плотностями состояний, ![]() и
и ![]() суть
эффективные массы плотности состояний зоны проводимости и валентной зоны
соответственно. Установим размерности
суть
эффективные массы плотности состояний зоны проводимости и валентной зоны
соответственно. Установим размерности ![]() и
и ![]() :
:
 ,
,
![]()
Графики
функций ![]() и
и ![]() показаны на рис. 7.4.
показаны на рис. 7.4.
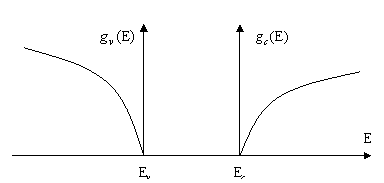
Рис. 7.4 Зонные плотности состояний
Видно,
что ![]() , то есть плотность уровней на
дне зоны проводимости и у потолка валентной зоны равна нулю. Но производные
равны бесконечности, поэтому при
, то есть плотность уровней на
дне зоны проводимости и у потолка валентной зоны равна нулю. Но производные
равны бесконечности, поэтому при ![]() или
или ![]() плотность уровней конечна и весьма велика.
плотность уровней конечна и весьма велика.
Согласно статистической термодинамике, в
состоянии термодинамического равновесия электроны распределены по энергиям в
соответствии с функцией распределения Ферми-Дирака
 (7.2.9)
(7.2.9)
где
![]() - параметр с размерностью энергии, называемый уровнем Ферми. Функция
- параметр с размерностью энергии, называемый уровнем Ферми. Функция ![]() даёт вероятность обнаружить дырку на уровне энергии
даёт вероятность обнаружить дырку на уровне энергии ![]() , что эквивалентно вероятности
отсутствия электрона на этом уровне, поэтому
, что эквивалентно вероятности
отсутствия электрона на этом уровне, поэтому
 (7.2.10)
(7.2.10)
Подставим
(7.2.9) и (7.2.7) в выражение для концентрации электронов (7.2.5),


Сделав естественную замену переменной ![]() , получим
, получим
![]() (7.2.11)
(7.2.11)
В
интеграле верхний предел положен равным ![]() , поскольку при
, поскольку при ![]() подынтегральное выражение стремится к нулю и
вносимая погрешность пренебрежимо мала. Концентрация электронов определяется,
таким образом, безразмерным параметром
подынтегральное выражение стремится к нулю и
вносимая погрешность пренебрежимо мала. Концентрация электронов определяется,
таким образом, безразмерным параметром ![]() . Функция
. Функция ![]() называется интегралом
Ферми индекса
называется интегралом
Ферми индекса ![]() .
.
Аналогично, подставив (7.2.10) и (7.2.8) в (7.2.6), получим для концентрации
дырок


![]() (7.2.12)
(7.2.12)
где
![]() .
.
Множители ![]() и
и ![]() задают масштабы концентраций носителей.
Вычислим их для
задают масштабы концентраций носителей.
Вычислим их для ![]() ,
, ![]() , и
, и ![]() . С этой целью преобразуем формулы
и (
. С этой целью преобразуем формулы
и (![]() ) , выделив явно отношения
эффективных масс
) , выделив явно отношения
эффективных масс ![]() и
и ![]() к массе свободного электрона
к массе свободного электрона ![]() и температуры
и температуры
![]() к нормальной
к нормальной ![]() температуре,
температуре,
 (
(![]() )
)
Характерную
концентрацию ![]() , образованную
фундаментальными постоянными
, образованную
фундаментальными постоянными ![]() , можно вычислить раз и навсегда,
, можно вычислить раз и навсегда,

Эффективные
массы возьмём из справочной литературы [ ]. При ![]() получаем:
получаем:
|
|
Ge |
Si |
GaAs |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Формулы (7.2.11) и (7.2.12) позволяют вычислить
концентрации носителей, если известно
положение уровня Ферми относительно дна зоны проводимости или потолка валентной
зоны.
Обсудим поэтому физическую интерпретацию уровня Ферми
и методы его определения. Ранее мы использовали функцию распределения
Ферми-Дирака при изучении термоэлектронной эмиссии из металла. Параметр ![]() назывался там энергией Ферми и
интерпретировался как максимальная энергия электронов в металле при температуре,
стремящейся к абсолютному нулю. Выше
назывался там энергией Ферми и
интерпретировался как максимальная энергия электронов в металле при температуре,
стремящейся к абсолютному нулю. Выше ![]() все уровни считались свободными, а все уровни
ниже
все уровни считались свободными, а все уровни
ниже ![]() - занятыми электронами. При повышении
температуры происходит возбуждение электронов с уровней под
- занятыми электронами. При повышении
температуры происходит возбуждение электронов с уровней под ![]() на уровни, лежащие над
на уровни, лежащие над ![]() . Но при этом вероятность обнаружить электрон на самом
уровне
. Но при этом вероятность обнаружить электрон на самом
уровне ![]() всегда
равна
всегда
равна ![]() , как это следует
непосредственно из (7.2.9). Для металлов это не формальный результат, поскольку
концентрация электронов в них огромна, из-за чего они и занимают интервал
энергий
, как это следует
непосредственно из (7.2.9). Для металлов это не формальный результат, поскольку
концентрация электронов в них огромна, из-за чего они и занимают интервал
энергий ![]() , и практически не зависит от
температуры. Поэтому уровень Ферми для металла можно вычислить, рассматривая (7.2.12) как уравнение относительно
, и практически не зависит от
температуры. Поэтому уровень Ферми для металла можно вычислить, рассматривая (7.2.12) как уравнение относительно ![]() с заданным значением n.
с заданным значением n.
Иная ситуация
имеет место в полупроводниках. Концентрации электронов и дырок в них определяются одним
и тем же уровнем Ферми, при этом они могут
быть сравнимыми по величине. Это возможно только если уровень Ферми лежит между потолком валентной зоны и дном
зоны проводимости, ![]() . Но электроны не могут
обладать энергиями, принадлежащими запрещённой зоне. Поэтому интерпретация
. Но электроны не могут
обладать энергиями, принадлежащими запрещённой зоне. Поэтому интерпретация ![]() является чисто формальной, не имеющей
физического смысла. Реальный же физический смысл уровня Ферми состоит в том, что он
является термодинамическим параметром, характеризующим
равновесие относительно обмена частицами между различными частями
полупроводника. В равновесном состоянии устанавливается такое
пространственное распределение носителей, при котором во всём объёме уровень Ферми одинаков. В
процессе выравнивания частицы (электроны), переходят из областей, где уровень Ферми
больше, в области, где уровень Ферми
меньше. В этом отношении уровень Ферми аналогичен двум другим
термодинамическим параметрам – температуре и давлению. Температура Т характеризует равновесие относительно
теплообмена (рис.7.5а) – при равенстве
является чисто формальной, не имеющей
физического смысла. Реальный же физический смысл уровня Ферми состоит в том, что он
является термодинамическим параметром, характеризующим
равновесие относительно обмена частицами между различными частями
полупроводника. В равновесном состоянии устанавливается такое
пространственное распределение носителей, при котором во всём объёме уровень Ферми одинаков. В
процессе выравнивания частицы (электроны), переходят из областей, где уровень Ферми
больше, в области, где уровень Ферми
меньше. В этом отношении уровень Ферми аналогичен двум другим
термодинамическим параметрам – температуре и давлению. Температура Т характеризует равновесие относительно
теплообмена (рис.7.5а) – при равенстве ![]() температур двух частей системы теплообмена
между ними нет, при
температур двух частей системы теплообмена
между ними нет, при ![]() поток тепла
поток тепла ![]() направлен от 1 к 2. Давление характеризует равновесие в составной системе
относительно обмена импульсом (рис. 7.5б). При равенстве давлений
направлен от 1 к 2. Давление характеризует равновесие в составной системе
относительно обмена импульсом (рис. 7.5б). При равенстве давлений ![]() упругая разделяющая перегородка не
деформирована, при
упругая разделяющая перегородка не
деформирована, при ![]() она деформируется потоком импульса
она деформируется потоком импульса ![]() , направленным от 1 к 2.
, направленным от 1 к 2.
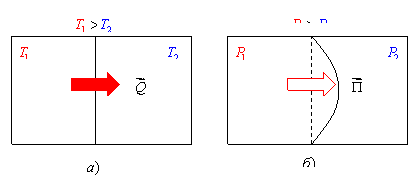
Рис.
7.5 К определению теплового и механического равновесия
Уровень Ферми, отсчитанный от дна зоны
проводимости, есть химический потенциал электронов ![]() . Уровень Ферми, отсчитанный от потолка валентной зоны,
есть химический потенциал дырок
. Уровень Ферми, отсчитанный от потолка валентной зоны,
есть химический потенциал дырок ![]() . Для измерения
температуры и давления имеются удобные приборы – термометр и манометр. Хотелось
бы иметь аналогичный прибор для измерения уровня Ферми, который можно было бы
назвать «фермометром». Но, оказывается, построить универсальный материальный
фермометр нельзя. Причина заключается в том, что помимо большого сходства,
между температурой и давлением, с одной стороны, и уровнем Ферми, с другой
стороны, существует глубокое различие. Измерение температуры и давления связано
с передачей движения от термодинамической системы к измерительному прибору. При
измерении температуры передаётся хаотическое движение, при измерении давления –
направленное движение. Можно сказать, что температура и давление имеют явную
кинетическую природу. Химический потенциал есть энергетическая мера склонности
термодинамической системы к обмену
частицами с другой системой. Он имеет информационную природу. Для измерения егонеобходимо реализовать этот
обмен, так же, как обмен движением при измерении температуры и давления. Каждый
тип частиц характеризуется своим
химическим потенциалом, следовательно, при измерении конструкция фермометра
должна обеспечивать обмен именно этими
частицами. А поскольку частиц – молекул, атомов, носителей заряда – великое
множество, то универсальный фермометр невозможен. Значит, для каждой термодинамической
системы необходим свой фермометр. Радикальный способ решить эту задачу состоит
в том, чтобы использовать в качестве фермометра саму систему, наблюдая за
происходящим в ней процессами выравнивания химического потенциала, или, в
случае полупроводников, уровня Ферми. Непосредственно наблюдать процессы переноса
мы не можем, но результат можем зафиксировать с помощью математических
соотношений, выражающих равновесие. Эти математические соотношения позволяют вычислить химический потенциал.
. Для измерения
температуры и давления имеются удобные приборы – термометр и манометр. Хотелось
бы иметь аналогичный прибор для измерения уровня Ферми, который можно было бы
назвать «фермометром». Но, оказывается, построить универсальный материальный
фермометр нельзя. Причина заключается в том, что помимо большого сходства,
между температурой и давлением, с одной стороны, и уровнем Ферми, с другой
стороны, существует глубокое различие. Измерение температуры и давления связано
с передачей движения от термодинамической системы к измерительному прибору. При
измерении температуры передаётся хаотическое движение, при измерении давления –
направленное движение. Можно сказать, что температура и давление имеют явную
кинетическую природу. Химический потенциал есть энергетическая мера склонности
термодинамической системы к обмену
частицами с другой системой. Он имеет информационную природу. Для измерения егонеобходимо реализовать этот
обмен, так же, как обмен движением при измерении температуры и давления. Каждый
тип частиц характеризуется своим
химическим потенциалом, следовательно, при измерении конструкция фермометра
должна обеспечивать обмен именно этими
частицами. А поскольку частиц – молекул, атомов, носителей заряда – великое
множество, то универсальный фермометр невозможен. Значит, для каждой термодинамической
системы необходим свой фермометр. Радикальный способ решить эту задачу состоит
в том, чтобы использовать в качестве фермометра саму систему, наблюдая за
происходящим в ней процессами выравнивания химического потенциала, или, в
случае полупроводников, уровня Ферми. Непосредственно наблюдать процессы переноса
мы не можем, но результат можем зафиксировать с помощью математических
соотношений, выражающих равновесие. Эти математические соотношения позволяют вычислить химический потенциал.
Для полупроводников в качестве условия равновесия
используется условие
электронейтральности – суммарный электрический
заряд в выделенном объёме должен
равняться нулю. Положительными зарядами обладают дырки и
ионизованные доноры, отрицательными зарядами – электроны и ионизованные
акцепторы. Поэтому в общем случае полупроводниковый фермометр имеет вид
![]() (7.2.13)
(7.2.13)
Через
![]() обозначена концентрация заряженных доноров,
через
обозначена концентрация заряженных доноров,
через ![]() - концентрация заряженных
акцепторов. Чтобы воспользоваться фермометром
(7.2.13), необходимы выражения всех концентраций через
уровень Ферми. Для электронов и дырок они даются формулами (7.2.11) и (7.2.12).
Концентрации заряженных примесей равны произведению концентраций нейтральных
примесей (уровней легирования) на вероятность отсутствия электрона на доноре
или присутствия электрона на акцепторе,
- концентрация заряженных
акцепторов. Чтобы воспользоваться фермометром
(7.2.13), необходимы выражения всех концентраций через
уровень Ферми. Для электронов и дырок они даются формулами (7.2.11) и (7.2.12).
Концентрации заряженных примесей равны произведению концентраций нейтральных
примесей (уровней легирования) на вероятность отсутствия электрона на доноре
или присутствия электрона на акцепторе,
 (7.2.14)
(7.2.14)
 (7.2.15)
(7.2.15)
При
комнатных температурах практически все примеси, за исключением индия, можно
считать полностью ионизованными, то есть полагать ![]() ,
, ![]() .
.
В большинстве случаев приходится иметь дело с не
сильно легированными полупроводниками, у которых концентрации носителей ![]() . Уровень Ферми у них отстоит
от дна зоны проводимости или потолка валентной зоны на расстоянии, превышающем
несколько
. Уровень Ферми у них отстоит
от дна зоны проводимости или потолка валентной зоны на расстоянии, превышающем
несколько ![]() ,
,
![]()
а безразмерные химические потенциалы ![]() и
и ![]() отрицательны,
отрицательны,
![]() ,
, ![]()
Такие полупроводники называются
невырожденными. Интегралы Ферми, а,
следовательно, и формулы для вычисления концентраций носителей, при этом сильно
упрощаются. Так как ![]() , то единицей в знаменателе
интеграла Ферми можно пренебречь, после чего интегрирование выполняется
элементарно,
, то единицей в знаменателе
интеграла Ферми можно пренебречь, после чего интегрирование выполняется
элементарно,
![]()

![]()
Таким
образом, ![]() (7.2.16)
(7.2.16)
![]() (7.2.17)
(7.2.17)
Из
(7.2.16) и (7.2.17) следует, что в невырожденном полупроводнике
![]() ,
, ![]()
Эти
неравенства можно рассматривать как другое определение невырожденности
полупроводника.
Теперь можно сконструировать фермометр для
невырожденного полупроводника любого типа.
Рассмотрим собственный полупроводник. Условие
электронейтральности для него имеет вид ![]() . После подстановки (7.2.16) и
(7.2.17) получаем
. После подстановки (7.2.16) и
(7.2.17) получаем
![]() (7.2.18)
(7.2.18)
Откуда
после логарифмирования находим
![]()
![]() (7.2.19)
(7.2.19)
Так
как отношение  практически во всех полупроводниках немного
меньше единицы, то из (7.2.19) следует важнейший вывод - в собственном полупроводнике уровень Ферми
лежит вблизи средины запрещённой зоны. Подставив (7.2.19) в
(7.2.16), найдём концентрацию электронов, равную концентрации дырок, в собственном
полупроводнике
практически во всех полупроводниках немного
меньше единицы, то из (7.2.19) следует важнейший вывод - в собственном полупроводнике уровень Ферми
лежит вблизи средины запрещённой зоны. Подставив (7.2.19) в
(7.2.16), найдём концентрацию электронов, равную концентрации дырок, в собственном
полупроводнике

![]() (7.2.20)
(7.2.20)
Используя
вычисленные ранее значения эффективных зонных плотностей состояний ![]() и
и ![]() , найдём собственные
концентрации для тех же полупроводников при
, найдём собственные
концентрации для тех же полупроводников при
![]() :
:
![]()
![]()
![]()
Перемножив (7.2.16) и (7.2.17), получим
![]()
или,
с учётом (7.2.20) ![]() (7.2.21)
(7.2.21)
Это
соотношение есть закон действующих масс
применительно к электронно-дырочной подсистеме полупроводника. Согласно
ему, в данном полупроводнике произведение концентраций электронов и дырок не
зависит от уровня легирования, пока полупроводник остаётся невырожденным. Он
позволяет вычислить одну из концентраций по
известной другой и собственной концентрации.
В примесном полупроводнике уровень Ферми сдвигается в
сторону зоны основных носителей – к зоне проводимости в полупроводнике n
– типа и в сторону валентной зоны в
полупроводнике p - типа. Покажем это для первого случая.
Фермометр для полупроводника n-типа имеет
вид
![]() (7.2.21)
(7.2.21)
Подставив
в него концентрацию дырок из закона действующих масс ![]() , получим квадратное уравнение
для концентрации электронов
, получим квадратное уравнение
для концентрации электронов
![]() или
или ![]() (7.2.22)
(7.2.22)
из
которого находим
 (7.2.24)
(7.2.24)
Практически
во всех случаях ![]() , поэтому
, поэтому
![]() (7.2.25)
(7.2.25)
Подставив
в (7.2.25) n в
соответствии с (2.7.16),
![]()
и
прологарифмировав, найдём положение уровня Ферми в полупроводнике n-типа,
![]() (7.2.26)
(7.2.26)
Если
отношение ![]() лежит в пределах
лежит в пределах ![]() , то уровень Ферми располагается
на расстоянии
, то уровень Ферми располагается
на расстоянии ![]() от дна зоны проводимости. При
от дна зоны проводимости. При ![]() это составляет
это составляет ![]() , что даже для германия меньше
трети ширины запрещённой зоны.
, что даже для германия меньше
трети ширины запрещённой зоны.
7.3. ТОКИ И
ПОЛЯ В ПОЛУПРОВОДНИКАХ
7.3.1.
ДРЕЙФОВЫЕ И ДИФФУЗИОННЫЕ ТОКИ
Токи в
полупроводниках возникают при любом макроскопически упорядоченном перемещении
носителей заряда. В общем случае плотность
тока, созданного носителями одного типа,
можно представить в виде
![]() (7.3.1)
(7.3.1)
где
![]() – плотность потока носителей,
– плотность потока носителей, ![]() - их заряд. По определению, плотность потока – это число частиц,
пересекающих за единицу времени единичную площадку, перпендикулярную
направлению потока. Размерность плотности потока –
- их заряд. По определению, плотность потока – это число частиц,
пересекающих за единицу времени единичную площадку, перпендикулярную
направлению потока. Размерность плотности потока – ![]() или
или ![]() . Опыт показывает, что потоки
вызываются движущими силами. Наиболее известной и привычной движущей силой
является электрическое поле
. Опыт показывает, что потоки
вызываются движущими силами. Наиболее известной и привычной движущей силой
является электрическое поле ![]() . Под его действием все
носители одного знака приобретают одинаковые
ускорения
. Под его действием все
носители одного знака приобретают одинаковые
ускорения ![]() . Но скорость их не может
стать сколь угодно большой, так как спустя некоторое время
. Но скорость их не может
стать сколь угодно большой, так как спустя некоторое время ![]() носитель сталкивается с атомом и полностью
теряет её. График его движения имеет примерно такой вид (рис. 7.6).
носитель сталкивается с атомом и полностью
теряет её. График его движения имеет примерно такой вид (рис. 7.6).
![]()

Рис. 7.6
Мгновенная скорость отдельного носителя в поле ![]()
Максимальная
скорость в направлении поля равна ![]() . Средняя за большой
промежуток времени скорость также пропорциональна полю
. Средняя за большой
промежуток времени скорость также пропорциональна полю
![]() (7.3.2)
(7.3.2)
![]() есть подвижность носителя, а коэффициент
есть подвижность носителя, а коэффициент ![]() автоматически задаёт направление скорости в
зависимости от знака заряда носителя. С этой скоростью все носители
перемещаются в одном направлении, образуя дрейфовый
поток плотностью
автоматически задаёт направление скорости в
зависимости от знака заряда носителя. С этой скоростью все носители
перемещаются в одном направлении, образуя дрейфовый
поток плотностью
![]() (7.3.3)
(7.3.3)
и дрейфовый ток плотностью
![]() (7.3.4)
(7.3.4)
Из
(7.3.2) получаем дрейфовые скорости электронов ![]() и дырок
и дырок
![]() ,
,
![]() (
(![]() )
)
![]() (
(![]() )
)
а
из (7.3.4) – электронный ![]() и дырочный
и дырочный ![]() дрейфовые токи
дрейфовые токи
![]() (
(![]() )
)
![]() (
(![]() )
)
Формулы
(7.3.6) выражают эмпирический закон Ома в дифференциальной форме. Коэффициенты ![]() и
и ![]() есть вклады электронов и дырок в удельную
электропроводность полупроводника. Полный дрейфовый ток
есть вклады электронов и дырок в удельную
электропроводность полупроводника. Полный дрейфовый ток ![]() равен сумме электронного и дырочного токов,
равен сумме электронного и дырочного токов,
![]() (7.3.7)
(7.3.7)
Так
как локальное поле равно обратному градиенту потенциала, ![]() , то (7.3.7) примет вид
, то (7.3.7) примет вид
![]() (7.3.8)
(7.3.8)
Из
(7.3.8) следует, что дрейфовая движущая
сила возникает только при наличии разности потенциалов (![]() ).
).
Частное выражение для дрейфового тока (7.3.8), как
оказалось, может быть обобщено и распространено на токи, вызываемые другими
движущими силами. Их (движущие силы) можно представить в виде градиента некоторой
скалярной функции, характеризующей систему. Такими скалярными функциями для
полупроводника являются концентрация носителей и их температура.
При неоднородной концентрации происходит диффузионное
хаотическое перемещение носителей из области с большей концентрацией в область
с меньшей концентрацией. Ещё в 1855 году Фик установил количественный закон
диффузии – плотность диффузионного потока
пропорциональна градиенту концентрации частиц,
![]() (7.3.9)
(7.3.9)
Можно
дать наглядное молекулярное истолкование закона Фика (рис.7.7). Пусть
концентрация носителей убывает в положительном направлении оси ![]() . Подсчитаем суммарный поток
носителей через плоское сечение
. Подсчитаем суммарный поток
носителей через плоское сечение ![]() . Для этого выделим два слоя
толщиной
. Для этого выделим два слоя
толщиной ![]() , примыкающих к
, примыкающих к ![]() . В левом слое средняя
концентрация носителей равна
. В левом слое средняя
концентрация носителей равна ![]() . Они движутся хаотично, со
средней тепловой скоростью
. Они движутся хаотично, со
средней тепловой скоростью ![]() . В положительном направлении
оси
. В положительном направлении
оси ![]() движется
движется ![]() их часть.
Если толщину слоя
их часть.
Если толщину слоя ![]() выбрать равной средней длине свободного
пробега носителя
выбрать равной средней длине свободного
пробега носителя ![]() , то все они пересекут
плоскость
, то все они пересекут
плоскость ![]() , создав поток плотностью
, создав поток плотностью ![]() . В правом слое средняя концентрация носителей
равна
. В правом слое средняя концентрация носителей
равна ![]() ,
, ![]() их движется в отрицательном направлении оси
их движется в отрицательном направлении оси ![]() с той же самой тепловой скоростью
с той же самой тепловой скоростью ![]() , образуя поток плотностью
, образуя поток плотностью ![]() . Суммарная плотность потока
через сечение равна разности потоков
. Суммарная плотность потока
через сечение равна разности потоков ![]() и
и ![]() ,
,
![]()
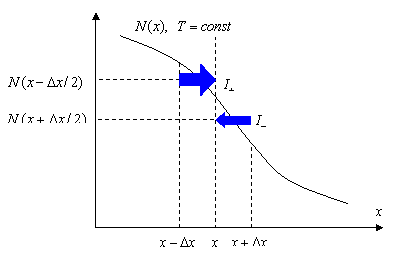
Рис. 7.7. К обоснованию
закона Фика
Разложив
концентрации в ряд Тейлора, получим закон Фика для одномерной диффузии,
![]()
![]() (7.3.10)
(7.3.10)
Коэффициент
диффузии в данной модели равен
![]() (7.3.11)
(7.3.11)
Его
размерность ![]() . Изложенные рассуждения носят
сугубо качественный характер. Они показывают, что диффузия есть следствие
теплового хаоса, дают разумный порядок величины коэффициента диффузии, но
точные его значения находят из эксперимента. Коэффициент диффузии – один из
основных параметров полупроводника наряду с подвижностью носителей, их
эффективными массами и временами жизни.
. Изложенные рассуждения носят
сугубо качественный характер. Они показывают, что диффузия есть следствие
теплового хаоса, дают разумный порядок величины коэффициента диффузии, но
точные его значения находят из эксперимента. Коэффициент диффузии – один из
основных параметров полупроводника наряду с подвижностью носителей, их
эффективными массами и временами жизни.
Из (7.3.9) получаем общее выражение для диффузионного
тока
![]() (7.3.12)
(7.3.12)
Электронный,
дырочный и полный диффузионный токи в полупроводнике равны
![]() (
(![]() )
)
![]() (
(![]() )
)
![]() (
(![]() )
)
Если
отсутствует неоднородность концентрации носителей, то есть ![]() , то и диффузионные токи равны
нулю.
, то и диффузионные токи равны
нулю.
Если в системе создана неоднородность температуры, то
имеет место явление термодиффузии –
хаотическое перемещение носителей из областей с более высокой в области с более
низкой температурой, даже если концентрация однородна. Качественное
объяснение термодиффузии можно дать аналогично обычной диффузии (рис. 7.8).
Если температура неоднородна, то тепловая скорость носителей будет зависеть от координаты через
температуру,
![]() (7.3.14)
(7.3.14)
Потоки
носителей ![]() и
и ![]() равны
равны
![]() ,
, ![]()
Суммарный
поток оказывается пропорциональным градиенту температуры,

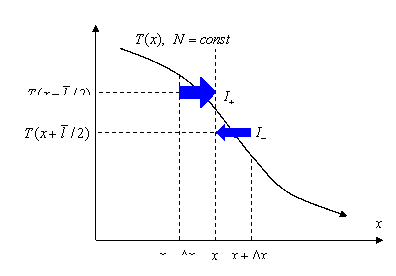
Рис. 7.8
К объяснению термодиффузии
В дискретной полупроводниковой электронике
термодиффузионные потоки не играют практически никакой роли, так как
температуру носителей можно считать постоянной по всему рабочему объёму. В тоже
время очень легко создать в полупроводнике как разность потенциалов, так и
неоднородность концентрации. Обе движущие силы будут давать вклад в полный ток,
![]() (7.3.14)
(7.3.14)
В
разных частях полупроводника соотношение между четырьмя вкладами может быть
разным – в одних может доминировать электронный диффузионный ток, в других
дырочный диффузионный ток, в третьих – дрейфовые токи.
7.3.2.
ПОЛУПРОВОДНИК В ОДНОРОДНОМ ЭЛЕКТРИЧЕСКОМ ПОЛЕ
Рассмотрим реакцию изолированного полупроводника на
однородное внешнее электростатическое поле, созданное, например, плоским конденсатором
(рис. 7.9а). Для определённости будем
считать, что полупроводник донорный, равновесная концентрация носителей в нём ![]() , размер полупроводника L в направлении поля макроскопический,
, размер полупроводника L в направлении поля макроскопический, ![]() , а поле слабое,
, а поле слабое, ![]() . Тем не менее, оно поляризует
полупроводник – притягивает к одной поверхности электроны, образуя
отрицательный пространственный заряд, тогда вблизи противоположной поверхности
образуется положительный
пространственный заряд нескомпенсированных доноров (рис. 7.9б).
. Тем не менее, оно поляризует
полупроводник – притягивает к одной поверхности электроны, образуя
отрицательный пространственный заряд, тогда вблизи противоположной поверхности
образуется положительный
пространственный заряд нескомпенсированных доноров (рис. 7.9б).

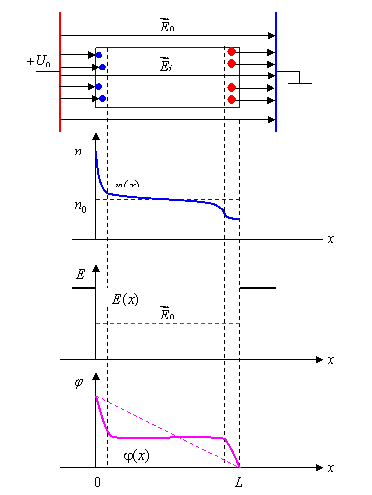
Рис. 7.9 Полупроводник во внешнем
электрическом поле
Поле, созданное пространственным зарядом, направлено в
полупроводнике против внешнего поля, а вне полупроводника – совпадает по
направлению с внешним полем. В результате суммарное поле внутри полупроводника
ослабевает, а снаружи – усиливается.
Распределение поля и потенциала показано на рис. 7.9в и 7.9г. Оно устанавливается
очень быстро, за время максвелловской релаксации ![]() . Установившееся распределение
электронов неоднородно, поэтому неизбежно возникнет диффузионный ток
. Установившееся распределение
электронов неоднородно, поэтому неизбежно возникнет диффузионный ток ![]() , стремящийся сгладить его. Но
этому препятствует противоположно направленный дрейфовый ток
, стремящийся сгладить его. Но
этому препятствует противоположно направленный дрейфовый ток ![]() , созданный внутренним
полем
, созданный внутренним
полем ![]() . В стационарном состоянии суммарный
ток в любой точке полупроводника должен быть равным нулю,
. В стационарном состоянии суммарный
ток в любой точке полупроводника должен быть равным нулю,
![]() (7.3.15)
(7.3.15)
Получили
дифференциальное уравнение
![]()
позволяющее
установить связь локальной концентрации электронов ![]() с потенциалом
с потенциалом ![]() в этой же точке
в этой же точке
![]()
где
![]() - нормировочная постоянная. Отношение
концентраций в двух произвольных
точках
- нормировочная постоянная. Отношение
концентраций в двух произвольных
точках ![]() равно
равно
![]() (7.3.16)
(7.3.16)
Это
же отношение можно записать с помощью модифицированной формулы (7.2.16). В ней ![]() - энергия электрона на дне зоны проводимости.
По физическому смыслу это есть энергия взаимодействия одного свободного
покоящегося электрона со всеми
остальными электронами полупроводника. Она одинакова во всех точка полупроводника.
При помещении полупроводника в электростатическое поле электрон в точке
- энергия электрона на дне зоны проводимости.
По физическому смыслу это есть энергия взаимодействия одного свободного
покоящегося электрона со всеми
остальными электронами полупроводника. Она одинакова во всех точка полупроводника.
При помещении полупроводника в электростатическое поле электрон в точке ![]() приобретает дополнительную энергию
приобретает дополнительную энергию ![]() . Таким образом, полная
энергия электрона на дне зоны проводимости теперь зависит от его положения,
. Таким образом, полная
энергия электрона на дне зоны проводимости теперь зависит от его положения,
![]() (7.3.17)
(7.3.17)
Локальную
концентрацию электронов получим, подставив (7.3.17) в (7.2.16),
![]()
![]() (7.3.18)
(7.3.18)
Аналогичные
соотношения можно записать и для дырок,
![]() (
(![]() )
)
![]()
![]() (
(![]() )
)
Отношение концентраций электронов в точках ![]() и
и ![]() равно
равно
![]() (7.3.19)
(7.3.19)
Сравнивая
(7.3.16) с (7.3.19), находим связь между подвижностью и коэффициентом диффузии
![]()
или ![]() (7.3.20)
(7.3.20)
Формула (7.3.20) называется соотношением
Эйнштейна. Оно справедливо для
невырожденного полупроводника n-типа. Точно такое же соотношение получается для
полупроводника p-типа
![]() (7.3.21)
(7.3.21)
7.4.
УРАВНЕНИЯ ДЛЯ ЗАРЯДОВ, ТОКОВ И ПОЛЕЙ В ПОЛУПРОВОДНИКЕ
В общем случае пространственные заряды, токи и
электрические поля в полупроводниках могут зависеть как от координат, так и от
времени. При этом все три величины взаимосвязаны и должны находиться из фундаментальной системы уравнений (ФСУ) полупроводника. В ФСУ входят
следующие уравнения.
1. Уравнение непрерывности, выражающее в
дифференциальной форме закон сохранения заряда в полупроводнике. Для его
вывода рассмотрим объём V, ограниченный поверхностью S (рис.
7.11).
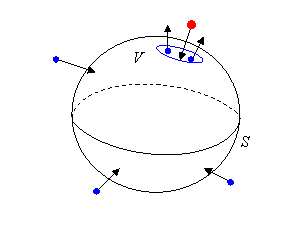
Рис. 7.11 Баланс зарядов в
объёме
В момент времени t в нём содержится полный заряд
![]() (7.4.1)
(7.4.1)
где
![]() - плотность заряда, соответствующая этому моменту.
В последующие моменты времени заряд Q может измениться
по трём причинам:
- плотность заряда, соответствующая этому моменту.
В последующие моменты времени заряд Q может измениться
по трём причинам:
а)
вследствие вытекания заряда из объёма V через
поверхность S. За время ![]() вытечет заряд
вытечет заряд
![]() (7.4.2)
(7.4.2)
где
![]() – векторный
элемент поверхности S,
– векторный
элемент поверхности S, ![]() - плотность тока, протекающего через
- плотность тока, протекающего через ![]() .
.
б)
вследствие генерации новых зарядов со
скоростью ![]() . За время
. За время ![]() заряд в объёме V увеличится на
заряд в объёме V увеличится на
![]() (7.4.3)
(7.4.3)
в)
вследствие рекомбинации зарядов со
скоростью ![]() . За время
. За время ![]() заряд в объёме V уменьшится на
заряд в объёме V уменьшится на
![]() (7.4.4)
(7.4.4)
Полная скорость изменения заряда в объёме V
![]()
![]() (7.4.5)
(7.4.5)
С другой стороны, согласно (7.4.1) она равна
![]() (7.4.6)
(7.4.6)
Приравняв
(7.4.5) и (7.4.6), получим интегральное соотношение
![]() (7.4.7)
(7.4.7)
Первое
слагаемое в правой части преобразуем по теореме Остроградского-Гаусса

Полученное
равенство справедливо для произвольного объёма V, следовательно, равны также и подынтегральные
выражения в левой и правой частях. Получаем искомое уравнение непрерывности
![]() (7.4.7)
(7.4.7)
Подставив
плотность заряда ![]() , запишем его в виде
, запишем его в виде
![]() (7.4.8)
(7.4.8)
Из
(7.4.8) получаем уравнения непрерывности для электронов и дырок
![]() (7.4.9)
(7.4.9)
![]() (7.4.10)
(7.4.10)
2.
Уравнения для токов, полученные
ранее,
![]()
![]() (7.4.11)
(7.4.11)
![]()
![]() (7.4.12)
(7.4.12)
3.
Третье уравнение Максвелла
![]() (7.4.13)
(7.4.13)
или
уравнение Пуассона
![]() (7.4.14)
(7.4.14)
![]() (7.4.15)
(7.4.15)
Использование
уравнений (7.4.13)-(7.4.15) законно, если электроны успевают следовать за
изменением поля, Для дискретных приборов
это так вплоть до частот ![]() .
.
Мы будем применять уравнения (7.4.8) – (7.4.15) для
описания переноса неравновесных неосновных носителей заряда (ННЗ). В этом случае,
как показано ранее, для неосновных электронов, ![]() (
(![]() )
)
для
неосновных дырок
![]() (
(![]() )
)
Подставив
(7.4.11) и (![]() ) в (7.4.9), а (7.4.12) и (
) в (7.4.9), а (7.4.12) и (![]() ) в (7.4.10), получим систему из трёх уравнений для
концентраций и скалярного потенциала
) в (7.4.10), получим систему из трёх уравнений для
концентраций и скалярного потенциала
![]() (7.4.17)
(7.4.17)
![]() (7.4.18)
(7.4.18)
![]() (7.4.19)
(7.4.19)
Эти
уравнения нелинейные и в общем виде решены быть не могут. Но в реальных случаях
их можно существенно упростить.
Во-первых, если концентрации ННЗ не сильно отличаются
от равновесных значений, то есть ![]() , то можно избавиться от нелинейностей во вторых слагаемых правых
частях. Уравнение Пуассона (7.4.19) в этом случае превращается в уравнение
Лапласа
, то можно избавиться от нелинейностей во вторых слагаемых правых
частях. Уравнение Пуассона (7.4.19) в этом случае превращается в уравнение
Лапласа
![]()
которое
может быть решено независимо. Вторые слагаемые Уравнений (7.4.17) и (7.4.18) превращаются
в
![]()
![]()
где
поле ![]() уже
известно. Тогда уравнения (7.4.17) и
(7.4.18) принимают вид
уже
известно. Тогда уравнения (7.4.17) и
(7.4.18) принимают вид
![]() (7.4.20)
(7.4.20)
![]() (7.4.21)
(7.4.21)
Если
поле столь слабое, что ![]() , то вторыми слагаемыми вообще
можно пренебречь,
, то вторыми слагаемыми вообще
можно пренебречь,
![]() (7.4.22)
(7.4.22)
![]() (7.4.23)
(7.4.23)
Во-вторых, часто можно считать, что перенос ННЗ происходит по оси
![]() , а поле имеет только одну
, а поле имеет только одну ![]() - компоненту. Тогда в уравнениях останутся
только пространственные производные по
- компоненту. Тогда в уравнениях останутся
только пространственные производные по ![]() ,
,
![]() (7.4.24)
(7.4.24)
![]() (7.4.25)
(7.4.25)
![]() (7.4.26)
(7.4.26)
![]() (7.4.27)
(7.4.27)
В-третьих, если интересоваться только стационарными
процессами в полупроводниках, то производные по времени следует положить
равными нулю. Уравнения при этом превращаются в обыкновенные дифференциальные с
постоянными коэффициентами,
![]() (7.4.28)
(7.4.28)
![]() (7.4.29)
(7.4.29)
![]() (7.4.30)
(7.4.30)
![]() (7.4.31)
(7.4.31)
Именно их мы
будем использовать для анализа процессов в полупроводниковых диодах и
транзисторах.
7.5.
ЭЛЕКТРИЧЕСКИЕ ПЕРЕХОДЫ
Полупроводниковая электроника использует для
преобразования энергии и обработки информации свойства объёмных полупроводников
и электрических переходов.
Приборы на объёмных свойствах – датчики – используются
для регистрации и измерения внешних факторов. Внешним фактором может быть
электромагнитное излучение, поток быстрых заряженных частиц, магнитное поле,
механическое давление, температура. Регистрация и измерение производится по
изменению какого-либо свойства под влиянием внешнего фактора. Чаще всего таким
свойством является электросопротивление, так как концентрация носителей заряда
в полупроводниках очень чувствительна к
внешним воздействиям.
Электрический
переход – это переходный слой, образующийся при контакте полупроводника с
другим материалом или между двумя областями полупроводника с различными
свойствами.
Свойства электрических переходов гораздо богаче
объёмных свойств полупроводников. На их основе создаются все активные приборы.
Даже в датчиках имеются контакты полупроводника с металлическими выводами.
Поэтому электронику иногда определяют как науку о контактах.
7.5.1.
КЛАССИФИКАЦИЯ ЭЛЕКТРИЧЕСКИХ ПЕРЕХОДОВ
В зависимости от природы контактирующих материалов
различают следующие виды электрических переходов:
1) Электронно-дырочный,
или p-n – переход
между областями полупроводника с различным типом проводимости;
2) односторонние,
или p-i - , n-i – переходы
между легированной и собственной областями полупроводника;
3) переход
металл-полупроводник, или переход
Шоттки;
4) гетеропереход между двумя разными полупроводниками.
Основу полупроводниковой электроники составляют p-n –переходы.
Поэтому им мы уделим главное внимание. Переходы Шоттки изучаются в курсе
«Твёрдотельная электроника». На гетеропереходах построена вся современная
полупроводниковая оптоэлектроника, поэтому они изучаются в курсе «Квантовая и
оптическая электроника».
Электронно-дырочные переходы принято классифицировать
по уровням легирования, по распределению легирующей примеси, по методам
формирования, по конструктивным особенностям.
Если концентрации легирующих примесей в n- и p-областях
равны, ![]() , то p-n –переход
называется симметричным. В противном
случае он называется несимметричным.
При
, то p-n –переход
называется симметричным. В противном
случае он называется несимметричным.
При ![]() или
или ![]() p-n
–переход называется резко несимметричным.
Сильнолегированная область несимметричного p-n –перехода
называется эмиттером, слаболегированная
область называется базой.
p-n
–переход называется резко несимметричным.
Сильнолегированная область несимметричного p-n –перехода
называется эмиттером, слаболегированная
область называется базой.
p-n – переходы, у которых концентрация легирующей примеси
изменяется на расстоянии ![]() , много меньшем толщины
переходного слоя
, много меньшем толщины
переходного слоя ![]() , называются резкими. Если же
, называются резкими. Если же ![]() , то p-n –переходы называются плавными.
, то p-n –переходы называются плавными.
7.5.2.
МЕТОДЫ ФОРМИРОВАНИЯ p-n - ПЕРЕХОДОВ
В настоящее время p-n
– переходы формируют тремя методами –
диффузии, эпитаксиального наращивания и ионной имплантации. На ранних
этапах развития полупроводниковой
электроники широко использовался метод вплавления. Хотя сегодня сплавная
технология представляет только исторический интерес, мы коснёмся и её, так как
она ярко демонстрирует роль материаловедения в полупроводниковой технологии.
7.5.2.1.
СПЛАВНЫЕ p-n - ПЕРЕХОДЫ
По сплавной технологии производились германиевые диоды
и транзисторы. Для создания p-n – перехода
на монокристаллическую пластинку n-Ge площадью накладывают крупинку In
и подвергают нагреву до примерно ![]() . При этом происходят
следующие процессы.
. При этом происходят
следующие процессы.
При температуре ![]() In, контактирующий с Ge, плавится и образует несмачивающую каплю (рис.
7.12а). Германий начинает медленно растворяться в жидком индии. Предельная
растворимость его при
In, контактирующий с Ge, плавится и образует несмачивающую каплю (рис.
7.12а). Германий начинает медленно растворяться в жидком индии. Предельная
растворимость его при ![]() составляет
составляет ![]() или
или ![]() в атомных долях. С повышением температуры смачивание
увеличивается и при
в атомных долях. С повышением температуры смачивание
увеличивается и при ![]() оно становится почти полным (рис. 7.12б).
Скорость растворения и предельная растворимость также растут. При
оно становится почти полным (рис. 7.12б).
Скорость растворения и предельная растворимость также растут. При ![]() в In растворяется уже 10% Ge. В результате образуется капля расплава
в In растворяется уже 10% Ge. В результате образуется капля расплава ![]() в лунке (рис 7.12в). Затем температуру
постепенно снижают. При этом вследствие понижения растворимости избыточный Ge
уходит из расплава и рекристаллизуется на
границе Ge-расплав. Но в рекристаллизованную решётку Ge
оказываются встроенными атомы In. Концентрация их может достигать
в лунке (рис 7.12в). Затем температуру
постепенно снижают. При этом вследствие понижения растворимости избыточный Ge
уходит из расплава и рекристаллизуется на
границе Ge-расплав. Но в рекристаллизованную решётку Ge
оказываются встроенными атомы In. Концентрация их может достигать ![]() . Это значительно больше концентрации
доноров в исходном германии, поэтому рекристаллизованный слой приобретает
проводимость p-типа. При
. Это значительно больше концентрации
доноров в исходном германии, поэтому рекристаллизованный слой приобретает
проводимость p-типа. При ![]() In кристаллизуется
и получается структура с p-n - переходом
(рис. 7.12г).
In кристаллизуется
и получается структура с p-n - переходом
(рис. 7.12г).
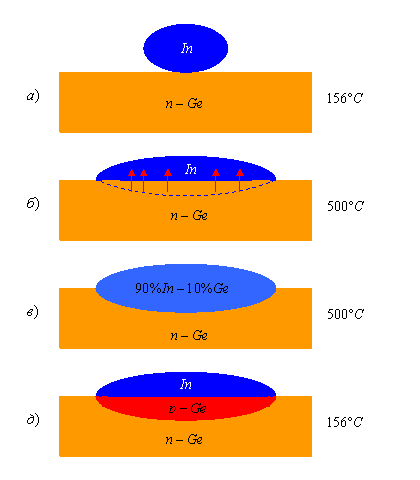
Рис.
12 Сплавной метод изготовления p-n-переходов
7.5.2.2.
ДИФФУЗИОННЫЕ p-n – ПЕРЕХОДЫ
Диффузионные p-n – переходы
изготавливают методом диффузии примеси в монокристалл полупроводника через его
поверхность. Для этого однородно легированную полупроводниковую пластину помещают
в трубчатую печь, через которую пропускают инертный газ-носитель, доставляющий
к поверхности пластины молекулы вещества, в состав которого входят примесные
атомы. Эти молекулы служат источниками примеси. Например, для n-Si источником
является бромид бора ![]() , для p-Si – фосфин
, для p-Si – фосфин
![]() или
арсин
или
арсин ![]() . Процесс диффузии идёт с
заметной скоростью при температурах
. Процесс диффузии идёт с
заметной скоростью при температурах ![]() . Сталкиваясь с нагретой до
такой температуры пластиной, молекулы-источники вступают в химические реакции с
кремнием, в результате которых на поверхности адсорбируются свободные атомы B, P
или As.
. Сталкиваясь с нагретой до
такой температуры пластиной, молекулы-источники вступают в химические реакции с
кремнием, в результате которых на поверхности адсорбируются свободные атомы B, P
или As.
Концентрация их в поверхностном монослое может
достигать ![]() от атомной концентрации кремния, тогда как в
глубине их нет вовсе. Под действием градиента концентрации примесные атомы
диффундируют от поверхности, распределяясь в момент времени t по закону
от атомной концентрации кремния, тогда как в
глубине их нет вовсе. Под действием градиента концентрации примесные атомы
диффундируют от поверхности, распределяясь в момент времени t по закону
![]()
где
![]() – расстояние по нормали от поверхности
пластины (на поверхности
– расстояние по нормали от поверхности
пластины (на поверхности ![]() ). Функция
). Функция ![]() определяется интегралом
определяется интегралом

График
её напоминает экспоненту (рис. 7.13).
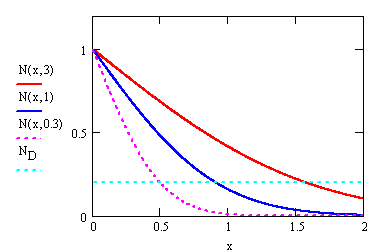
Рис.
7.13 Распределение примеси,
диффундирующей
с поверхности
в глубину полупроводника.
В
точке ![]() концентрации исходных доноров и диффундирующих
акцепторов равны. При
концентрации исходных доноров и диффундирующих
акцепторов равны. При ![]()
![]() , следовательно, имеем проводимость
p - типа.
При
, следовательно, имеем проводимость
p - типа.
При ![]() ,
, ![]() , и полупроводник сохраняет
проводимость n - типа.
Плоскость
, и полупроводник сохраняет
проводимость n - типа.
Плоскость ![]() есть металлургическая граница p-n – перехода.
Глубину залегания p-n - перехода
есть металлургическая граница p-n – перехода.
Глубину залегания p-n - перехода
![]() можно варьировать, изменяя длительность процесса диффузии.
можно варьировать, изменяя длительность процесса диффузии.
Металлургическая граница в диффузионном p-n
–переходе параллельна внешней
поверхности. Изготовление диода состоит в формировании контактных площадок, раскалывании
пластины на кристаллы площадью ![]() , помещении кристалла в корпус
и разварке выводов. В таких диодах ток, текущий от n- к p-области,
перпендикулярен металлургической границе и внешней поверхности. Их можно,
поэтому, назвать вертикальными.
, помещении кристалла в корпус
и разварке выводов. В таких диодах ток, текущий от n- к p-области,
перпендикулярен металлургической границе и внешней поверхности. Их можно,
поэтому, назвать вертикальными.
Значительная часть диодов и особенно транзисторов
производится по так называемой планарной технологии. Термин «планарная» указывает
на то, что все выводы развариваются на одной поверхности, через которую
производилась диффузия. Для этого диффузию осуществляют через окно ограниченной
площади в маске из непроницаемого для примесей вещества. Для кремния такую
маску создать достаточно просто – надо окислить поверхностный слой, а затем
вытравить окна в слое оксида. Эти операции в настоящее время являются рутинными.
Диффузия через окно является уже не одномерной, а трёхмерной. Равенство
концентраций достигается на некоторой
поверхности, сечение которой плоскостью показано на рис. 7.14.
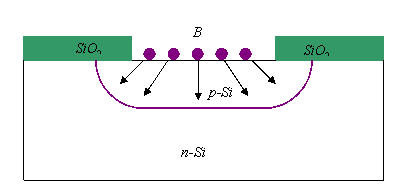
Рис. 7.14
Профиль p-n –перехода
при диффузии примеси через окно
Такой
p-n –переход обладает большой кривизной, обусловливающей
дополнительные особенности его свойств.
В планарных p-n –переходах
один из выводов разваривается в исходном окне, а для второго вскрывается ещё
одно окно над n-областью (рис. 7.15). Ток между выводами течёт
параллельно внешней поверхности
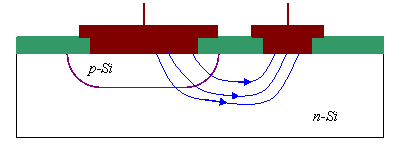
Рис.
7.15 Структура диффузионного планарного p-n –перехода.
7.5.2.3.
ЭПИТАКСИАЛЬНЫЕ p-n – ПЕРЕХОДЫ
Эпитаксией называется наращивание на подложке слоя
материала, свойства которого определяются подложкой. В частности, на монокристаллической
подложке можно нарастить монокристаллический слой, который является как бы
продолжением подложки, наследует её кристаллическую структуру.
Эпитаксиальные p-n – переходы
изготавливают путём эпитаксии слоя полупроводника n(p) – типа на монокристаллическом полупроводнике p(n) – типа, служащем подложкой. В результате получается
единый монокристалл с резкой границей между слоями p- и n- типа
(рис. 7.16).
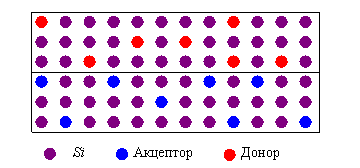
Рис. 7.16 Эпитаксиальный p-n –переход
Эпитаксиальное наращивание можно осуществить,
доставляя к поверхности атомов из жидкой фазы (жидкофазная эпитаксия – ЖФЭ), из
паровой фазы (парофазная эпитаксия – ПФЭ), из газовой фазы (газофазная эпитаксия
– ГФЭ), с помощью молекулярных пучков (молекулярно-лучевая эпитаксия – МЛЭ). Во
всех случаях ориентированный эпитаксиальный рост может происходить при строго
определённых давлении, концентрациях и температуре. Как и диффузия, эпитаксия –
высокотемпературный процесс, происходящий при температурах порядка ![]() . Толщины эпитаксиальных слоёв
контролируются с точностью до одного
атомного слоя.
. Толщины эпитаксиальных слоёв
контролируются с точностью до одного
атомного слоя.
Разделению пластины на отдельные кристаллы предшествует
нанесение защитного покрытия (рис. 7.17а) и травление сетки канавок на глубину,
превышающую толщину эпитаксиального слоя (рис. 7.17б).
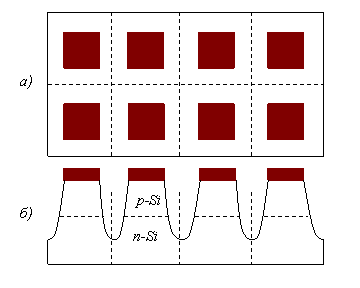
Рис. 7.18 Формирование меза-структур с p-n –переходом
Раскалывание
пластины производится по дну канавок, в результате получается так называемые меза-структуры (от испанского mesa – стол).
7.5.2.4.
ИМПЛАНТИРОВАННЫЕ p-n – ПЕРЕХОДЫ
Ионной
имплантацией (или ионным легированием)
называется внедрение в твёрдое тело ионов, ускоренных до энергии в
десятки и сотни кэВ. Многократно
столкнувшись с атомами и электронами мишени, имплантируемый ион, в конце
концов, остановится на некоторой глубине x от поверхности. При этом пройденный им в мишени путь L будет
больше x (рис. 7.18). Соударения с атомами мишени происходят
статистически, поэтому предсказать, где остановится конкретный ион, нельзя. Но
можно подсчитать, какова будет концентрация остановившихся ионов на глубине x, если
через единицу площади поверхности мишени их прошло ![]() . В первом приближении она даётся
формулой
. В первом приближении она даётся
формулой

Смысл параметров ![]() и
и ![]() ясен из рис. 7.19.
ясен из рис. 7.19.
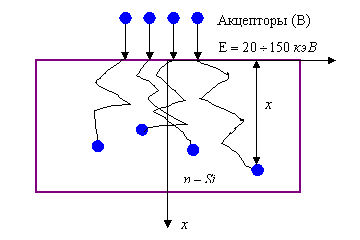
Рис.
7.18 Имплантация ионов в полупроводник
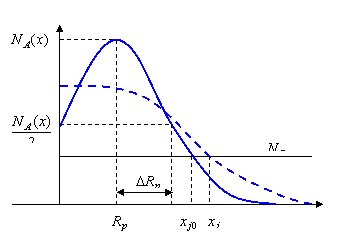
Рис. 7.19
Распределение имплантированных ионов в мишени
![]() называется средним проективным побегом и
задаёт положение максимума распределения внедрённых ионов,
называется средним проективным побегом и
задаёт положение максимума распределения внедрённых ионов, ![]() называется разбросом пробегов. Оба параметра
определяются энергией иона и соотношением его массы и массы атомов мишени. В
области, где
называется разбросом пробегов. Оба параметра
определяются энергией иона и соотношением его массы и массы атомов мишени. В
области, где ![]() полупроводник обладает проводимостью p-типа. Плоскость
полупроводник обладает проводимостью p-типа. Плоскость ![]() есть металлургическая граница p-n –перехода. Как правило, после имплантации следует
операция разгонки примеси – диффузионное сглаживание распределения при
температуре
есть металлургическая граница p-n –перехода. Как правило, после имплантации следует
операция разгонки примеси – диффузионное сглаживание распределения при
температуре ![]() . Конечный профиль показан
пунктиром. Переход залегает на глубине
. Конечный профиль показан
пунктиром. Переход залегает на глубине ![]() .
.
7.6.
ФИЗИКА p-n – ПЕРЕХОДА
В настоящем параграфе будут рассмотрены электрические
свойства p-n
– перехода, проявляющиеся при приложении
к нему разности потенциалов, или смещения, ![]() . Смещение может быть
постоянным, гармоническим или импульсным. Эти свойства важны не только сами по
себе. Они служат базой для понимания физики биполярных транзисторов и полевых
транзисторов с управляющим p-n – переходом.
. Смещение может быть
постоянным, гармоническим или импульсным. Эти свойства важны не только сами по
себе. Они служат базой для понимания физики биполярных транзисторов и полевых
транзисторов с управляющим p-n – переходом.
Чтобы выявить главные свойства p-n
– перехода в первозданном виде,
используем плоскостную модель.
Именно, будем считать, что металлургическая граница есть бесконечная плоскость,
а толщины n- и p-областей столь велики, что влияние их внешних границ
не сказывается на процессах в собственно переходном слое. Свойства такого перехода
однородны по любому сечению, параллельному металлургической границе, поэтому их
можно изучать, вырезав параллелепипед с единичной площадью сечения, перпендикулярный
границе (рис. 7.20).
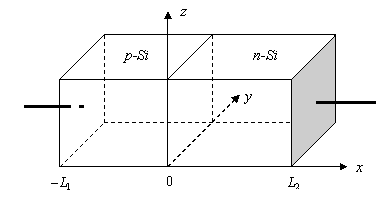
Рис. 7.20 «Кирпичная» модель p-n
– перехода
Структура
напоминает составной кирпич, поэтому такую модификацию плоскостной модели
назовём «кирпичной» моделью.
Основой для анализа p-n
– перехода, равно как и других полупроводниковых
приборов, служит его энергетическая
диаграмма - зависимость энергии электрона от его пространственного положения.
В «кирпичной» модели достаточно рассмотреть эту зависимость вдоль направления
от p-области к n-области перпендикулярно металлургической границе.
Выберем его в качестве оси ![]() . Точку
. Точку ![]() совместим с металлургической границей.
Энергетическая диаграмма тогда задаётся зависимостями от
совместим с металлургической границей.
Энергетическая диаграмма тогда задаётся зависимостями от ![]() дна зоны проводимости
дна зоны проводимости ![]() и потолка валентной зоны
и потолка валентной зоны ![]() в интервале
в интервале
![]() .
.
7.6.1. ПРОЦЕССЫ В
РАВНОВЕСНОМ p-n – ПЕРЕХОДЕ
7.6.1.1.
ЭНЕРГЕТИЧЕСКАЯ ДИАГРАММА
Равновесным
называется состояние p-n – перехода, устанавливающееся при отсутствии на нём
смещения, то есть при ![]() .
.
Установим вид энергетической диаграммы равновесного p-n – перехода и распределение носителей в нём. Для
анализа процессов установления равновесия воспользуемся мысленным экспериментом
- создадим p-n
– переход из двух отдельных равновесных
частей полупроводника, однородно легированных донорами до концентрации ![]() и акцепторами до концентрации
и акцепторами до концентрации ![]() , путём приведения их в
контакт и образования кристаллографически совершенной металлургической границы.
Будем считать полупроводники невырожденными, причём
, путём приведения их в
контакт и образования кристаллографически совершенной металлургической границы.
Будем считать полупроводники невырожденными, причём ![]() .
.
В момент образования контакта энергетическая диаграмма
составного полупроводника есть просто объединение энергетических диаграмм p- и n-частей (рис. 7.21а). Точно так же распределение носителей
в объединённой структуре есть сумма их распределений в p- и n-частях (рис.7.21б). Из рис 7.20 следует, что исходное
состояние структуры сильно неравновесное – на металлургической границе существуют
скачки уровня Ферми ![]() , концентраций электронов
, концентраций электронов ![]() и концентрации дырок
и концентрации дырок ![]() . Поэтому в системе немедленно
начнутся процессы выравнивания уровней Ферми. Под действием градиента
концентрации электроны будут диффундировать из n-области в p-область,
образуя диффузионный ток
. Поэтому в системе немедленно
начнутся процессы выравнивания уровней Ферми. Под действием градиента
концентрации электроны будут диффундировать из n-области в p-область,
образуя диффузионный ток
![]()
Навстречу
им будут диффундировать дырки, создавая диффузионный ток ![]()
Перешедшие
в p-область электроны рекомбинируют с имеющимися там в
изобилии дырками. Дырки, перешедшие в n-область, рекомбинируют с электронами.
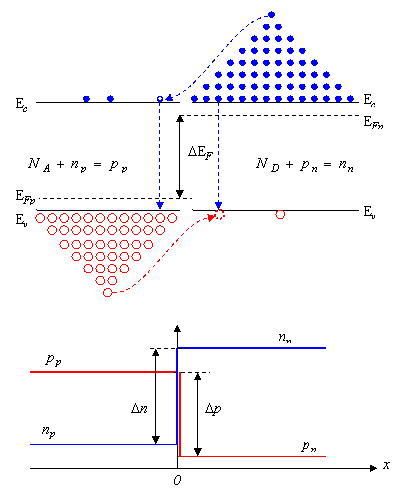
Рис. 7.20
Исходное состояние составной p-n - структуры
Каждый акт рекомбинации создаёт один
нескомпенсированный акцептов в p-области и
один нескомпенсированный донор в n-области. Таким образом, в n-области создаётся приграничный положительный
пространственный заряд, а в p-области – приграничный отрицательный пространственный
заряд. Вместе они образуют область пространственного
заряда (ОПЗ), и создают
встроенное электростатическое поле ![]() , направленное от n-области к p-области
(рис. 7.21а).
, направленное от n-области к p-области
(рис. 7.21а).
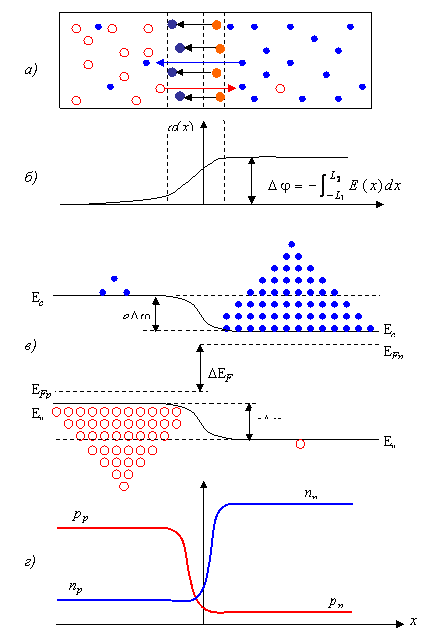
Рис. 7.21
Промежуточное неравновесное состояние p-n -перехода
Если
положить потенциал встроенного поля равным нулю в глубине p-области,
то тогда в глубине n-области он будет положительным и равным
 (7.6.1)
(7.6.1)
Примерный
график ![]() показан на рис. 7.21б. Встроенное поле изменяет
энергии электронов, находящихся в точке
показан на рис. 7.21б. Встроенное поле изменяет
энергии электронов, находящихся в точке ![]() , на
, на ![]() . Энергетическая диаграмма будет описываться
функциями
. Энергетическая диаграмма будет описываться
функциями ![]() и
и ![]() (рис. 7.21в). Концентрация носителей непрерывно
изменяются от равновесного значения в основных носителей до равновесного
значения неосновных носителей (рис. 7.21г). В промежуточном неравновесном
состоянии в зоне проводимости образуется потенциальный барьер
(рис. 7.21в). Концентрация носителей непрерывно
изменяются от равновесного значения в основных носителей до равновесного
значения неосновных носителей (рис. 7.21г). В промежуточном неравновесном
состоянии в зоне проводимости образуется потенциальный барьер ![]() для электронов и такой же барьер для дырок в
валентной зоне. Те носители, энергии которых меньше высоты барьера, не смогут
его преодолеть. Вся их энергия уйдёт на совершение работы против встроенного
поля. Поэтому диффузионные токи
для электронов и такой же барьер для дырок в
валентной зоне. Те носители, энергии которых меньше высоты барьера, не смогут
его преодолеть. Вся их энергия уйдёт на совершение работы против встроенного
поля. Поэтому диффузионные токи ![]() и
и ![]() уменьшатся по сравнению с исходным состоянием.
Разность уровней Ферми также станет меньше, чем в исходном состоянии, на
величину потенциального барьера,
уменьшатся по сравнению с исходным состоянием.
Разность уровней Ферми также станет меньше, чем в исходном состоянии, на
величину потенциального барьера, ![]() .
.
В состоянии равновесия должно быть ![]() . Следовательно, диффузия
носителей будет продолжаться, а толщина ОПЗ возрастать до тех пор, пока
встроенное поле не обеспечит выполнение этого условия, или следующего из него
. Следовательно, диффузия
носителей будет продолжаться, а толщина ОПЗ возрастать до тех пор, пока
встроенное поле не обеспечит выполнение этого условия, или следующего из него

Конечное
равновесное состояние p-n
–перехода изображено на рис. 7.22. Оно
характеризуется распределением поля ![]() и потенциала
и потенциала ![]() в ОПЗ и связанной с ними величиной
потенциального барьера
в ОПЗ и связанной с ними величиной
потенциального барьера ![]() . Поскольку этот потенциальный
барьер образуется вследствие диффузии носителей при контакте n- и p-областей полупроводника, он называется диффузионным потенциалом или контактной разностью потенциалов.
. Поскольку этот потенциальный
барьер образуется вследствие диффузии носителей при контакте n- и p-областей полупроводника, он называется диффузионным потенциалом или контактной разностью потенциалов.

Рис. 7.22 Равновесное состояние p-n
– перехода
ОПЗ
не имеет резкой границы, но изменение потенциала и поле сосредоточены главным
образом в слое толщиной ![]() . Суммарные заряды в ОПЗ по
обе стороны от металлургической границы равны по абсолютной величине, поэтому в
слаболегированной области, в данном случае p-типа, ОПЗ толще, то есть
. Суммарные заряды в ОПЗ по
обе стороны от металлургической границы равны по абсолютной величине, поэтому в
слаболегированной области, в данном случае p-типа, ОПЗ толще, то есть ![]() . В равновесном состоянии
преодолеть потенциальный барьер могут только самые энергичные основные носители – электроны и дырки. Они
образуют равновесные диффузионные токи
. В равновесном состоянии
преодолеть потенциальный барьер могут только самые энергичные основные носители – электроны и дырки. Они
образуют равновесные диффузионные токи ![]() и
и ![]() , текущие из p- в
n-область. А
поскольку суммарный ток обязан равняться нулю, то должны течь также токи из
n- в p-область. По
физической природе эти токи
, текущие из p- в
n-область. А
поскольку суммарный ток обязан равняться нулю, то должны течь также токи из
n- в p-область. По
физической природе эти токи ![]() и
и ![]() дрейфовые. Они создаются неосновными электронами и дырками,
которые, случайно блуждая, попадают в область сильного поля и перебрасываются
им в противоположную область. Таким
образом, равновесный p-n переход
не есть воплощение тишины и спокойствия. В нём постоянно текут встречные
диффузионные и дрейфовые токи, попарно скомпенсированные в зоне проводимости и
валентной зоне,
дрейфовые. Они создаются неосновными электронами и дырками,
которые, случайно блуждая, попадают в область сильного поля и перебрасываются
им в противоположную область. Таким
образом, равновесный p-n переход
не есть воплощение тишины и спокойствия. В нём постоянно текут встречные
диффузионные и дрейфовые токи, попарно скомпенсированные в зоне проводимости и
валентной зоне,
![]() или
или ![]() (7.6.3)
(7.6.3)
![]() или
или ![]() (7.6.4)
(7.6.4)
7.6.1.2.
ДИФФУЗИОННЫЙ ПОТЕНЦИАЛ
Равновесный диффузионный потенциал можно определить из
соотношения
![]() (7.6.5)
(7.6.5)
Для
этого достаточно выразить уровни Ферми и через параметры нейтральных n- и p-областей. Особенно просто это сделать для невырожденного
p-n –перехода. Концентрации основных носителей в n- и p- области
соответственно даются формулами
![]() (7.6.6)
(7.6.6)
![]() (7.6.7)
(7.6.7)
Перемножив
их, получим
![]() (7.6.8)
(7.6.8)
Откуда
немедленно находим
![]() (7.6.9)
(7.6.9)
Концентрации
основных носителей с высокой точностью равны уровням легирования, ![]() ,
, ![]() , следовательно
, следовательно
![]() (7.6.10)
(7.6.10)
В
невырожденных полупроводниках ![]() ,
, ![]() , поэтому
, поэтому ![]() . Соотношение (7.6.8) можно
переписать в виде
. Соотношение (7.6.8) можно
переписать в виде
![]() (7.6.11)
(7.6.11)
Откуда
получаем ещё одно выражение для диффузионного потенциала
![]() (7.6.12)
(7.6.12)
Оно
наиболее удобно для численных оценок.
Пример.
Оценить
величину диффузионного потенциала германиевого и кремниевого p-n-переходов
при ![]() и одинаковых
уровнях легирования
и одинаковых
уровнях легирования ![]() ,
, ![]() .
.
Решение
Собственные концентрации в Ge и Si
при ![]() равны:
равны:
![]()
![]()
Вспомнив, что
![]() , из формулы (7.6.12) находим
, из формулы (7.6.12) находим
![]()
![]()
![]()
![]()
Эти
типичные значения диффузионных потенциалов германиевых и кремниевых p-n –переходов
полезно запомнить.
7.6.1.3.
ПОЛЕ И ПОТЕНЦИАЛ
Для количественных расчётов необходимо знать
функциональные зависимости ![]() и
и ![]() . Их можно найти из уравнения Пуассона
. Их можно найти из уравнения Пуассона
![]() (7.6.13)
(7.6.13)
Здесь
![]() - суммарная плотность всех зарядов, создающих
поле. В общем случае она равна
- суммарная плотность всех зарядов, создающих
поле. В общем случае она равна
![]()
Для резкого p-n –перехода
![]() (7.6.14)
(7.6.14)
Концентрации
![]() и
и ![]() определяются локальным потенциалом согласно
(7.3.18) и
определяются локальным потенциалом согласно
(7.3.18) и ![]() . Уравнение (7.6.13) принимает
вид
. Уравнение (7.6.13) принимает
вид
 (7.6.15)
(7.6.15)
Получить
его явное аналитическое решение не удаётся, поэтому, следуя В. Шоттки,
уравнение упрощают на основе приближения полного обеднения. Именно,
считается, что, во-первых, поле
сосредоточено только в ОПЗ толщиной ![]() , а весь остальной объём
структуры электрически нейтрален, и, во-вторых, в ОПЗ нет подвижных носителей заряда - электронов и дырок. Это и
означает, что ОПЗ полностью обеднена носителями. На самом деле они там есть, но
концентрация их сравнима с концентрацией неподвижных доноров или акцепторов
только в узком переходном слое толщиной в несколько дебаевских длин
экранирования
, а весь остальной объём
структуры электрически нейтрален, и, во-вторых, в ОПЗ нет подвижных носителей заряда - электронов и дырок. Это и
означает, что ОПЗ полностью обеднена носителями. На самом деле они там есть, но
концентрация их сравнима с концентрацией неподвижных доноров или акцепторов
только в узком переходном слое толщиной в несколько дебаевских длин
экранирования
![]() или
или ![]()
При
![]() получаем оценку
получаем оценку

Толщины
реальных p-n –переходов,
по крайней мере, на порядок больше, поэтому приближение Шоттки даёт вполне
приемлемую с практической точки зрения точность.
Таким образом, для резкого p-n
–перехода в приближении полного обеднения
плотность заряда в уравнении Пуассона имеет разрывы первого рода на
металлургической границе и на границах с нейтральными областями в точках
![]() ,
, ![]() и
и ![]() (рис. 7.23).
(рис. 7.23).
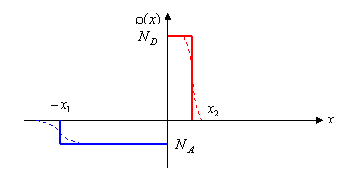
Рис. 7.23 Пространственный заряд в
резком p-n
– переходе:
сплошные линии
- приближение Шоттки,
пунктир – с учётом подвижных носителей
При
кусочно-непрерывной плотности пространственного заряда поле и потенциал должны
остаться непрерывными везде. Поэтому уравнение Пуассона следует решать отдельно
для каждой из областей непрерывности ![]() , а на границах выполнить
«сшивание» полученных решений, то есть потребовать равенства потенциала и поля
слева и справа от границы.
, а на границах выполнить
«сшивание» полученных решений, то есть потребовать равенства потенциала и поля
слева и справа от границы.
Решение для нейтральных областей известно сразу:
![]() при
при ![]() ,
,
![]() при
при ![]()
Остаётся
найти поле и потенциал в ОПЗ. Снабдим потенциал в p-области индексом 1, потенциал в n-области –
индексом 2. Тогда получим следующие уравнения и граничные условия,
![]() (7.6.16)
(7.6.16) ![]() (7.6.17)
(7.6.17)
![]() (
(![]() )
) ![]() (
(![]() )
)
![]() (
(![]() )
) ![]() (
(![]() )
)
![]() (7.6.18)
(7.6.18)
![]() (7.6.19)
(7.6.19)
Интегрируем
уравнение (7.6.16),
![]()
Из
граничного условия (![]() ) находим постоянную
интегрирования,
) находим постоянную
интегрирования, ![]()
![]() (7.6.20)
(7.6.20)
![]() (7.6.21)
(7.6.21)
Ещё
раз интегрируя (7.6.20), находим потенциал в p- области,
![]()
![]()
![]() (7.6.22)
(7.6.22)
Аналогично,
интегрируя уравнение (7.6.17), находим поле и потенциал в n-области.
![]()
Из
(![]() ) имеем
) имеем ![]()
![]()
![]() (7.6.23)
(7.6.23)
![]()
Из
(![]() )
) ![]()
![]()
![]() (7.6.24)
(7.6.24)
Использовав
четыре условия на внешних границах
ОПЗ, мы определили четыре постоянных
интегрирования. Но полностью поле и потенциал ещё не определены. В формулы
(7.6.21) – (7.6.24) входят неизвестные толщины ОПЗ ![]() и
и ![]() . Их найдём из оставшихся двух
условий на металлургической границе,
. Их найдём из оставшихся двух
условий на металлургической границе,
![]()
![]()
Получили два уравнения относительно ![]() и
и ![]() .Сократив на общие множители,
перепишем их в виде
.Сократив на общие множители,
перепишем их в виде
![]() (7.6.25)
(7.6.25)
![]() (7.6.26)
(7.6.26)
Уравнение
(7.6.25), если его умножить на заряд электрона ![]() , выражает отмеченный ранее баланс
зарядов в ОПЗ на единицу площади. Толщины ОПЗ оказываются обратно
пропорциональными уровням легирования. Выразим из первого уравнения
, выражает отмеченный ранее баланс
зарядов в ОПЗ на единицу площади. Толщины ОПЗ оказываются обратно
пропорциональными уровням легирования. Выразим из первого уравнения ![]() и подставим во второе уравнение,
и подставим во второе уравнение,
![]()
Из
полученного уравнения находим ![]() ,
,
 (7.6.27)
(7.6.27)
а
из (7.6.25) -  (7.6.28)
(7.6.28)
Суммарная
толщина ОПЗ оказывается равной
 (7.6.29)
(7.6.29)
В
резко несимметричном p-n
– переходе под корнем доминирует слагаемое
с меньшей концентрацией примеси, то есть ОПЗ практически полностью
располагается в слаболегированной области. При ![]()
 (7.6.30)
(7.6.30)
Графики
потенциала и поля в резком германиевом p-n –переходе,
рассчитанные по формулам (7.6.21)-(7.6.30), показаны на рис. 7.24.
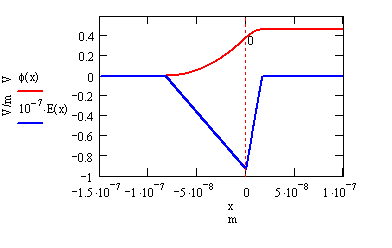
Рис.
7.24 Поле и потенциал в германиевом p-n
–переходе
с ![]() ,
, ![]() .
.
Максимальной
величины поле достигает на металлургической границе p-n
-перехода.
7.6.2.
ПРОЦЕССЫ В НЕРАВНОВЕСНОМ p-n – ПЕРЕХОДЕ
7.6.2.1.
ОБРАТНОЕ СМЕЩЕНИЕ
Обратным называется такое смещение p-n – перехода, когда положительный вывод источника смещения
подключается к n-области, а отрицательный вывод – к p-области.
Сопротивление ОПЗ,
где практически нет свободных носителей, намного больше сопротивлений нейтральных
областей, поэтому можно считать, что все обратное смещение приложено к ней.
Поле, созданное обратным смещением, совпадает по направлению с встроенным полем
и суммируется с ним. Следовательно, в обратно смещённом p-n – переходе высота потенциального барьера увеличится
на ![]() , где
, где ![]() - абсолютная величина смещения, и будет равной
- абсолютная величина смещения, и будет равной
![]() . Соответственно, изменятся и
все величины, связанные с величиной потенциального барьера. Прежде всего, это
толщины ОПЗ. Теперь их следует вычислять по формулам
. Соответственно, изменятся и
все величины, связанные с величиной потенциального барьера. Прежде всего, это
толщины ОПЗ. Теперь их следует вычислять по формулам
 (7.6.31)
(7.6.31)
 (7.6.32)
(7.6.32)
 (7.6.33)
(7.6.33)
Эти
значения толщин должны быть подставлены в формулы (7.6.21) и (7.6.23) при
вычислении напряжённости встроенного поля в обратно смещённом p-n –переходе.
Изменения распределения потенциала, поля и энергетической диаграммы в
германиевом p-n – переходе оказаны на рис. 7.25.
Увеличение потенциального барьера нарушает равновесие в p-n –переходе. Диффузионные токи ![]() и
и ![]() резко уменьшаются, так как уменьшается число
носителей, способных преодолеть барьер. Дрейфовые же токи
резко уменьшаются, так как уменьшается число
носителей, способных преодолеть барьер. Дрейфовые же токи ![]() и
и ![]() практически не изменяются (рис. 7.26). В результате
через обратно смещённый p-n –переход течёт ток
практически не изменяются (рис. 7.26). В результате
через обратно смещённый p-n –переход течёт ток
![]() (7.6.34)
(7.6.34)
называемый
током насыщения, и направленный от n- к p-области.
Величину его можно оценить достаточно просто. По физической природе это ток
неосновных носителей, захваченных полем и переброшенных в противоположную
область. Захваченными могут быть электроны или дырки, которые за время жизни ![]() или
или ![]() смогут приблизиться к p-n - переходу. Для
этого они должны находиться от ОПЗ на расстоянии, не большем диффузионной
длины
смогут приблизиться к p-n - переходу. Для
этого они должны находиться от ОПЗ на расстоянии, не большем диффузионной
длины ![]() или
или ![]() . Число таких электронов в p-области в
пересчёте на единицу площади ОПЗ равно
. Число таких электронов в p-области в
пересчёте на единицу площади ОПЗ равно ![]() . За время
. За время ![]() они перенесут через ОПЗ заряд
они перенесут через ОПЗ заряд ![]() и создадут ток плотностью
и создадут ток плотностью
![]() (7.6.35)
(7.6.35)

Рис.
7.26 Токи в обратно смещённом p-n
–переходе
Аналогично,
в n-области на единицу площади ОПЗ приходится ![]() дырок, которые при переносе через ОПЗ создают
ток плотностью
дырок, которые при переносе через ОПЗ создают
ток плотностью
![]() (7.6.36)
(7.6.36)
Суммарный
ток насыщения равен
![]() (7.6.37)
(7.6.37)
Формулу
(7.6.37) можно представить в более удобном для практических оценок виде, если
воспользоваться определением диффузионных длин
![]() ,
, ![]() ,
,
и выразить концентрации неосновных носителей
через концентрации основных носителей с помощью закона действующих масс,
![]() ,
, ![]()
В результате получим
 (7.6.38)
(7.6.38)
Вследствие захвата неосновных носителей
полем ОПЗ их концентрация в приконтактных слоях толщиной ![]() уменьшается. Это явление называется экстракцией неосновных носителей. Изменение концентрации носителей
при обратном смещении по сравнению с равновесием показано на рис. 7.27.
уменьшается. Это явление называется экстракцией неосновных носителей. Изменение концентрации носителей
при обратном смещении по сравнению с равновесием показано на рис. 7.27.
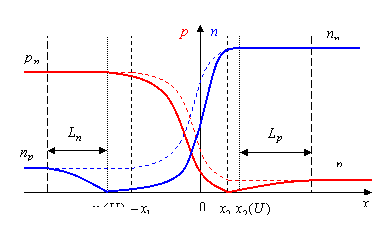
Рис.
7.27 Экстракция неосновных
носителей. Сплошные линии
– концентрации при обратном смещении, пунктирные –
равновесные концентрации.
7.6.2.2.
ПРЯМОЕ СМЕЩЕНИЕ
Прямым
называется такое смещение p-n – перехода, когда положительный вывод источника смещения подключается
к p-области, а отрицательный вывод – к n-области.
Оно также вызывает нарушение равновесия в p-n –переходе, но
в противоположную сторону по сравнению сторону по сравнению с обратным
смещением. Теперь поле, созданное смещением ![]() , противоположно встроенному
полю, следовательно, суммарное поле в p-n - переходе
уменьшается, высота потенциального барьера понижается и становится равной
, противоположно встроенному
полю, следовательно, суммарное поле в p-n - переходе
уменьшается, высота потенциального барьера понижается и становится равной ![]() , а ОПЗ – сужается. Теперь
толщину её следует рассчитывать по формулам, отличающихся от (7.6.31) -
(7.6.33) одним знаком под корнем,
, а ОПЗ – сужается. Теперь
толщину её следует рассчитывать по формулам, отличающихся от (7.6.31) -
(7.6.33) одним знаком под корнем,
 (7.6.31)
(7.6.31)
 (7.6.32)
(7.6.32)
 (7.6.33)
(7.6.33)
Понижение потенциального барьера на ![]() приводит к резкому возрастанию диффузионных
токов носителей обоих типов (рис. 7.28).
приводит к резкому возрастанию диффузионных
токов носителей обоих типов (рис. 7.28).
При этом дрейфовые токи практически не меняется.
Вследствие этого происходит столь же резкое возрастание концентрации неосновных
носителей в приконтактных областях, называемое инжекцией. Суммарный ток при прямом смещении течёт от p- к n-области и
очень сильно зависит от смещения ![]() .
.
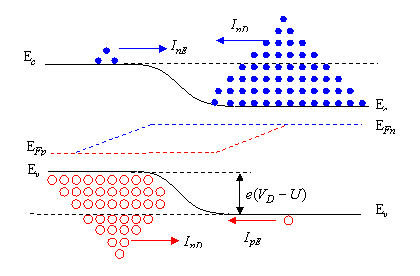
Рис. 7.28 Прямо смещённый p-n -переход
Инжектированные
носители под действием созданного градиента концентрации диффундируют вглубь
соответствующих областей и при этом рекомбинируют с основными носителями.
Поэтому концентрации их быстро убывают (экспоненциально, как будет показано в
следующем пункте), и отличаются от равновесной только в пределах слоёв толщиной
в несколько диффузионных длин (рис. 7.29).
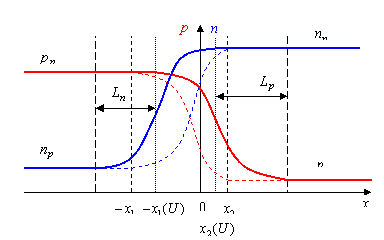
Рис. 7.29 Инжекция неосновных
носителей. Сплошные линии –
концентрации при
прямом смещении, пунктирные –
равновесные
концентрации.
7.6.3.
ВОЛЬТ-АМПЕРНАЯ ХАРАКТЕРИСТИКА p-n–ПЕРЕХОДА
Вольтамперная
характеристика p-n – перехода отражает его реакцию на постоянное
смещение. Исходя из качественного анализа токов при прямом и обратном смещении,
можно представить, что ВАХ имеет
следующий вид (7.30). Для количественного анализа необходимо знать
функциональную зависимость ![]() . Впервые она была выведена У.
Шокли в рамках модели идеального p-n –перехода.
. Впервые она была выведена У.
Шокли в рамках модели идеального p-n –перехода.

Рис. 7.30 Предполагаемая ВАХ p-n –перехода
7.6.3.1.
ИДЕАЛЬНЫЙ p-n-ПЕРЕХОД
ШОКЛИ.
Идеальный p-n – переход Шокли определяется следующими условиями.
1. p-n –переход
плоский.
2. p-n –переход настолько тонкий, что имеют место два
следствия:
Встроенное поле ![]() сообщает носителю на длине свободного пробега
сообщает носителю на длине свободного пробега ![]() энергию
энергию ![]() . Это значит, что потери
энергии носителей при столкновениях с атомами, имеющие порядок
. Это значит, что потери
энергии носителей при столкновениях с атомами, имеющие порядок ![]() , не искажают их движения;
, не искажают их движения;
2.2.Носители пролетают ОПЗ столь
быстро, что не успевают
рекомбинировать. Следовательно, полный электронный ток
одинаков
на границах ОПЗ и нейтральных областей. То же
самое
можно утверждать и о дырочном токе.
3. Смещение ![]() значительно меньше высоты равновесного потенциального барьера
значительно меньше высоты равновесного потенциального барьера ![]() ,
, ![]() . Вследствие этого концентрация
основных носителей заряда намного больше концентрации инжектированных неосновных
носителей заряда, и последние не влияют на движение первых.
. Вследствие этого концентрация
основных носителей заряда намного больше концентрации инжектированных неосновных
носителей заряда, и последние не влияют на движение первых.
4. Размеры p- и n-областей намного больше диффузионных длин ![]() и
и ![]() соответственно. Поэтому можно не учитывать
влияние их внешних границ.
соответственно. Поэтому можно не учитывать
влияние их внешних границ.
Полный ток ![]() одинаков
в любом сечении p-n
–структуры. Однако электронный
одинаков
в любом сечении p-n
–структуры. Однако электронный ![]() и дырочный
и дырочный ![]() токи в разных сечениях имеют разную величину и
разную природу. Поэтому для вычисления
целесообразно выбрать то сечения, в котором
токи в разных сечениях имеют разную величину и
разную природу. Поэтому для вычисления
целесообразно выбрать то сечения, в котором ![]() и
и ![]() вычисляются проще всего.
вычисляются проще всего.
Рассмотрим токи в p-n –структуре
при прямом смещении. Её можно разбить на 5 слоёв (рис. 7.31а).
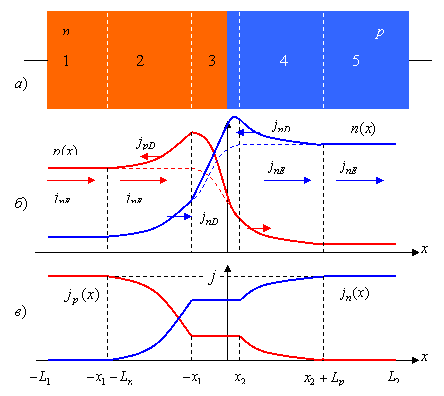
Рис.
7.31 Токи в p-n
– структуре при прямом смещении
В слое 1, примыкающем к внешней границе p-области, электроны и дырки распределены однородно,
причём электронов ничтожно мало, поэтому ток создаётся практически только дырками, дрейфующими в слабом
поле ![]() ,
,
![]() (7.6.34)
(7.6.34)
Аналогично, в слое 5, примыкающем к внешней границе n-области, ток создаётся только однородно распределёнными
электронами, дрейфующими в слабом поле ![]() ,
,
![]() (7.6.35)
(7.6.35)
В слое 2, примыкающем в ОПЗ, диффундируют
инжектированные электроны и дрейфуют дырки, создавая токи ![]() и
и ![]() соответственно. Кроме того, имеется ещё и
дырочный диффузионный ток
соответственно. Кроме того, имеется ещё и
дырочный диффузионный ток ![]() , направленный против
, направленный против ![]() . Неоднородное распределение
дырок в слое 2 обусловлено их приходом через внешний вывод для нейтрализации
инжектированных избыточных электронов. На рис. 7.31б оно показано в сильно преувеличенном
для наглядности масштабе. Концентрация пришедших дырок
. Неоднородное распределение
дырок в слое 2 обусловлено их приходом через внешний вывод для нейтрализации
инжектированных избыточных электронов. На рис. 7.31б оно показано в сильно преувеличенном
для наглядности масштабе. Концентрация пришедших дырок ![]() в точности равна концентрации избыточных
электронов
в точности равна концентрации избыточных
электронов ![]() , поэтому полная дырочная
концентрация равна
, поэтому полная дырочная
концентрация равна ![]() . Таким образом, в слое 2 дырочный
ток уменьшается вблизи ОПЗ, а электронный ток растёт, так что полный ток
. Таким образом, в слое 2 дырочный
ток уменьшается вблизи ОПЗ, а электронный ток растёт, так что полный ток
![]() (7.6.36)
(7.6.36)
остаётся постоянным. Аналогичное соотношение
можно записать для примыкающего к ОПЗ слою 4,
![]() (7.6.37)
(7.6.37)
Здесь
электронный диффузионный ток обусловлен неоднородностью концентрации
электронов, возникающей вследствие нейтрализации инжектированных дырок
электронами, вошедшими из внешней цепи. Вблизи ОПЗ электронный ток ![]() убывает, а дырочный ток растёт, так что полный
ток остаётся постоянным.
убывает, а дырочный ток растёт, так что полный
ток остаётся постоянным.
Наконец, в ОПЗ (слой 3) ток создаётся дрейфующими и
диффундирующими электронами и дырками. В
силу условия идеальности 2.2 в любой точке ОПЗ дырочный ток одинаков и равен
![]() (7.6.38)
(7.6.38)
По той же причине электронный ток в ОПЗ равен
![]() (7.6.39)
(7.6.39)
Распределение
токов в структуре показано на рис. 7.31в.
Полный ток целесообразно вычислять либо в
сечении ![]()
![]() (7.6.40)
(7.6.40)
либо
в сечении ![]() ,
,
![]() (7.6.41)
(7.6.41)
Электронный
ток ![]() чисто диффузионный, а дырочный ток
чисто диффузионный, а дырочный ток ![]() содержит и диффузионную, и дрейфовую
составляющую. Но согласно (7.6.38), он равен чисто диффузионному току
содержит и диффузионную, и дрейфовую
составляющую. Но согласно (7.6.38), он равен чисто диффузионному току ![]() ! Поэтому (7.6.40) принимает
вид
! Поэтому (7.6.40) принимает
вид
![]() (7.6.42)
(7.6.42)
Точно
такое же соотношение следует из (7.6.41), если заменить ![]() согласно (7.6.39).
согласно (7.6.39).
Таким образом, полный ток есть сумма диффузионных токов инжектированных
неосновных носителей на границах ОПЗ. Для вычисления диффузионных
токов надо знать распределения избыточных носителей ![]() и
и ![]() , тогда как для вычисления
дрейфового тока, например, в сечении
, тогда как для вычисления
дрейфового тока, например, в сечении ![]() , надо знать поле
, надо знать поле ![]() , найти которое гораздо сложнее.
В этом и состоит преимущество выбора сечений
, найти которое гораздо сложнее.
В этом и состоит преимущество выбора сечений ![]() и
и ![]() .
.
6.7.3.2. ВЫЧИСЛЕНИЕ РАСПРЕДЕЛЕНИЯ
ИНЖЕКТИРОВАННЫХ НОСИТЕЛЕЙ
Распределение инжектированных дырок в нейтральной n-области ![]() находим их уравнения (7.4.31)
находим их уравнения (7.4.31)
![]()
В
точках и
должны быть заданы граничные условия. Первое из них очень простое –
концентрация дырок на правом омическом контакте равна равновесной концентрации,
![]() (7.6.43)
(7.6.43)
В
соответствии с третьим условием идеальности положим ![]() , тогда граничное условие
примет вид
, тогда граничное условие
примет вид
![]() (7.6.44)
(7.6.44)
Это
существенно упростит решение уравнения (7.4.31). Второе граничное условие
получим, воспользовавшись формулой (![]() ). Согласно ей, концентрации
дырок на границах ОПЗ в состоянии равновесия связаны соотношением
). Согласно ей, концентрации
дырок на границах ОПЗ в состоянии равновесия связаны соотношением
![]() (7.6.45)
(7.6.45)
или, ![]() (
(![]() )
)
Будем
считать, что так же связаны концентрации дырок на границах ОПЗ и в
неравновесном состоянии, когда к p-n
–переходу приложено смещение ![]() ,
,
![]() (7.6.46)
(7.6.46)
На
самом деле (7.6.46) справедливо только приближённо, но обеспечивает хорошую
точность. Разделив (7.6.46) на (![]() ), получим
), получим
![]() (7.6.47)
(7.6.47)
Это
и есть искомое граничное условие.
Общее решение уравнения имеет вид

Из
условия (7.6.44) следует, что ![]() . Постоянную
. Постоянную ![]() находим из (7.6.47):
находим из (7.6.47):


Таким
образом,
 (7.6.48)
(7.6.48)
Аналогично, распределение инжектированных в p-область
электронов находим из уравнения
![]() (7.6.49)
(7.6.49)
С
граничными условиями
![]() (7.6.50)
(7.6.50)
![]() (7.6.51)
(7.6.51)
Оно
имеет вид
 (7.6.52)
(7.6.52)
6.7.3.3.
ВАХ ИДЕАЛЬНОГО p-n –ПЕРЕХОДА
Вольтамперную
характеристику идеального p-n – перехода
получим, подставив в (7.6.42) явные выражения для диффузионных токов,
![]()
Из
(7.6.48) и (7.6.52) имеем:
![]()
![]()
Таким
образом,

![]() (7.6.53)
(7.6.53)
![]() (7.6.54)
(7.6.54)
Точно также зависит от смещения полный ток ![]() через p-n
–переход,
через p-n
–переход, ![]() - площадь перехода,
- площадь перехода,
![]() (
(![]() )
)
Соотношение (7.6.53), называемое формулой Шокли, есть искомая ВАХ идеального p-n
–перехода. Из него следует, что при
увеличении прямого смещения (![]() ) ток инжекции возрастает
экспоненциально. При обратном смещении (
) ток инжекции возрастает
экспоненциально. При обратном смещении (![]() ) ток быстро выходит на
постоянное значение
) ток быстро выходит на
постоянное значение ![]() . Следовательно,
. Следовательно, ![]() есть введённый ранее ток насыщения (7.6.37).
Легко показать, что выражения (7.6.54) и (7.6.37) эквивалентны:
есть введённый ранее ток насыщения (7.6.37).
Легко показать, что выражения (7.6.54) и (7.6.37) эквивалентны:
![]()

Очень наглядно экспоненциальный характер прямой
ветви ВАХ виден на графике в полулогарифмическом масштабе. При смещении ![]() единицей в формуле Шокли можно пренебречь,
единицей в формуле Шокли можно пренебречь,
![]()
Логарифмируя,
находим ![]() (7.6.55)
(7.6.55)
Логарифм тока инжекции линейно зависит
от смещения (рис. 7.32)

Рис. 7.32
Полулогарифмическая ВАХ идеального p-n
– перехода
Тангенс
угла наклона ![]() равен угловому коэффициенту
равен угловому коэффициенту ![]() ,
,
![]() (7.6.56)
(7.6.56)
Для
идеального диода ![]() . Экстраполируя прямую до
пересечения с осью ординат, найдём значение логарифма тока насыщения
. Экстраполируя прямую до
пересечения с осью ординат, найдём значение логарифма тока насыщения ![]() , откуда
, откуда ![]() .
.
Таким образом, построив экспериментальную ВАХ в
полулогарифмическом масштабе, легко проверит, является ли p-n –
переход идеальным, и определить его ток насыщения.
7.6.3.4. ВАХ РЕАЛЬНОГО p-n – ПЕРЕХОДА
Измеряемые в экспериментах ВАХ реальных p-n –переходов,
как правило, отличаются от идеальной ВАХ Шокли. Отклонения обусловлены
нарушением условий идеальности. Рассмотрим их последовательно.
Первое условие идеальности нарушается вследствие
искривления ОПЗ вблизи её выхода на свободную поверхность полупроводника. ОПЗ искривляется адсорбированными на
поверхности технологическими молекулами. Электроположительные молекулы отдают
один из своих электронов полупроводнику и образуют положительно заряженный
поверхностный слой. Этот слой отталкивает от поверхности дырки и притягивает к
ней электроны. В результате происходит инверсия (то есть изменение знака)
проводимости в узком приповерхностном слое. Образуется, как говорят, канал n-типа (рис.
7.25). Толщина его порядка 0,01 мкм.
Границы ОПЗ теперь не параллельны металлургической границе, а их площадь ![]() гораздо больше
площади
гораздо больше
площади ![]() последней.
последней.
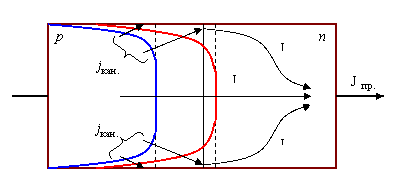
Рис. 7.25 Происхождение канальных
токов в p-n
–переходе
При прямом смещении носители инжектируются через всю поверхность S. Полный
ток инжекции равен
![]()
где
![]() - ток инжекции через плоскую ОПЗ,
- ток инжекции через плоскую ОПЗ, ![]() - так называемый канальный ток, равный току
инжекции через избыточную площадь
- так называемый канальный ток, равный току
инжекции через избыточную площадь ![]() .
.
При обратном смещении ток экстракции, пропорциональный
S, также
будет больше, чем у плоского p-n
– перехода.
Экспериментатор, интерпретирующий результаты измерений
в предположении, что площадь p-n
– перехода равна ![]() , вынужден будет
рассматривать канальный ток как
отклонение от модели Шокли.
, вынужден будет
рассматривать канальный ток как
отклонение от модели Шокли.
Если ОПЗ не бесконечно тонкая, то в ней, в нарушение
второго условия идеальности, будут иметь место
генерация электронно-дырочных пар и рекомбинация электронов и дырок.
Рекомбинация более вероятна при прямом смещении, когда
концентрации электронов и дырок в ОПЗ больше их равновесных значений. Она как
бы открывает дополнительный канал для тока через p-n
–переход, параллельный инжекционному
каналу (рис. 7.26).
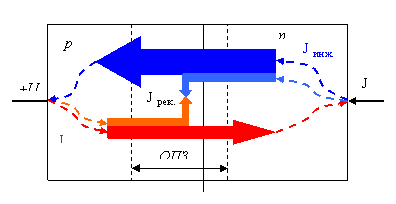
Рис. 7.26 Токи рекомбинации в ОПЗ
Генерация электронно-дырочных пар более вероятна при
обратном смещении, когда концентрации носителей в ОПЗ меньше равновесных.
Рождённый электроны и дырки тут же разделяются встроенным полем и выносятся в
одноимённые области (рис. 7.27).
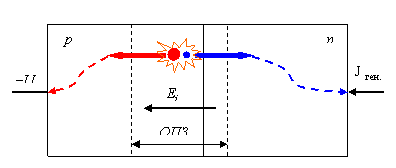
Рис. 7.27
Ток генерации в ОПЗ
Оценить
ток генерации легко. Скорость термогенерации ![]() равна равновесной скорости рекомбинации через
ловушки. Для p-области, где неосновные носители – электроны,
равна равновесной скорости рекомбинации через
ловушки. Для p-области, где неосновные носители – электроны,
![]() (7.6.57)
(7.6.57)
Тогда
плотность тока генерации ![]() равна заряду, генерируемому за 1с в объёме
равна заряду, генерируемому за 1с в объёме ![]() ,
,
![]() (7.6.58)
(7.6.58)
Аналогично,
скорость генерации в n-области,
![]() (7.6.59)
(7.6.59)
а
плотность тока генерации ![]() равна заряду, генерируемому за 1с в объёме
равна заряду, генерируемому за 1с в объёме ![]() ,
,
![]() (7.6.60)
(7.6.60)
Полный
ток генерации равен
 (7.6.61)
(7.6.61)
Он
течёт от n- к p-области, то есть в одном направлении с током насыщения.
Таким образом, прямой ток есть сумма тока инжекции ![]() , тока рекомбинации
, тока рекомбинации ![]() и канального тока
и канального тока ![]() ,
,
![]() (7.6.62)
(7.6.62)
а
обратный ток есть сумма тока насыщения ![]() , тока генерации
, тока генерации ![]() и канального тока
и канального тока ![]() ,
,
![]() (7.6.63)
(7.6.63)
Только
ток насыщения практически не зависит от смещения. Остальные компоненты прямого
и обратного токов определяются падением напряжения на ОПЗ.
Если сопротивления нейтральных областей эмиттера ![]() и
и ![]() базы
сопоставимы с сопротивлением ОПЗ, то нарушается четвёртое условие
идеальности. В этом случае на ОПЗ падает только часть
базы
сопоставимы с сопротивлением ОПЗ, то нарушается четвёртое условие
идеальности. В этом случае на ОПЗ падает только часть ![]() смещения
смещения
![]() , так что
, так что
![]()
Прямую
ветвь ВАХ реального p-n
–перехода получим, подставив ![]() в (7.6.62),
в (7.6.62),
![]()
![]()
![]() (7.6.64)
(7.6.64)
Это
есть нелинейное уравнение, из которого следует находить зависимость ![]() . Сделать это можно только
численными методами, что на практике неудобно. Поэтому прямую ветвь ВАХ p-n –перехода аппроксимируют двухпараметрической
экспоненциальной зависимостью
. Сделать это можно только
численными методами, что на практике неудобно. Поэтому прямую ветвь ВАХ p-n –перехода аппроксимируют двухпараметрической
экспоненциальной зависимостью
![]() (7.6.65)
(7.6.65)
в
которой ![]() и
и ![]() - эмпирические подгоночные параметры.
- эмпирические подгоночные параметры. ![]() называется током насыщения,
называется током насыщения, ![]() - коэффициентом
неидеальности. У идеального p-n –
перехода
- коэффициентом
неидеальности. У идеального p-n –
перехода ![]() . У большинства реальных p-n –переходов
. У большинства реальных p-n –переходов
![]() , хотя не редкость и p-n –переходы с
, хотя не редкость и p-n –переходы с ![]() .
.
Аналогично,
обратную ветвь ВАХ получим, подставив ![]() в (7.6.63)
в (7.6.63)
![]() (7.6.65)
(7.6.65)
7.6.3.5. ПРОБОЙ p-n – ПЕРЕХОДА
Особый случай отличия реальной ВАХ p-n –
перехода от идеальной представляет пробой
p-n
– перехода – резкое возрастание обратного
тока при некотором значении смещения ![]() . Напряжение пробоя может
лежать в интервале от
. Напряжение пробоя может
лежать в интервале от ![]() до
до ![]() для мощных приборов.
для мощных приборов.
Пробои бывают поверхностные и объёмные. Поверхностный
пробой возникает в месте выхода ОПЗ на поверхность вследствие адсобрции из
атмосферы проводящего молекулярного слоя. С ним борются технологическими
приёмами.
Объёмный пробой обусловлен физическими причинами. Он
может иметь тепловую или электрическую природу. Тепловой пробой происходит
из-за повышения температуры p-n – перехода.
Электрический пробой происходит либо вследствие ударной ионизации в ОПЗ, либо
вследствие туннелирования электронов из валентной зоны в зону проводимости. В
первом случае пробой называется лавинным,
во втором случае – туннельным.
Механизм объёмного пробоя и значения напряжения
пробоя определяются шириной ОПЗ ![]() , а, так как
, а, так как

то,
в конечном итоге, уровнем легирования базы.
При низком уровне легирования базы ОПЗ широкая, а
встроенное поле слабое. Обратное смещение ещё больше расширяет ОПЗ. При
столкновении дрейфующих носителей с атомами
кинетическая энергия, приобретённая ими на длине свободного пробега,
полностью переходит в энергию атомных колебаний, и, в конечном итоге, в джоулево
тепло. Джоулево тепло разогревает ОПЗ,
и, если теплоотвод недостаточен, температура её может повыситься настолько, что
начнётся интенсивная термогенерация носителей. Прирост тока ещё больше
увеличивает тепловыделение, в результате интенсивность генерации также
возрастёт. Так замыкается тепловая положительная обратная связь, в результате
происходит локальное плавление полупроводника и необратимый выход прибора из
строя. Тепловой пробой, таким образом,
является необратимым, поэтому допускать
его ни в коем случае нельзя. Повышение температуры внешней среды
способствует тепловому пробою. ВАХ теплового пробоя для двух температур среды показаны
на рис.7.28.

Рис. 7.28
Обратная ветвь ВАХ p-n
–перехода при тепловом пробое
При повышении
уровня легирования базы толщина ОПЗ уменьшается, а встроенное поле усиливается.
Теперь дрейфующие в ОПЗ носители способны набрать на длине свободного пробега
кинетическую энергию, достаточную для совершения при столкновении ударной ионизации
атомов – отрыва связанного электрона и превращения его в свободный носитель. В
этом акте кинетическая энергия первичного электрона передаётся не решётке, а
оторванному электрону, поэтому температура решётки не повышается, но происходит
размножение носителей по показательному закону. После ![]() столкновений число носителей возрастает
примерно в
столкновений число носителей возрастает
примерно в ![]() раз. Такое
размножение носителей и возрастание обратного тока называется лавинным пробоем.
ВАХ лавинного пробоя показаны на рис.7.29 также для двух температур среды. При
повышении температуры среды пробойное напряжение, в отличие от теплового
пробоя, повышается. Причина состоит в том, что с ростом температуры
увеличивается интенсивность теплового движения атомов и рассеяние ими
носителей. В результате уменьшается
длина свободного побега носителя, и он не способен уже в поле прежней величины
набрать энергию, достаточную для ударной ионизации. Требуется повысить обратное
смещение, чтобы усилить поле в ОПЗ.
раз. Такое
размножение носителей и возрастание обратного тока называется лавинным пробоем.
ВАХ лавинного пробоя показаны на рис.7.29 также для двух температур среды. При
повышении температуры среды пробойное напряжение, в отличие от теплового
пробоя, повышается. Причина состоит в том, что с ростом температуры
увеличивается интенсивность теплового движения атомов и рассеяние ими
носителей. В результате уменьшается
длина свободного побега носителя, и он не способен уже в поле прежней величины
набрать энергию, достаточную для ударной ионизации. Требуется повысить обратное
смещение, чтобы усилить поле в ОПЗ.

Рис.
7.29 ВАХ лавинного пробоя при двух температурах среды
Если лавинный ток не ограничивать, то он, в конце
концов, также приведёт к разрушению прибора. Реально он ограничивается последовательными
сопротивлениями, поэтому лавинный пробой не приводит к катастрофическим
последствиям для прибора, хотя может вывести его из рабочего режима. При
уменьшении обратного смещения лавина ослабевает и восстанавливается исходное
высокоомное состояние p-n
–перехода. Лавинный пробой является,
таким образом, обратимым.
При высоких уровнях легирования p- и n-областей ![]() толщина ОПЗ составляет несколько сот ангстрем, а диффузионный
потенциал превышает ширину запрещённой зоны. Равновесная энергетическая
диаграмма такого вырожденного p-n –перехода
показана на рис. 7.30а. Электроны
могут переходить из зоны проводимости в валентную зону, преодолевая узкий потенциальный
барьер посредством туннельного эффекта без затрат энергии, при условии, что в
валентной зоне имеются дырки с той же энергией. Но как раз в равновесном
состоянии в валентной зоне все дырки находятся в состояниях с бόльшими,
чем у электронов, энергиями, поэтому туннельные переходы невозможны. При
обратном смещении дырочные уровни энергии поднимаются на
толщина ОПЗ составляет несколько сот ангстрем, а диффузионный
потенциал превышает ширину запрещённой зоны. Равновесная энергетическая
диаграмма такого вырожденного p-n –перехода
показана на рис. 7.30а. Электроны
могут переходить из зоны проводимости в валентную зону, преодолевая узкий потенциальный
барьер посредством туннельного эффекта без затрат энергии, при условии, что в
валентной зоне имеются дырки с той же энергией. Но как раз в равновесном
состоянии в валентной зоне все дырки находятся в состояниях с бόльшими,
чем у электронов, энергиями, поэтому туннельные переходы невозможны. При
обратном смещении дырочные уровни энергии поднимаются на ![]() , и электроны получают возможность
совершить туннельный переход (рис. 7.30б).
При увеличении смещения туннельный ток резко возрастает вследствие
увеличения как плотности занятых
электронами состояний в валентной зоне,
так и плотности доступных для электронов состояний в зоне проводимости.
, и электроны получают возможность
совершить туннельный переход (рис. 7.30б).
При увеличении смещения туннельный ток резко возрастает вследствие
увеличения как плотности занятых
электронами состояний в валентной зоне,
так и плотности доступных для электронов состояний в зоне проводимости.
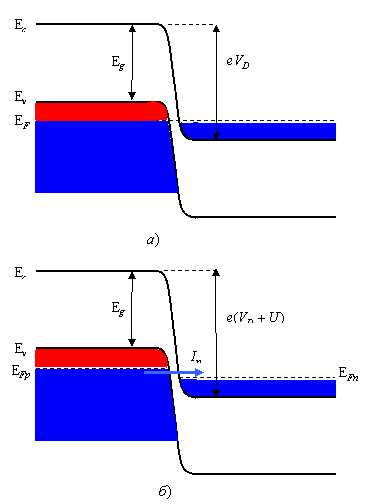
Рис. 7.30
энергетическая диаграмма вырожденного p-n -перехода
7.4.4.
РЕАКЦИЯ p-n – ПЕРЕХОДА НА ПЕРЕМЕННОЕ СМЕЩЕНИЕ
ВАХ описывает стационарное состояние p-n – перехода,
установившееся через большой промежуток времени после приложения постоянного
прямого или обратного смещения. Переход в это состояние не может, как и любой
процесс в природе, произойти мгновенно. Он происходит в течение некоторого
конечного интервала времени через ряд промежуточных состояний. Процесс установления стационарного состояния
называется, поэтому переходным
процессом. Скорость перехода из одного состояния, определяемого смешением ![]() , в другое состояние, определяемое
смещением
, в другое состояние, определяемое
смещением ![]() , является имманентным
свойством p-n
– перехода. Поэтому характер переходного
процесса зависит от соотношения упомянутой скорости перехода и скорости
изменения самого смещения. Представляет
интерес реакция p-n - перехода
на переменное смещение двух типов:
, является имманентным
свойством p-n
– перехода. Поэтому характер переходного
процесса зависит от соотношения упомянутой скорости перехода и скорости
изменения самого смещения. Представляет
интерес реакция p-n - перехода
на переменное смещение двух типов:
-гармоническое смещение, изменяющееся по закону ![]() .
.
- импульсное смещение, описывающее включение,
переключение и выключение p-n
– перехода;
Рассмотрим сначала первый случай. Под действием
гармонического смещения с тем же периодом изменяются потенциальный барьер p-n
– перехода ![]() и толщина ОПЗ
и толщина ОПЗ ![]() . При расширении или сужении
ОПЗ уменьшается или увеличиваются суммарные заряды основных носителей в базе и эмиттере, нейтрализующих доноры и акцепторы,
за счёт их оттока во внешнюю цепь или притока из внешней цепи. При понижении
или повышении потенциального барьера возрастает или убывает суммарный заряд неосновных
носителей в базе и эмиттере
вследствие их инжекции или экстракции. Относительная роль этих процессов
различна при прямом и обратном смещении.
. При расширении или сужении
ОПЗ уменьшается или увеличиваются суммарные заряды основных носителей в базе и эмиттере, нейтрализующих доноры и акцепторы,
за счёт их оттока во внешнюю цепь или притока из внешней цепи. При понижении
или повышении потенциального барьера возрастает или убывает суммарный заряд неосновных
носителей в базе и эмиттере
вследствие их инжекции или экстракции. Относительная роль этих процессов
различна при прямом и обратном смещении.
7.4.4.1
ПРЯМОЕ ГАРМОНИЧЕСКОЕ СМЕЩЕНИЕ
Пусть к p-n – переходу
приложено переменное смещение ![]() , причём постоянная составляющая
, причём постоянная составляющая
![]() , а
, а ![]() . При столь малых смещениях
изменением толщины ОПЗ можно пренебречь. Основную роль играет изменение
потенциального барьера.
. При столь малых смещениях
изменением толщины ОПЗ можно пренебречь. Основную роль играет изменение
потенциального барьера.
Под действием смещения ![]() вследствие инжекции неосновных носителей
устанавливается их стационарное распределение в базе и эмиттере (рис. 7.31).
вследствие инжекции неосновных носителей
устанавливается их стационарное распределение в базе и эмиттере (рис. 7.31).
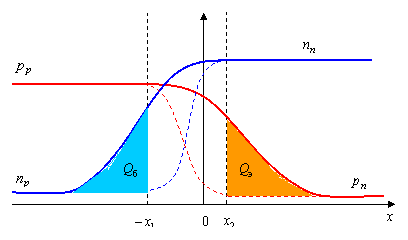
Рис. 7.31
Стационарное раседеление ННЗ при смещении ![]()
Его можно охарактеризовать граничными концентрациями
![]()
![]()
или
накопленными избыточным зарядами в базе
 (7.6.67)
(7.6.67)
и
эмиттере
 (7.6.68)
(7.6.68)
Стационарные
распределения ННЗ найдены нами ранее (формулы (7.6.48) и (7.6.52)). Подставив
их в (7.6.67) и (7.6.68) и выполнив интегрирование, получим

![]() (7.6.69)
(7.6.69)

![]() (7.6.70)
(7.6.70)
Если
теперь приложить в дополнение к ![]() переменное смещение
переменное смещение ![]() , то в течение первой четверти
периода суммарное смещение будет расти, следовательно, инжекция усилится, в
базе и эмиттере накопятся дополнительные заряды неосновных носителей
, то в течение первой четверти
периода суммарное смещение будет расти, следовательно, инжекция усилится, в
базе и эмиттере накопятся дополнительные заряды неосновных носителей ![]() и
и ![]() . Для поддержания нейтральности
в эмиттер и базу из внешней цепи войдут точно такие же по величине заряды
основных носителей противоположного знака. Их ток течёт во внешнюю цепь из n-области и
из внешней цепи в p-область. В течение следующего полупериода смещение
уменьшается, инжекция ослабевает, уменьшаются накопленные заряды в эмиттере и
базе. Следовательно. Для поддержания нейтральности должны уйти во внешнюю цепь
основные носители – электроны из n-области и дырки из p-области. Ток во внешней цепи меняет направление на
противоположное (рис.7.32).
. Для поддержания нейтральности
в эмиттер и базу из внешней цепи войдут точно такие же по величине заряды
основных носителей противоположного знака. Их ток течёт во внешнюю цепь из n-области и
из внешней цепи в p-область. В течение следующего полупериода смещение
уменьшается, инжекция ослабевает, уменьшаются накопленные заряды в эмиттере и
базе. Следовательно. Для поддержания нейтральности должны уйти во внешнюю цепь
основные носители – электроны из n-области и дырки из p-области. Ток во внешней цепи меняет направление на
противоположное (рис.7.32).
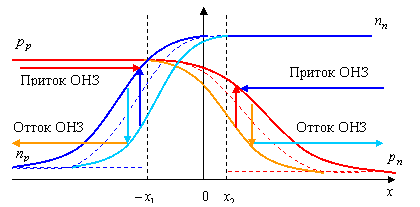
Рис.
7.32 Баланс зарядов при прямом переменном смещении
Таким
образом, под воздействием гармонического смещения периодически изменяются
накопленные заряды в эмиттере и базе, а
во внешней цепи протекает гармонический ток. Точно так же ведёт себя обыкновенный
конденсатор. Следовательно, p-n –переход обладает ёмкостными свойствами. Емкость,
обусловленная накоплением избыточных зарядов неосновных носителей при прямом
смещении, называется диффузионной и обозначается ![]() . Её можно определить соотношением
. Её можно определить соотношением
![]()
где
![]() – суммарный накопленный в базе и эмиттере избыточный
заряд. Дифференцируя (7.6.69) и (7.6.70), получим ёмкость единицы площади p-n - перехода
– суммарный накопленный в базе и эмиттере избыточный
заряд. Дифференцируя (7.6.69) и (7.6.70), получим ёмкость единицы площади p-n - перехода
![]() (7.6.71)
(7.6.71)
В
несимметричном p-n –переходе
доминирует одно из слагаемых. Если ![]() , то из закона действующих
масс следует, что
, то из закона действующих
масс следует, что ![]() , тогда
, тогда
![]() (7.6.72)
(7.6.72)
Диффузионная ёмкость прямо
пропорциональна току инжекции и времени жизни неосновных носителей в базе.
7.4.4.2.
ОБРАТНОЕ ГАРМОНИЧЕСКОЕ СМЕЩЕНИЕ
При обратном гармоническом смещении изменение заряда
основных носителей в базе и эмиттере ![]() вследствие изменения толщины ОПЗ намного
больше, чем изменение заряда неосновных носителей
вследствие изменения толщины ОПЗ намного
больше, чем изменение заряда неосновных носителей ![]() вследствие экстракции. Это видно уже из рис.
7.33. Легко получить и выражение для изменений зарядов.
вследствие экстракции. Это видно уже из рис.
7.33. Легко получить и выражение для изменений зарядов.
![]() (7.6.73)
(7.6.73)
![]() (7.6.74)
(7.6.74)
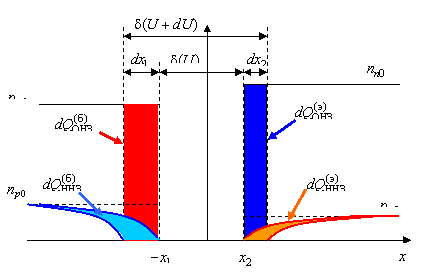
Рис. 7.33 Динамика зарядов при обратном
смещении
Из (7.6.73) и (7.6.74) следует, что действительно,
![]()
При гармоническом обратном смещении происходит
перезарядка слоев ОПЗ, граничащих с эмиттером и базой. Во внешней цепи протекает
гармонический ток. Следовательно, p-n – переход
снова ведёт себя как конденсатор. Ёмкость, обусловленная перезарядкой ОПЗ при обратном смещении,
называется барьерной, и обозначается
![]() . Её можно определить
соотношением
. Её можно определить
соотношением
![]()
Тогда из (7.6.74) получаем
![]()
![]()
 (7.6.75)
(7.6.75)
Барьерная ёмкость единицы
площади p-n –перехода равна ёмкости плоского
конденсатора с расстоянием между пластинами, равным толщине ОПЗ ![]() . Она зависит, как это следует
из (7.6.75), от приложенного смещения. Эта зависимость называется вольтфарадной
характеристикой p-n - перехода.
. Она зависит, как это следует
из (7.6.75), от приложенного смещения. Эта зависимость называется вольтфарадной
характеристикой p-n - перехода.
7.6.4.3.ИМПУЛЬСНОЕ СМЕЩЕНИЕ
Импульсным
называется смещение, мгновенно изменяющееся от одного постоянного значения до
другого постоянного значения. Возможные
типы импульсов показаны на рис. 7.35.

Рис. 7.35 Типы импульсных напряжений
Ступенчатое
входное напряжение включает прямое смещение диода, прямоугольный импульс
включает и выключает прямое смещение, меандр производит периодическое
переключение с прямого смещения на обратное. Реакцию p-n –перехода на импульсное смещение удобно исследовать с
помощью простейшей схемы, состоящей из последовательно соединённых полупроводникового
диода и резистора (рис. 7.36).

Рис. 7.36
Схема для изучения переходных процессов в p-n
–переходе
В зависимости от величины сопротивления R различают
два случая. Если сопротивление R намного меньше сопротивления p-n –перехода
по постоянному току при прямом смещении ![]() , то можно считать, что всё
входное напряжение падает на диоде,
, то можно считать, что всё
входное напряжение падает на диоде,
![]()
В
таком случае говорят, что диод включается
и переключается импульсом напряжения.
Переходный процесс состоит в установлении тока
в цепи.
Если R намного больше сопротивления ![]() , то всё входное напряжение
падает на нём, следовательно, ток в цепи остаётся практически постоянным,
, то всё входное напряжение
падает на нём, следовательно, ток в цепи остаётся практически постоянным,
![]()
Говорят,
что p-n – переход
включается импульсом тока. Переходный процесс состоит в установлении напряжения на диоде. При переключении из
прямого смещения на обратное переходный процесс состоит в установлении
напряжения и тока.
Корректная теория переходных процессов в диоде весьма
сложна и громоздка. Поэтому ограничимся их качественным описанием.
Рассмотрим сначала включение и выключение p-n – перехода
импульсом напряжения. До момента
времени p-n –переход находится в состоянии равновесия, которое
можно охарактеризовать распределением носителей, показанным на рис. 7.36
пунктиром. Ток в цепи отсутствует (рис. 7.37).
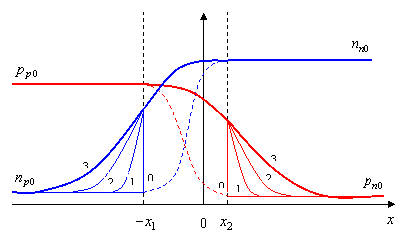
Рис.
7.37 Распределение носителей при включении диода
импульсом
напряжения.
В
момент времени ![]() напряжение на ОПЗ скачком возрастает до
значения
напряжение на ОПЗ скачком возрастает до
значения ![]() , что вызывает столь же резкое
повышение граничных концентраций носителей в соответствии с формулами (7.6.47)
и (7.6.50). Образуются огромные (формально – бесконечные) градиенты концентраций
носителей
, что вызывает столь же резкое
повышение граничных концентраций носителей в соответствии с формулами (7.6.47)
и (7.6.50). Образуются огромные (формально – бесконечные) градиенты концентраций
носителей ![]() и
и ![]() . Следовательно, диффузионные
токи
. Следовательно, диффузионные
токи ![]() и
и ![]() в момент включения также очень велики. В
последующие моменты граничные концентрации не меняются, в базе и эмиттере
накапливаются инжектированные носители, распределения которых становятся всё
более плавными. Ток
в момент включения также очень велики. В
последующие моменты граничные концентрации не меняются, в базе и эмиттере
накапливаются инжектированные носители, распределения которых становятся всё
более плавными. Ток ![]() при этом быстро убывает и стремится к
постоянному значению
при этом быстро убывает и стремится к
постоянному значению ![]() , определяемому вольтамперной характеристикой. Соответствие
распределений носителей и токов показано на рис. 7.37 и 7.38 точками 0, 1, 2,
3.
, определяемому вольтамперной характеристикой. Соответствие
распределений носителей и токов показано на рис. 7.37 и 7.38 точками 0, 1, 2,
3.
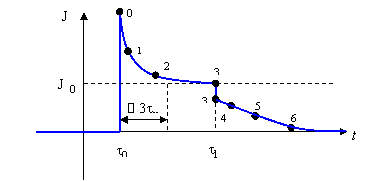
Рис.
7.37 Ток при включении диода импульсом напряжения
Длительность
фазы установления прямого тока составляет ![]() времени жизни носителей в базе. Далее ток остаётся
постоянным вплоть до момента выключения напряжения
времени жизни носителей в базе. Далее ток остаётся
постоянным вплоть до момента выключения напряжения ![]() . В момент
. В момент ![]() напряжение
скачком падает до нуля. Это эквивалентно короткому замыканию входной
цепи. Напряжение на диоде также скачком
уменьшается на величину его падения на нейтральной части базы. Запертые в базе
и эмиттере избыточные носители не могут из них уйти, и вынуждены там же
рекомбинировать. Граничные концентрации стремятся к равновесным значениям, а
напряжение на p-n –
переходе – к нулю. Сразу после переключения
напряжение убывает линейно, а спустя
напряжение
скачком падает до нуля. Это эквивалентно короткому замыканию входной
цепи. Напряжение на диоде также скачком
уменьшается на величину его падения на нейтральной части базы. Запертые в базе
и эмиттере избыточные носители не могут из них уйти, и вынуждены там же
рекомбинировать. Граничные концентрации стремятся к равновесным значениям, а
напряжение на p-n –
переходе – к нулю. Сразу после переключения
напряжение убывает линейно, а спустя ![]() времени жизни носителей в базе закон убывания
становится экспоненциальным. Соответствие распределений носителей и напряжения
на диоде показано точками 3, 4, 5, 6 на рис. 7.38 и 7.39.
времени жизни носителей в базе закон убывания
становится экспоненциальным. Соответствие распределений носителей и напряжения
на диоде показано точками 3, 4, 5, 6 на рис. 7.38 и 7.39.
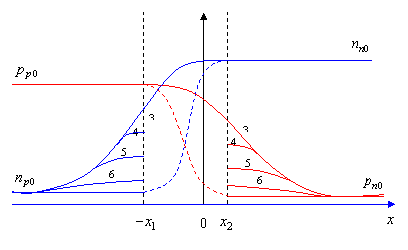
Рис.
7.39 Распределение носителей при выключении
импульса
напряжения
Рассмотрим теперь включение в момент ![]() и переключение в момент
и переключение в момент ![]() диода импульсом тока. Поскольку ток на
границе ОПЗ является чисто диффузионным, то его постоянство означает постоянство
производных
диода импульсом тока. Поскольку ток на
границе ОПЗ является чисто диффузионным, то его постоянство означает постоянство
производных ![]() и
и ![]() . В момент
. В момент ![]() начинается инжекция. Граничные концентрации
монотонно увеличиваются (рис. 7.40).
начинается инжекция. Граничные концентрации
монотонно увеличиваются (рис. 7.40).
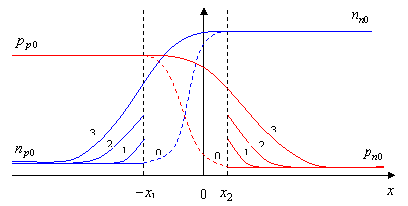
Рис.
7.39 Распределение носителей при включении диода
импульсом тока
Вместе
с ними растёт и напряжение на ОПЗ ![]() . Оно связано с мгновенным
значением граничной концентрации соотношением (7.6.50)
. Оно связано с мгновенным
значением граничной концентрации соотношением (7.6.50)
![]()
из
которого находим
 (7.6.76)
(7.6.76)
Одновременно
монотонно убывает падение напряжения ![]() на нейтральной части базы (и на нейтральной
части эмиттера, но последнее намного меньше первого), так как вследствие
накопления инжектированных носителей сопротивление её уменьшается. Сумма
на нейтральной части базы (и на нейтральной
части эмиттера, но последнее намного меньше первого), так как вследствие
накопления инжектированных носителей сопротивление её уменьшается. Сумма
![]()
есть
падение напряжения на диоде. График его показан на рис. 7.41. В момент ![]() входное напряжение скачком принимает
значение
входное напряжение скачком принимает
значение ![]() , а ток меняет направление на
обратное. Это напряжение должно почти всё падать на диоде, ток же должен
равняться току насыщения диода
, а ток меняет направление на
обратное. Это напряжение должно почти всё падать на диоде, ток же должен
равняться току насыщения диода ![]() . Но мгновенно такое состояние
установиться не может. Сразу после переключения значение обратного тока определяется сопротивлением R, так как сопротивление диода с накопленными
носителями очень мало,
. Но мгновенно такое состояние
установиться не может. Сразу после переключения значение обратного тока определяется сопротивлением R, так как сопротивление диода с накопленными
носителями очень мало,
![]()
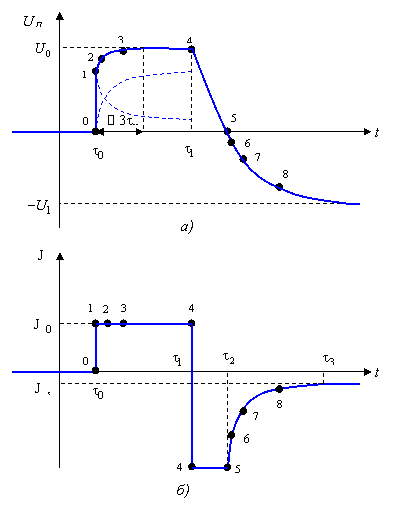
Рис. 7.41 Напряжение на диоде при включении
и переключении
импульсом тока
Граничные
концентрации ![]() и
и ![]() при
при ![]() принимают такие значения, чтобы производные
принимают такие значения, чтобы производные ![]() и
и ![]() соответствовали граничным условиям
соответствовали граничным условиям
![]()
![]()
где
![]() - коэффициент инжекции, S – площадь p-n -перехода. Под действием градиентов концентраций
электроны диффундируют назад в n-область, а дырки – назад в p-область.
Граничные концентрации при этом монотонно убывают, вместе с ними по закону
(7.6.76) убывает и прямое напряжение на ОПЗ
- коэффициент инжекции, S – площадь p-n -перехода. Под действием градиентов концентраций
электроны диффундируют назад в n-область, а дырки – назад в p-область.
Граничные концентрации при этом монотонно убывают, вместе с ними по закону
(7.6.76) убывает и прямое напряжение на ОПЗ ![]() . Обратный ток остаётся постоянным
до тех пор, пока граничные концентрации не достигнут равновесных значений. Это
произойдёт в некоторый момент
. Обратный ток остаётся постоянным
до тех пор, пока граничные концентрации не достигнут равновесных значений. Это
произойдёт в некоторый момент ![]() . После этого накопленных
носителей уже недостаточно для поддержания постоянных граничных градиентов.
Напряжение на диоде становится обратным и стремится к
. После этого накопленных
носителей уже недостаточно для поддержания постоянных граничных градиентов.
Напряжение на диоде становится обратным и стремится к ![]() . Обратный ток начинает
убывать по абсолютной величине, и спустя
. Обратный ток начинает
убывать по абсолютной величине, и спустя ![]() времени жизни носителей становится равным току
насыщения. Соответствие распределений носителей, напряжения на диоде и тока в
цепи при
времени жизни носителей становится равным току
насыщения. Соответствие распределений носителей, напряжения на диоде и тока в
цепи при ![]() показаны на рис. 7.41 и 7.42.
показаны на рис. 7.41 и 7.42.
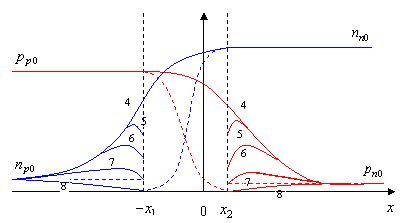
Рис. 7.42 Распределение носителей заряда при
переключении диода
импульсом тока
Промежуток
времени ![]() называется временем
рассасывания накопленного заряда, промежуток
называется временем
рассасывания накопленного заряда, промежуток ![]() называется
временем восстановления обратного
тока.
называется
временем восстановления обратного
тока.
Таким
образом, при включении, выключении и переключении полупроводникового диода в
цепи возникают импульсы тока очень значительной
величины. Они могут представлять опасность для других элементов электронных
схем, поэтому проектировать схемы следует так, чтобы минимизировать эту
опасность.
7.6.5.
ПОЛУПРОВОДНИКОВЫЕ ДИОДЫ
Полупроводниковым диодом называется прибор в одним p-n - переходом и двумя выводами от эмиттерной и базовой
областей. Размеры собственно полупроводниковой структуры составляют несколько
квадратных миллиметров. Размеры корпуса, в который она помещается, превосходят
её порядок (рис. 7.43)
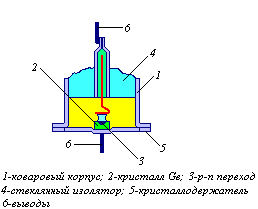
Рис. 7.43 Разрез полупроводникового диода
в корпусе
В основу классификации диодов положено их назначение,
из которого вытекают предъявляемые к ним требования, а они уже определяют конструктивные
особенности диода.
Выделяют следующие типы диодов:
- выпрямительные (силовые);
- стабилитроны;
- импульсные;
- высокочастотные;
- варикапы;
- другие.
При анализе электрических цепей диод заменяют его
эквивалентной схемой, учитывающей рассмотренные выше свойства p-n –перехода
(рис.7.44).

Рис.
7.44 Эквивалентная схема полупроводникового диода
Реакция
диода на смещение определяется областью пространственного заряда и нейтральной
частью базы. Падение напряжения на базе учитывается введением последовательного
сопротивления базы ![]() . ОПЗ представлена параллельно
соединёнными барьерной ёмкостью
. ОПЗ представлена параллельно
соединёнными барьерной ёмкостью ![]() , диффузионной ёмкостью
, диффузионной ёмкостью ![]() и дифференциальным сопротивлением p-n – перехода
и дифференциальным сопротивлением p-n – перехода ![]() . Дифференцируя выражение
(7.6.65) для прямой ветви ВАХ, находим
. Дифференцируя выражение
(7.6.65) для прямой ветви ВАХ, находим

При
прямом смещении дифференциальное сопротивление весьма мало. Например, при не
слишком большом токе ![]() и коэффициенте неидельности
и коэффициенте неидельности ![]() оно равно
оно равно ![]() . Обратные токи диодов слабо
зависят от смещения, поэтому дифференциальное сопротивление имеет порядок
. Обратные токи диодов слабо
зависят от смещения, поэтому дифференциальное сопротивление имеет порядок ![]() .
.
7.6.5.1. ВЫПРЯМИТЕЛЬНЫЕ ДИОДЫ
Выпрямительные
диоды предназначены для преобразования переменных токов низкой частоты (до 100
Гц) в пульсирующие токи. Они также
используются в сильноточных цепях в качестве развязывающих и коммутирующих элементов.
Во всех случаях используется нелинейность ВАХ, обеспечивающая практически
одностороннюю проводимости диода.
Простейшим является однополупериодный выпрямитель
(рис. 7.44).

Рис. 7.44 Однополупериодный выпрямитель
Входным является гармоническое напряжение ![]() , выходным - падение
напряжения на резисторе
, выходным - падение
напряжения на резисторе ![]() . Найти явную аналитическую
зависимость тока в цепи с нелинейным
элементом от падения напряжения на нём в общем случае нельзя. Поэтому такие
цепи рассчитываются графически методом
нагрузочной прямой. Сущность его состоит в следующем.
. Найти явную аналитическую
зависимость тока в цепи с нелинейным
элементом от падения напряжения на нём в общем случае нельзя. Поэтому такие
цепи рассчитываются графически методом
нагрузочной прямой. Сущность его состоит в следующем.
При последовательном соединении через нелинейный
элемент N и резистор R протекает одинаковый ток
![]() (7.6.77)
(7.6.77)
Он
однозначно определяется, с одной стороны, падением напряжения ![]() на нелинейном элементе, а, с другой стороны,
падением напряжения на резисторе
на нелинейном элементе, а, с другой стороны,
падением напряжения на резисторе ![]() . Поэтому равенство (7.6.77)
можно записать в виде
. Поэтому равенство (7.6.77)
можно записать в виде ![]() (7.6.78)
(7.6.78)
Левая
его часть есть ВАХ нелинейного элемента. Для диода она может быть представлена
формулой (7.6.65)
![]()
Правая
часть есть ВАХ резистора, подчиняющегося
закону Ома,
![]()
Таим образом,
имеем уравнение
![]() (7.6.79)
(7.6.79)
Графическое
решение его даётся точкой пересечения графиков ![]() и
и ![]() (рис. 7.75).
(рис. 7.75).

Рис. 7.75
Графический метод расчёта цепи с нелинейным элементом
Нагрузочная
прямая пересекает оси координат в точках ![]() и
и ![]() . Координаты точки
. Координаты точки ![]() определяют ток в цепи и падение напряжения на
нелинейном элементе. Котангенс угла
определяют ток в цепи и падение напряжения на
нелинейном элементе. Котангенс угла ![]() численно равен сопротивлению нагрузки,
численно равен сопротивлению нагрузки,
![]()
Таким
образом, чем больше нагрузочное сопротивление, тем более полога нагрузочная
прямая. Ток в цепи близок к току короткого замыкания ![]() , а падение напряжения на диоде
, а падение напряжения на диоде ![]() очень мало
При входном напряжении
очень мало
При входном напряжении ![]() нагрузочная прямая пересекает оси в точках
нагрузочная прямая пересекает оси в точках ![]() и
и ![]() , а ток в цепи и напряжение на
нелинейном элементе определяются точкой
, а ток в цепи и напряжение на
нелинейном элементе определяются точкой ![]() . Как следует из рис. 7.75,
ток в цепи при этом не превышает обратный ток диода, а падение напряжения на
диоде близко к
. Как следует из рис. 7.75,
ток в цепи при этом не превышает обратный ток диода, а падение напряжения на
диоде близко к ![]() .
.
Таким образом, если входное напряжение зависит от
времени гармонически, то выходное напряжение будет состоять из хорошо воспроизведённых
положительных полуволн и практически полностью обрезанных отрицательных
полуволн (рис. 7.76).
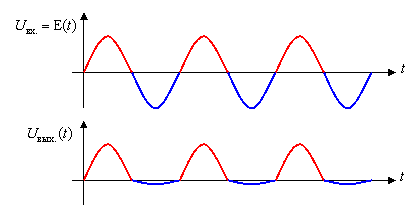
Рис. 7.76 Однополупериодное
выпрямление
Однополупериодное выпрямление применяется редко, так
как даёт большие пульсации тока. Гораздо чаще применяется двухполупериодное
выпрямление при включении диодов по мостовой схеме (рис. 7.77).

Рис.
7.77 Двухполупериодный мостовой выпрямитель
Входное
гармоническое напряжение прикладывается между точками а и в. Выходное напряжение снимается с
точек с и d. В течение нечётных периодов ток протекает через
диоды Д1 и Д3, в течение нечётных периодов – через диоды
Д2 и Д4. при этом потенциал точки c всегда
выше потенциала точки d, так что на выходе получается пульсирующий ток одной
полярности (рис. 7.78).
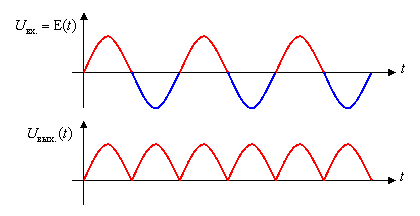
Рис. 7.78 Двухполупериодное
выпрямление
При использовании в цепях постоянного тока важны
следующие параметры:
- прямое падение напряжения ![]() ;
;
- постоянный обратный ток ![]() ;
;
- диапазон частот ![]() , в пределах которого
выпрямленный ток не уменьшается ниже некоторого уровня;
, в пределах которого
выпрямленный ток не уменьшается ниже некоторого уровня;
- максимально допустимый прямой ток ![]() ;
;
- максимально допустимое обратное напряжение ![]() ;
;
- максимальная рассеиваемая мощность ![]() ;
;
- диапазон температур окружающей среды ![]() , в пределах которого диод
сохраняет работоспособность.
, в пределах которого диод
сохраняет работоспособность.
Первые
два параметра должны быть как можно меньше, остальные – как можно больше.
Выпрямительные диоды изготавливают из Si, Ge, GaAs.
Наиболее распространены кремниевые диоды, так как они обладают наилучшим
комплексом эксплуатационных характеристик и высокой технологичностью. В
приводимой ниже таблице сравниваются по трём параметрам кремниевые и германиевые
диоды.
|
|
|
|
|
|
Si |
1500 |
20 |
150 |
|
Ge |
400 |
200 |
85 |
Преимущества
кремниевых диодов обусловлены в конечном итоге большей по сравнению с германием
шириной запрещённой зоны. Вследствие этого обратный ток в гераниевых диодах по
физической природе - тепловой ток насыщения, а в кремниевых диодах основной
вклад в обратный ток дают ток генерации и ток утечки.
Арсенид-галиевые диоды потенциально превосходят
кремниевые, но применяются реже последних из-за более сложной технологии производства.
Выпрямительные диоды изготавливаются по диффузионной
технологии.
7.6.5.2.
СТАБИЛИТРОНЫ
Стабилитронами
называются полупроводниковые диоды, используемые для поддержания на заданном уровне напряжения на нагрузке вне
зависимости от колебаний напряжения источника питания. Стабилитрон включается параллельно нагрузке (рис.
7.79). Такой стабилизатор напряжения называется параметрическим.

Рис.
7.79 Параметрический стабилизатор напряжения
В качестве стабилизатора напряжения может быть
использован любой нелинейный элемент, на ВАХ которого имеются участки с очень
резкой зависимостью тока от напряжения. Таковыми являются участки лавинного или
туннельного пробоя на обратной ветви ВАХ диода (рис. 7.80). Принцип
стабилизации напряжения легко объяснить с помощью метода нагрузочной прямой.
Исходим их очевидного соотношения для токов
![]()
При
напряжении на стабилитроне и нагрузке ![]() ток стабилитрона определяется ВАХ
ток стабилитрона определяется ВАХ ![]() , а ток нагрузки – законом
Ома
, а ток нагрузки – законом
Ома ![]() . Полный ток
. Полный ток ![]() , текущий через балластное
сопротивление
, текущий через балластное
сопротивление ![]() , в свою очередь, по закону
Ома равен
, в свою очередь, по закону
Ома равен ![]() . Таким образом, получаем
уравнение для
. Таким образом, получаем
уравнение для ![]() ,
,
![]()
которое
перепишем в виде
![]() (7.6.80)
(7.6.80)
Правая
часть (6.7.80) есть нагрузочная прямая. Она пересекает оси абсцисс и ординат в
точках ![]() и
и ![]() соответственно. Котангенс угла её наклона
равен
соответственно. Котангенс угла её наклона
равен
![]()
Напряжение
на стабилитроне и нагрузке и ток стабилитрона определяются точкой C.

Рис. 7.80 Принцип стабилизации
напряжения
Если
входное напряжение получит приращение ![]() , то нагрузочная прямая
сместится параллельно самой себе:
, то нагрузочная прямая
сместится параллельно самой себе: ![]() . Ток через стабилитрон изменится
на
. Ток через стабилитрон изменится
на ![]() . Но при этом, как следует из
рис. 7.80, напряжение на стабилитроне и нагрузке практически не изменится.
Более точно, его изменение
. Но при этом, как следует из
рис. 7.80, напряжение на стабилитроне и нагрузке практически не изменится.
Более точно, его изменение
![]()
так
как дифференциальное сопротивление стабилитрона ![]() на участке пробоя очень мало,
на участке пробоя очень мало,

Физическая
причина стабильности заключается в образовании отрицательной обратной связи.
Приращение входного напряжения ![]() должно было
бы вызвать приращение напряжения
должно было
бы вызвать приращение напряжения ![]() на стабилитроне и нагрузке. Но даже очень
небольшое
на стабилитроне и нагрузке. Но даже очень
небольшое ![]() вызывает большое приращение тока стабилитрона
вызывает большое приращение тока стабилитрона ![]() , а, значит, и суммарного тока
, а, значит, и суммарного тока
![]() . Это, в свою очередь,
вызывает увеличение на
. Это, в свою очередь,
вызывает увеличение на ![]() падения напряжения на балластном резисторе и
уменьшение его падения на стабилитроне и нагрузке на такую же величину. Цепь
обратной связи замкнулась. Замыкание обратной связи происходит очень быстро, поэтому
стабилитрон легко демпфирует низкочастотные колебания входного напряжения.
падения напряжения на балластном резисторе и
уменьшение его падения на стабилитроне и нагрузке на такую же величину. Цепь
обратной связи замкнулась. Замыкание обратной связи происходит очень быстро, поэтому
стабилитрон легко демпфирует низкочастотные колебания входного напряжения.
Основными параметрами стабилитронов являются:
-
напряжение пробоя, оно же напряжение стабилизации ![]() ;
;
-
интервал токов стабилизации ![]() ;
;
-
температурный коэффициент напряжения стабилизации
![]()
показывающий,
на сколько процентов изменится напряжение стабилизации при изменении
температуры на один градус.
У высоковольтных стабилитронов ![]() , а механизм пробоя лавинный.
При повышении температуры уменьшается средняя длина свободного пробега
носителей, поэтому пробой начинается в более сильных полях или при большем
обратном смещении. Поэтому
, а механизм пробоя лавинный.
При повышении температуры уменьшается средняя длина свободного пробега
носителей, поэтому пробой начинается в более сильных полях или при большем
обратном смещении. Поэтому ![]() .
.
У низковольтных стабилитронов ![]() , а механизм пробоя
туннельный. При повышении температуры уменьшается ширина запрещённой зоны
, а механизм пробоя
туннельный. При повышении температуры уменьшается ширина запрещённой зоны ![]() и, в соответствии с формулой (7.6.9), диффузионный
потенциал
и, в соответствии с формулой (7.6.9), диффузионный
потенциал ![]() . Следовательно, ОПЗ
становится тоньше, и туннельный пробой наступает при меньшем напряжении.
Поэтому
. Следовательно, ОПЗ
становится тоньше, и туннельный пробой наступает при меньшем напряжении.
Поэтому ![]() .
.
Для стабилизации напряжения можно использовать также
прямую ветвь ВАХ диода с малым дифференциальным сопротивлением. Такие диоды называются
стабисторами.
7.6.5.3. ИМПУЛЬСНЫЕ ДИОДЫ
Импульсные диоды предназначены для работы в схемах с
временами переключения менее ![]() . Это требование определяет
особенности их структуры.
. Это требование определяет
особенности их структуры.
В п. 7.6.4. показано, что длительность переходных
процессов включения и выключения определяется временем перезарядки барьерной
ёмкости ![]() и временами накопления
и временами накопления ![]() и рассасывания
и рассасывания ![]() избыточного заряда в базе. Для повышения
скорости переключения надо уменьшать эти времена.
избыточного заряда в базе. Для повышения
скорости переключения надо уменьшать эти времена.
Время перезарядки барьерной ёмкости проще всего
уменьшить за счёт уменьшения площади p-n
–перехода S. Поэтому импульсные диоды изготавливают по
меза-технологии, которая позволяет получать ![]() .
.
Времена накопления и рассасывания заряда уменьшают
двумя путями:
- уменьшая время жизни носителей в базе;
- создавая в базе встроенное поле, препятствующее
диффузии носителей вглубь базы, что
эквивалентно уменьшению диффузионной длины.
Время жизни
носителей в кремнии и германии тем меньше, чем больше концентрация
примесей-ловушек. Очень эффективными ловушками являются атомы золота, которые к
тому же обладают на 6-7 порядков большими коэффициентами диффузии по сравнению
с донорами (P, As) и акцепторами (B, Al). Поэтому при температуре получают очень плавные, практически
однородные, профили распределения Au в
полупроводнике. Тормозящее поле создаётся за счёт неоднородного распределения
примесей в базе диффузионного p-n – перехода
(рис. 7.52).
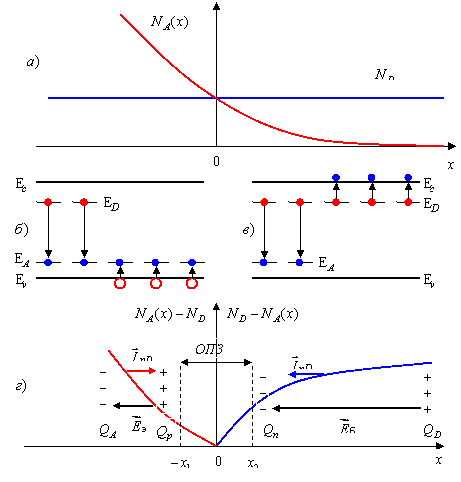
Рис. 7.52
Происхождение тормозящего поля в диффузионном диоде
На
рис.7.52а показаны распределения
доноров ![]() и акцепторов
и акцепторов ![]() . Начало координат совмещено с
металлургической границей. Если в некотором объёме полупроводника имеются и
доноры, и акцепторы, то не все они будут электрически активными примесями,
создающими свободные носители. Если
акцепторов больше, то часть из них захватит электроны с доноров. В результате
образуется положительные и отрицательные заряды, в среднем компенсирующие друг
друга. Оставшиеся
. Начало координат совмещено с
металлургической границей. Если в некотором объёме полупроводника имеются и
доноры, и акцепторы, то не все они будут электрически активными примесями,
создающими свободные носители. Если
акцепторов больше, то часть из них захватит электроны с доноров. В результате
образуется положительные и отрицательные заряды, в среднем компенсирующие друг
друга. Оставшиеся ![]() акцепторов захватят электроны из валентной
зоны и создадут свободные дырки (рис.7.52б).
Эти то акцепторы и будут электрически активными. Аналогично. В области, где больше доноров, часть их отдаёт свои
электроны акцепторам, а остальные
акцепторов захватят электроны из валентной
зоны и создадут свободные дырки (рис.7.52б).
Эти то акцепторы и будут электрически активными. Аналогично. В области, где больше доноров, часть их отдаёт свои
электроны акцепторам, а остальные ![]() активных доноров создадут свободные носители в
зоне проводимости (рис. 7.52в).
Профили электрически активных доноров и акцепторов показаны на рис. 8.52г. ОПЗ диффузионного p-n –перехода почти симметрична,
активных доноров создадут свободные носители в
зоне проводимости (рис. 7.52в).
Профили электрически активных доноров и акцепторов показаны на рис. 8.52г. ОПЗ диффузионного p-n –перехода почти симметрична, ![]() . На границе
. На границе ![]() электрически активных доноров
и электронов меньше, чем в глубине базы, поэтому последние будут диффундировать
к ОПЗ и создадут вблизи неё отрицательный пространственный заряд
электрически активных доноров
и электронов меньше, чем в глубине базы, поэтому последние будут диффундировать
к ОПЗ и создадут вблизи неё отрицательный пространственный заряд ![]() . У базового контакта
образуется положительный пространственный заряд не скомпенсированных доноров
. У базового контакта
образуется положительный пространственный заряд не скомпенсированных доноров ![]() . Эти заряды создают во всей
базе встроенное электрическое поле
. Эти заряды создают во всей
базе встроенное электрическое поле ![]() , направленное к ОПЗ. В эмиттере произойдёт аналогичное
перераспределение дырок и образуется встроенное поле
, направленное к ОПЗ. В эмиттере произойдёт аналогичное
перераспределение дырок и образуется встроенное поле ![]() , направленное от ОПЗ. Встроенное поле будет препятствовать диффузии инжектированных
в базу дырок и тем самым их накопление произойдёт быстрее.
, направленное от ОПЗ. Встроенное поле будет препятствовать диффузии инжектированных
в базу дырок и тем самым их накопление произойдёт быстрее.
7.6.5.4. ВЫСОКОЧАСТОТНЫЕ ДИОДЫ
Высокочастотные (ВЧ) диоды предназначены для
выпрямления переменных токов высокой частоты от 1 МГц до десятков ГГц.
Такое выпрямление называют ещё
детектированием, а сами диоды – детекторными. С помощью детектирования
выделятся огибающая ВЧ колебаний промежуточной частоты с супергетеродинных
радиоприёмниках, которая несёт звуковую информацию. Основное требование,
предъявляемое к ВЧ диодам – малая диффузионная ёмкость. Самый эффективный
способ её уменьшения в ВЧ области состоит в уменьшении площади p-n –перехода. Минимальной площадью обладают точечные p-n - переходы.
Они изготавливаются специфическим методом формовки, состоящим в следующем (рис.
7.56). К монокристаллу ![]() прижимается игла из
бериллиевой бронзы (сплав 98% Cu + 2%Be) с диаметром острия
прижимается игла из
бериллиевой бронзы (сплав 98% Cu + 2%Be) с диаметром острия ![]() . Через образовавшийся контакт
пропускается ток, разогревающий его до температуры плавления бронзы
. Через образовавшийся контакт
пропускается ток, разогревающий его до температуры плавления бронзы ![]() . Атомы меди из образовавшейся
капельки расплава диффундируют в германий. Являясь глубокими акцепторами, они захватывают
сначала все электроны из зоны проводимости, а затем и из валентной зоны. В
результате сферическая область, в которой концентрация атомов меди больше
концентрации доноров, приобретает проводимость p – типа. Площадь такого p-n – перехода может составлять
. Атомы меди из образовавшейся
капельки расплава диффундируют в германий. Являясь глубокими акцепторами, они захватывают
сначала все электроны из зоны проводимости, а затем и из валентной зоны. В
результате сферическая область, в которой концентрация атомов меди больше
концентрации доноров, приобретает проводимость p – типа. Площадь такого p-n – перехода может составлять ![]() .
.
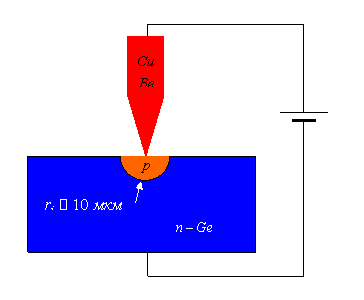
Рис. 7.56
Формование точечного p-n –перехода
Недостатком точечных p-n – переходов
является большой разброс свойств и ограничение по прямым токам, которые могут
привести к изменению параметров в процессе эксплуатации. Альтернативным методом
изготовления ВЧ – диодов является меза-технология. Современная фотолитография
позволят получать p-n –переходы
площадью ![]() , но с гораздо более высокой однородностью
свойств.
, но с гораздо более высокой однородностью
свойств.
7.6.5.5.
ВАРИКАПЫ
Варикап – это
управляемый полупроводниковый конденсатор, ёмкость которого можно плавно
изменять. Очень удобно перестраивать
барьерную
ёмкость p-n – перехода,
изменяя обратное смещение ![]() ,
,

где
![]() – равновесная ёмкость при нулевом смещении.
Варикапы входят в состав колебательных контуров, используемых для частотной
селекции электрических колебаний (рис.7.53).
– равновесная ёмкость при нулевом смещении.
Варикапы входят в состав колебательных контуров, используемых для частотной
селекции электрических колебаний (рис.7.53).

Рис.
7.53 Варикап в составе колебательного контура
С практической точки зрения важно, чтобы диапазон
изменения ёмкости варикапа был как можно больше, потери в диапазоне рабочих
частот минимальными, и обе величины слабо зависели (в идеале –вообще не зависели)
от температуры.
Диапазон изменения ёмкости ![]() ограничивается напряжением пробоя,
ограничивается напряжением пробоя, ![]() . Чтобы увеличить
. Чтобы увеличить ![]() , надо базу легировать как
можно слабее.
, надо базу легировать как
можно слабее.
Потери возникают при протекании тока перезарядки
барьерной ёмкости через активное сопротивление диода. Их принято характеризовать
добротностью Q – отношением реактивного сопротивления диода ![]() к его активному сопротивлению R,
к его активному сопротивлению R,
![]()
Выражение
для добротности легко найти с помощью эквивалентной схемы диода, в которой при обратном смещении можно пренебречь
диффузионной ёмкостью (рис.7.54)

Рис. 7.54
Эквивалентная схема диода при обратном смещении
Полное комплексное сопротивление диода равно


Откуда для добротности получаем
 (7.6.81)
(7.6.81)
Сопротивление
базы ![]() не менее чем на 5 порядков меньше дифференциального
сопротивления p-n – перехода
не менее чем на 5 порядков меньше дифференциального
сопротивления p-n – перехода
![]() , поэтому вторым слагаемым в
знаменателе (7.6.81) можно пренебречь, и формула для добротности принимает вид
, поэтому вторым слагаемым в
знаменателе (7.6.81) можно пренебречь, и формула для добротности принимает вид
 (7.6.82)
(7.6.82)
Добротность
стремится к нулю при ![]() и
и ![]() . Максимального значения она
достигает при выполнении условия
. Максимального значения она
достигает при выполнении условия
![]()
или
на частоте ![]()
При
этом ![]() (7.6.83)
(7.6.83)
Барьерная
ёмкость обычно лежит в интервале ![]() ,
, ![]() , а
, а ![]() , тогда получаем оценки
, тогда получаем оценки
![]()
![]()
В
области частот ![]() добротность определяется сопротивлением базы и
барьерной ёмкостью,
добротность определяется сопротивлением базы и
барьерной ёмкостью,
![]() (7.6.84)
(7.6.84)
Подставив
выражения для сопротивления базы ![]() , где
, где ![]() - толщина базы,
- толщина базы, ![]() - её удельная электропроводность, и барьерной
ёмкости (7.6.81), получим
- её удельная электропроводность, и барьерной
ёмкости (7.6.81), получим
![]() (7.6.85)
(7.6.85)
Из
(7.6.85) следует, что для увеличения добротности необходимо уменьшать толщину
базы и увеличивать степень её легирования. Но последнее понижает напряжение
пробоя и уменьшает диапазон изменения ёмкости. Это противоречие разрешается
в ![]() структуре (рис. 7.55).
структуре (рис. 7.55).
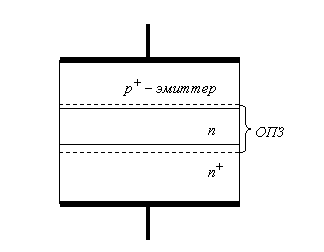
Рис.
7.55 Структура высокодобротного варикапа
Уровень
легирования n-базы выбирают
настолько низким, чтобы обеспечить требуемое напряжение пробоя ![]() . Оно зависит от
. Оно зависит от ![]() по степенному закону
по степенному закону
![]()
Для
Si
при ![]()
![]() , а при
, а при ![]()
![]() . Равновесные значения диффузионого
потенциала и толщины ОПЗ при последнем значении
. Равновесные значения диффузионого
потенциала и толщины ОПЗ при последнем значении ![]() и
равны
и
равны
![]()

Если
принять ![]() , то при этом смещении толщина
ОПЗ составит
, то при этом смещении толщина
ОПЗ составит
![]()
а
диапазон изменения ёмкости ![]() . Толщину базы
. Толщину базы ![]() нет смысла делать больше
нет смысла делать больше ![]() . Поэтому её наращивают
эпитаксиально на толстом сильно легированном
. Поэтому её наращивают
эпитаксиально на толстом сильно легированном ![]() - слое - подложке. Он
обеспечивает механическую прочность структуры, но при этом не вносит вклад в
последовательное сопротивление и позволяет создать надёжный омический контакт.
Поверх базы наращивается эпитаксиальный p-слой, на котором создаётся эмиттерный контакт.
- слое - подложке. Он
обеспечивает механическую прочность структуры, но при этом не вносит вклад в
последовательное сопротивление и позволяет создать надёжный омический контакт.
Поверх базы наращивается эпитаксиальный p-слой, на котором создаётся эмиттерный контакт.
7.6.5.6. ДРУГИЕ ТИПЫ ДИОДОВ
Главная особенность p-n – перехода
– наличие потенциального барьера и ОПЗ с встроенным электрическим полем -
позволяет использовать полупроводниковые диоды для преобразования электрической
энергии в электромагнитное излучение и энергии электромагнитного излучения в
электрический ток.
Диоды, выполняющие первую функцию, называются светоизлучающими диодами (СИД) или,
сокращённо, светодиодами.
Диоды, выполняющие вторую функцию, называются фотодиодами.
Физика процессов генерации и поглощения излучения в
полупроводниках весьма сложна и выходит за рамки настоящего курса. Она
изучается в курсе «Квантовая и оптическая электроника». Здесь кратко, на
терминологическом уровне, рассмотрим основные понятия о светоизлучающих диодах
и фотодиодах.
В светодиоде преобразование энергии инжектированных в
базу неосновных носителей в электромагнитное
излучение происходит при межзонной рекомбинации (рис. 7.57).
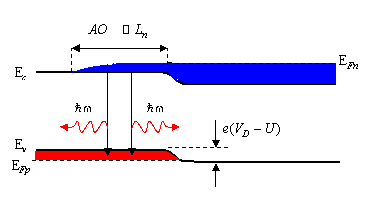
Рис.
7.57 Инжекция и рекомбинация в светодиоде
Чтобы
скорость межзонной рекомбинации, каждый акт которой сопровождается излучением
одного фотона, была высокой, надо создать в p-области одновременно высокую концентрацию и
электронов, и дырок. Причём концентрации должны быть столь высокими, чтобы
произошло вырождение носителей. Вырожденные дырки можно создать с помощью
легирования акцепторами, а электроны инжектируются из эмиттера. Смещение должно
быть большим, почти спрямляющим потенциальный
барьер. Тогда в слое p-области толщиной ![]() , называемом активной областью, происходит
излучательная рекомбинация. Фотоны испускаются изотропно, и те из них, которые
не поглощаются снова в полупроводниковой структуре, выходят наружу и образуют
поток излучения светодиода.
, называемом активной областью, происходит
излучательная рекомбинация. Фотоны испускаются изотропно, и те из них, которые
не поглощаются снова в полупроводниковой структуре, выходят наружу и образуют
поток излучения светодиода.
Такие светодиоды на p-n
– переходах в арсениде галлия были созданы
на раннем этапе развития оптоэлектроники. Но эффективность их оказалась
невысокой. Главная причина заключалась в большой толщине ![]() активной области, что понижает вероятность прямой
встречи электрона и дырки, и наличии ловушек, через которые носители
рекомбинировали безызлучательно. Поэтому впоследствии были созданы многослойные
гетероструктуры, в которых толщина активной области уменьшена до десятков
ангстрем, а качество материала обеспечивает практически 100%-ю вероятность
излучательной рекомбинации. В настоящее время светоизлучающие диоды перекрывают
весь видимый диапазон электромагнитного спектра, значительную часть
ИК-диапазона и вторглись в УФ-диапазон. Они достигли такой степени
совершенства, что в развитых странах стоит вопрос о полном переходе на
полупроводниковые источники освещения.
активной области, что понижает вероятность прямой
встречи электрона и дырки, и наличии ловушек, через которые носители
рекомбинировали безызлучательно. Поэтому впоследствии были созданы многослойные
гетероструктуры, в которых толщина активной области уменьшена до десятков
ангстрем, а качество материала обеспечивает практически 100%-ю вероятность
излучательной рекомбинации. В настоящее время светоизлучающие диоды перекрывают
весь видимый диапазон электромагнитного спектра, значительную часть
ИК-диапазона и вторглись в УФ-диапазон. Они достигли такой степени
совершенства, что в развитых странах стоит вопрос о полном переходе на
полупроводниковые источники освещения.
В фотодиоде происходит преобразование энергии
электромагнитного излучения, поглощённого в ОПЗ диода, в электрический ток
(рис. 7.58).

Рис.
7.58 Образование фототока в фотодиоде
Поглощённый
фотон рождает пару электрон-дырка, которая тут же разделяется встроенным полем
– электрон выбрасывается в n-область, дырка
в p-область. В результате от n- к p-области течёт фототок ![]() , равный скорости рождения пар
во всей ОПЗ. Если внешние выводы разомкнуты, то накопленные в n- и p-областях
избыточные электроны и дырки создадут электрическое поле, полностью компенсирующее
встроенное поле, и разделение зарядов станет невозможным. Но если диод включён
во внешнюю цепь, то по ней также потечёт ток
, равный скорости рождения пар
во всей ОПЗ. Если внешние выводы разомкнуты, то накопленные в n- и p-областях
избыточные электроны и дырки создадут электрическое поле, полностью компенсирующее
встроенное поле, и разделение зарядов станет невозможным. Но если диод включён
во внешнюю цепь, то по ней также потечёт ток ![]() . Его можно использовать либо
для измерения потока фотонов, либо для приведения в действие некоторой нагрузки.
В последнем случае фотодиод становится источником электрической энергии и
называется солнечным элементом, так
как мощным источником поглощаемых фотонов является только Солнце.
. Его можно использовать либо
для измерения потока фотонов, либо для приведения в действие некоторой нагрузки.
В последнем случае фотодиод становится источником электрической энергии и
называется солнечным элементом, так
как мощным источником поглощаемых фотонов является только Солнце.
7.8.
БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ
7.8.1. ОСНОВНЫЕ ОПРЕДЕЛЕНИЯ
Биполярный транзистор
– это полупроводниковый прибор с двумя взаимодействующими p-n – переходами,
обладающий усилительными свойствами.
Два p-n – перехода
образуются тремя чередующимися областями n-p-n или p-n-p.
Соответственно различают транзисторы pnp- и npn-типа. Каждая из трёх областей имеет свой вывод,
поэтому устаревшее название транзистора – полупроводниковый триод. Принцип
действия и свойства биполярного транзистора будем рассматривать с помощью
«кирпичной» модели (рис. 7.59).

Рис. 7.59 «Кирпичная » модель биполярного транзистора
Средняя область транзисторной структуры называется базой (Б). Одна из областей с противоположной проводимостью
называется эмиттером (Э), другая – коллектором (К). Условные схемотехнические
обозначения биполярных транзисторов показаны на рис. 7.60.

Рис. 7.60 Обозначения биполярных транзисторов
Токи в транзисторной структуре возникают под действием
разности потенциалов между выводами. В электронных схемах один из выводов
транзистора оказывается заземлённым. Его потенциал принимается за нуль,
относительно которого отсчитываются потенциалы двух других выводов. Таким
образом, возможны три способа включения транзистора в схему.
1.
Если заземлен базовый вывод (и, следовательно, потенциал
базовой области равен нулю), то имеем включение по схеме с общей базой (ОБ) (рис. 7.61). Потенциал эмиттера относительно базы обозначается ![]() . Он смещает переход
эмиттер-база. Потенциал коллектора относительно базы обозначают
. Он смещает переход
эмиттер-база. Потенциал коллектора относительно базы обозначают ![]() . Он смещает переход
коллектор-база. Эти потенциалы обусловливают протекание токов
. Он смещает переход
коллектор-база. Эти потенциалы обусловливают протекание токов ![]() в эмиттерном выводе,
в эмиттерном выводе, ![]() в базовом выводе,
в базовом выводе, ![]() в коллекторном выводе.
в коллекторном выводе.

Рис.
7.61 Токи и потенциалы в БТ, включенном
по схеме ОБ
2.
Если заземлён эмиттерный вывод (и эмиттерная область),
то говорят, что транзистор включён по схеме с общим эмиттером (ОЭ) (рис. 7.62).
Потенциал базы относительно эмиттера обозначаются ![]() . Он смещает только переход
эмиттерный переход. Потенциал коллектора относительно эмиттера
. Он смещает только переход
эмиттерный переход. Потенциал коллектора относительно эмиттера ![]() смещает одновременно и переход эмиттер-база, и
переход коллектор-база. Токи во внешних выводах также показаны на рис. 7.62.
смещает одновременно и переход эмиттер-база, и
переход коллектор-база. Токи во внешних выводах также показаны на рис. 7.62.

Рис. 7.62 Токи и потенциалы в БТ, включенном по схеме ОЭ
3.
Если заземлён коллекторный вывод (и коллекторная
область), то транзистор включён по схеме с общим коллектором (ОК). Потенциалы базы
и эмиттера относительно коллектора обозначаются
![]()
![]() и
и ![]() соответственно (рис. 7.63). Первый из них
смещает только переход коллектор-база, второй смещает одновременно два перехода
- коллектор-база и база-эмиттер. Направления и обозначения токов во внешних выводах
такие же, как и в схемах ОБ и ОЭ.
соответственно (рис. 7.63). Первый из них
смещает только переход коллектор-база, второй смещает одновременно два перехода
- коллектор-база и база-эмиттер. Направления и обозначения токов во внешних выводах
такие же, как и в схемах ОБ и ОЭ.

Рис.
7.63 Токи и потенциалы в БТ, включённом
по схеме ОК
Наиболее часто применяется схема
с общим эмиттером, так как она обеспечивает усиление по току, напряжению
и мощности. Схема с общей базой не даёт усиления по току, но усиливает
напряжение. Она наиболее просто демонстрирует принцип работы транзистора.
В зависимости от полярности смещений коллекторного и
эмиттерного переходов различают следующие режимы работы транзистора.
1. Активный
режим – эмиттерный переход смещён в прямом направлении, коллекторный – в
обратном. Для pnp-транзистора это
значит, что ![]() ,
, ![]() . Для npn-транзистора
в активном режиме
. Для npn-транзистора
в активном режиме ![]() ,
, ![]() .
.
2. Режим
насыщения – оба перехода смещены в прямом направлении, то есть ![]() для pnp-транзистора,
для pnp-транзистора, ![]() для npn-транзистора. Такое
состояние транзистора называется открытым.
для npn-транзистора. Такое
состояние транзистора называется открытым.
3. Режим отсечки
– оба перехода смещены в обратном направлении: ![]() для pnp-транзистора,
для pnp-транзистора, ![]() для npn-транзистора. Транзистор
находится в закрытом состоянии.
для npn-транзистора. Транзистор
находится в закрытом состоянии.
4. Инверсный
режим – эмиттерный переход смещён в обратном направлении, коллекторный переход –
в прямом направлении. Для pnp-транзистора
это значит, что ![]() ,
, ![]() . Для npn-транзистора
в активном режиме
. Для npn-транзистора
в активном режиме ![]() ,
, ![]() .
.
7.8.2.
РАВНОВЕСНОЕ СОСТОЯНИЕ ТРАНЗИСТОРНОЙ СТРУКТУРЫ
В состоянии равновесия потенциалы всех выводов транзистора
одинаковы, уровень Ферми также одинаков
в эмиттерной, базовой и коллекторной областях, а макроскопические токи отсутствуют.
Как и в случае p-n
–перехода, равновесное состояние
транзистора будем описывать энергетической диаграммой и распределением
носителей в структуре.
Энергетическую диаграмму построим методом мгновенного
образования идеального контакта между эмиттерной, базовой и коллекторной
областями. Исходим из их независимых энергетических диаграмм. Рассмотрим для
определённости биполярный транзистор pnp-типа (рис. 7.64а).
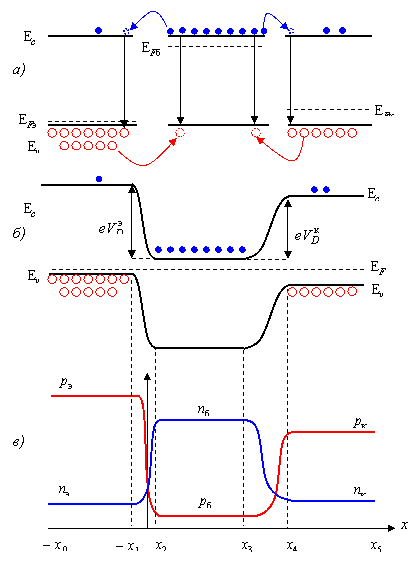
Рис. 7.64.
Равновесная энергетическая диаграмма
и
распределение носителей в pnp-транзисторе
Все три области будем считать невырожденными. После
приведения их в идеальный контакт начнутся процессы выравнивания уровней Ферми.
Электроны их n-базы будут диффундировать в p-эмиттер и p-коллектор,
и рекомбинировать там с дырками. В результате образуются эмиттерная и
коллекторная ОПЗ с встроенными полями ![]() и
и ![]() . Эти поля искривляют
энергетические зоны так, что в эмиттерной и коллекторной областях они окажутся
расположенными выше, чем в базовой области. Высота потенциального барьера
эмиттерного p-n – перехода
. Эти поля искривляют
энергетические зоны так, что в эмиттерной и коллекторной областях они окажутся
расположенными выше, чем в базовой области. Высота потенциального барьера
эмиттерного p-n – перехода
![]() определяется уровнями легирования эмиттера
определяется уровнями легирования эмиттера ![]() и базы
и базы ![]() ,
,
![]() (7.8.1)
(7.8.1)
Высота потенциального барьера коллекторного p-n – перехода
аналогично определяется уровнями легирования коллектора ![]() и базы,
и базы,
![]() (7.8.2)
(7.8.2)
В биполярных транзисторах обычно выполняются
соотношения
![]()
причём в диффузионных транзисторах ![]() , а в эпитаксиальных и
славных
, а в эпитаксиальных и
славных ![]() .
.
Начало координат совместим с металлургической границей
эмиттерного перехода. Будем считать, что границы эмиттерной ОПЗ расположены в
точках ![]() и
и ![]() , эмиттерный контакт – в точке
, эмиттерный контакт – в точке
![]() , точки
, точки ![]() и
и ![]() есть границы коллекторной ОПЗ, а точка
есть границы коллекторной ОПЗ, а точка ![]() - коллекторный контакт. Равновесное
распределение носителей в биполярном транзисторе показано на рис. 7.64в. Собственно базой биполярного транзистора
считается нейтральная область
- коллекторный контакт. Равновесное
распределение носителей в биполярном транзисторе показано на рис. 7.64в. Собственно базой биполярного транзистора
считается нейтральная область ![]() .
.
7.8.3. НЕРАВНОВЕСНОЕ СОСТОЯНИЕ ТРАНЗИСТОРА
7.8.3.1. ТРАНЗИСТОР
В АКТИВНОМ РЕЖИМЕ
Рассмотрим pnp-транзистор, включённый по схеме ОБ. В активном режиме
эмиттерный переход смещён в прямом направлении потенциалом ![]() , поэтому его потенциальный
барьер
, поэтому его потенциальный
барьер ![]() меньше равновесного. Коллекторный переход
смещён в обратном направлении потенциалом
меньше равновесного. Коллекторный переход
смещён в обратном направлении потенциалом ![]() , его потенциальный барьер
, его потенциальный барьер ![]() больше равновесного. Энергетическая диаграмма
транзистора в активном режиме показана на рис. 7.85.
больше равновесного. Энергетическая диаграмма
транзистора в активном режиме показана на рис. 7.85.

Рис. 7.85 Энергетическая
диаграмма pnp-транзистора
в активном режиме
Из эмиттера в
базу течёт инжекционный поток дырок
плотностью ![]() , навстречу ему из базы в
эмиттер инжектируется поток электронов плотностью
, навстречу ему из базы в
эмиттер инжектируется поток электронов плотностью ![]() . Токи, создаваемые этими
потоками, направлены одинаково и в сумме образуют эмиттерный ток, втекающий в
эмиттерный контакт,
. Токи, создаваемые этими
потоками, направлены одинаково и в сумме образуют эмиттерный ток, втекающий в
эмиттерный контакт,
![]() (7.83)
(7.83)
Инжектированные носители диффундируют вглубь эмиттера
(электроны) и базы (дырки).
Концентрация электронов в
точке ![]() равна
равна
![]() (7.84)
(7.84)
По мере удаления от ОПЗ она убывает вследствие
рекомбинации. На эмиттерном контакте концентрация всегда равна равновесной,
![]() (7.85)
(7.85)
Ток ![]() на контакте состоит из двух компонент. Одна из
них,
на контакте состоит из двух компонент. Одна из
них, ![]() , создаётся инжектированным
электронами, избежавшими рекомбинации и дошедшими до контакта через весь
эмиттер. Другая компонента,
, создаётся инжектированным
электронами, избежавшими рекомбинации и дошедшими до контакта через весь
эмиттер. Другая компонента, ![]() , создаётся дырками, входящими
в эмиттер для нейтрализации инжектируемых электронов. Она равна скорости рекомбинации
электронов в эмиттере, почему и помечена индексом r. Если толщина эмиттера превосходит в несколько раз диффузионную
длину электронов
, создаётся дырками, входящими
в эмиттер для нейтрализации инжектируемых электронов. Она равна скорости рекомбинации
электронов в эмиттере, почему и помечена индексом r. Если толщина эмиттера превосходит в несколько раз диффузионную
длину электронов ![]() , то до контакта они не
дойдут. В этом случае
, то до контакта они не
дойдут. В этом случае ![]() , то есть ток
, то есть ток ![]() на 100% является током рекомбинации. Если
же
на 100% является током рекомбинации. Если
же ![]() , то значительная часть
инжектированных электронов уйдёт в эмиттерный контакт, а ток рекомбинации
, то значительная часть
инжектированных электронов уйдёт в эмиттерный контакт, а ток рекомбинации ![]() будет составлять только часть тока
будет составлять только часть тока ![]() , тем меньшую, чем тоньше эмиттер.
, тем меньшую, чем тоньше эмиттер.
Для восполнения недостатка электронов в базе,
образовавшегося вследствие инжекции, из базового контакта входит ежесекундно ![]() электронов, то есть электронная компонента
эмиттерного тока замыкается через базовый вывод.
электронов, то есть электронная компонента
эмиттерного тока замыкается через базовый вывод.
Граничная концентрация
дырок в точке ![]() равна
равна
![]() (7.8.6)
(7.8.6)
Они также диффундируют вглубь базы, по пути
рекомбинируют, вследствие чего концентрация их убывает. Если толщина базы ![]() в несколько раз превосходит диффузионную длину
дырок в базе
в несколько раз превосходит диффузионную длину
дырок в базе ![]() , то все он рекомбинируют в
базе и до коллекторного перехода не дойдут. Для восстановления нейтральности в
базу из базового контакта должны будут войти электроны. Они образуют ток
рекомбинации
, то все он рекомбинируют в
базе и до коллекторного перехода не дойдут. Для восстановления нейтральности в
базу из базового контакта должны будут войти электроны. Они образуют ток
рекомбинации ![]() , в точности равный
, в точности равный ![]() . Таким образом, при
. Таким образом, при ![]() дырочная компонента эмиттерного тока также
замыкается через базовый вывод. Коллекторный переход при этом не
взаимодействует с эмиттерным. Через него протекает обратный ток
дырочная компонента эмиттерного тока также
замыкается через базовый вывод. Коллекторный переход при этом не
взаимодействует с эмиттерным. Через него протекает обратный ток ![]() , равный току насыщения. Такая
структура не является транзистором. Распределение дырок для этого случая
показано на рис. 7.86.
, равный току насыщения. Такая
структура не является транзистором. Распределение дырок для этого случая
показано на рис. 7.86.
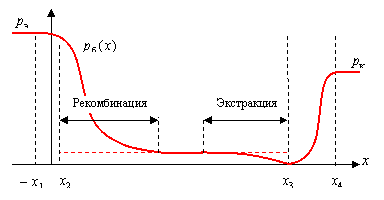
Рис 7.86 Распределение дырок в pnp-структуре
с толстой базой
Для того, чтобы переходы взаимодействовали, толщина
базы должна быть намного меньше диффузионной длины дырок,
![]() (7.8.7)
(7.8.7)
Тогда большая часть инжектированных дырок дойдёт до
коллектора и даст вклад в коллекторный ток ![]() , меньший, чем
, меньший, чем ![]() , но намного превосходящий
, но намного превосходящий ![]() . Неравенство (7.8.7) является, таким образом, необходимым условием транзисторного эффекта - передачи тока из
эмиттера в коллектор.
. Неравенство (7.8.7) является, таким образом, необходимым условием транзисторного эффекта - передачи тока из
эмиттера в коллектор.
Рисунки 7.88 и 7.89 резюмируют сказанное выше.
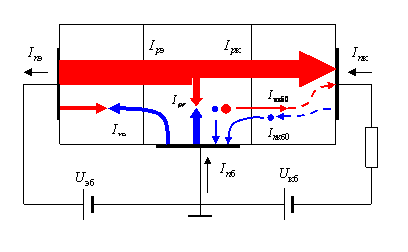
Рис. 7.88 Стационарные
потоки носителей в pnp-транзисторе
в активном режиме

Рис. 7.89 Стационарные токи
в pnp-транзисторе в активном режиме
Установим соотношения между токами в транзисторе и введём
важные параметры, характеризующие его эффективность.
Из рис. 7.89 следует, что электронная составляющая
эмиттерного тока является бесполезной,
так как она не передаётся в коллектор. Поэтому качество транзистора принято
характеризовать коэффициентом инжекции
или эффективностью эмиттера ![]() , равным отношению дырочной
компоненты эмиттерного тока к полному эмиттерному току,
, равным отношению дырочной
компоненты эмиттерного тока к полному эмиттерному току,
 (7.8.9)
(7.8.9)
Коэффициент инжекции npn-транзистора определяется соотношением
 (
(![]() )
)
Как следует из определения, ![]() всегда меньше 1, но чем ближе он к 1, тем выше
качество транзистора. Дырочную компоненту эмиттерного тока можно теперь
представить в виде
всегда меньше 1, но чем ближе он к 1, тем выше
качество транзистора. Дырочную компоненту эмиттерного тока можно теперь
представить в виде
![]() (7.8.10)
(7.8.10)
До коллектора дойдёт только часть ![]() этого тока, определяемая соотношением
этого тока, определяемая соотношением
![]() (7.8.11)
(7.8.11)
Коэффициент ![]() называется коэффициентом
переноса. Так как
называется коэффициентом
переноса. Так как ![]() , то
, то ![]() можно определить также соотношением
можно определить также соотношением
 (7.8.12)
(7.8.12)
Ток рекомбинации равен
![]() (7.8.13)
(7.8.13)
Подставив (7.8.9) в (7.8.10), получим
![]() (7.8.14)
(7.8.14)
Тем самым определили коэффициент передачи тока
![]() (7.8.15)
(7.8.15)
из эмиттерного вывода в коллектор. Это один из
важнейших параметров в коллектор
биполярного транзистора.
Коллекторный ток ![]() равен сумме переданного тока
равен сумме переданного тока ![]() и нулевого тока
и нулевого тока ![]() ,
,
![]() (7.8.16)
(7.8.16)
Это основное уравнение транзистора, включённого по
схеме ОБ. Согласно ему, коэффициент передачи тока можно определить дифференциальным
соотношением
 (7.8.17)
(7.8.17)
Наконец, базовый ток равен
![]()
![]() (7.8.18)
(7.8.18)
Последнее равенство является очевидным следствием
закона сохранения заряда.
7.8.3.2. СТАЦИОНАРНЫЕ РАСПРЕДЕЛЕНИЯ НОСИТЕЛЕЙ И ТОКИ В
ТРАНЗИСТОРЕ
Будем считать, что база и эмиттер легированы
однородно. Следовательно, внутренних электрических полей в них нет, перенос
электронов и дырок осуществляется только посредством диффузии. В этом случае
токи можно вычислить, если известно распределение инжектированных дырок в базе ![]() и электронов в эмиттере
и электронов в эмиттере ![]() . Эти распределения найдём из
уравнения
. Эти распределения найдём из
уравнения
![]() (7.8.19)
(7.8.19)
с граничными условиями (7.8.4) и (7.8.5) и уравнения
![]() (7.8.20)
(7.8.20)
с граничными условиями (7.8.6) и (7.8.7). Если
положить для упрощения толщину эмиттера равной ![]() , то распределение электронов
будет таким же, как и в диоде,
, то распределение электронов
будет таким же, как и в диоде,
![]() (7.8.21)
(7.8.21)
Решение уравнения (7.8.20) ищем в виде
![]() (7.8.22)
(7.8.22)
Подставив (7.8.22) в граничные условия, получим
систему уравнений для постоянных A и B,

Умножив первое уравнение на ![]() и вычтя его из второго уравнения, найдём A,
и вычтя его из второго уравнения, найдём A,

Умножив первое уравнение на ![]() и вычтя из него второе уравнение, найдём B,
и вычтя из него второе уравнение, найдём B,

Подставив А и В в (7.8.22), получим

(7.8.23)
Плотность дырочного тока в базе равна

 (7.8.24)
(7.8.24)
 (7.8.25)
(7.8.25)
Так как ![]() , то
, то ![]() , следовательно
, следовательно ![]() , как и должно быть. Ток
рекомбинации равен
, как и должно быть. Ток
рекомбинации равен
![]()
(7.8.26)
Выражения (7.8.23) – (7.8.26) являются точными в
рамках одномерной «кирпичной» модели. Их можно упростить, учитывая условие
(7.8.8). Если ![]() , то
, то ![]() , поэтому гиперболические функции можно
разложить в ряд Тейлора. Полагая в (7.8.23)
, поэтому гиперболические функции можно
разложить в ряд Тейлора. Полагая в (7.8.23)
![]() ,
, ![]() ,
, ![]() , получим
, получим


![]() (7.8.27)
(7.8.27)
В этом приближении дырки распределены в базе по
линейному закону, диффузионный ток
![]() (
(![]() )
)
а ток рекомбинации равен нулю. Чтобы получить для него
приближённое выражение, надо в (7.8.26) разложить ![]() в ряд до второго порядка включительно,
в ряд до второго порядка включительно,
![]()
Тогда
![]()
![]()
![]() (7.8.28)
(7.8.28)
где ![]() - полный заряд ННЗ,
- полный заряд ННЗ, ![]() - заряд равновесных ННЗ на единицу площади базы.
- заряд равновесных ННЗ на единицу площади базы.
Электронную компоненту эмиттерного тока получим,
продифференцировав (7.8.21)
![]() (7.8.29)
(7.8.29)
7.8.3.3.
СТАЦИОНАРНЫЕ РАСПРЕДЕЛЕНИЯ НОСИТЕЛЕЙ И ТОКИ ТРАНЗИСТОРА В РЕЖИМЕ НАСЫЩЕНИЯ.
В режиме насыщения оба перехода - эмиттерный и коллекторный - смещены в прямом направлении, поэтому через
них в базу инжектируются дырки, а из базы в эмиттер и коллектор – электроны.
Можно записать следующие соотношения между токами во внешних выводах,
![]()
![]()
![]()
Распределение электронов в эмиттере и ток ![]() вычислены выше (формулы (7.8.21), (7.8.28)).
Распределение электронов коллекторе и ток
вычислены выше (формулы (7.8.21), (7.8.28)).
Распределение электронов коллекторе и ток ![]() могут быть записаны точно так же,
могут быть записаны точно так же,
![]() (7.8.29)
(7.8.29)
![]() (7.8.30)
(7.8.30)
Распределение дырок в базе даётся общим решением
(7.8.22), в котором A и B
следует находить из граничных условий
![]()
![]()
Имеем:




 (7.8.31)
(7.8.31)
В том же приближении, что и (7.8.27), распределение
дырок в базе может быть записано в виде
![]()

![]() (7.8.32)
(7.8.32)
Концентрация их линейно изменяется от ![]() до
до ![]() (рис. 7.90).
(рис. 7.90).
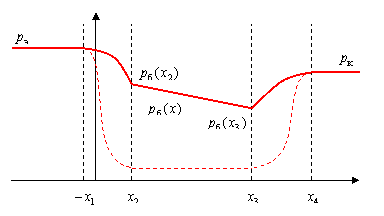
Рис. 7.90 Распределение дырок в pnp-транзисторе
в режиме насыщения
Дифференцируя (7.8.31), находим дырочный ток в базе и
его значения на эмиттерном и коллекторном переходах:

 (7.8.33)
(7.8.33)


(7.8.34)


(7.8.35)
Рекомбинационный ток равен разности дырочных
составляющих эмиттерного и коллекторного токов,

![]()
![]()
![]()
![]() есть полное число дырок в базе, равное площади под
графиком
есть полное число дырок в базе, равное площади под
графиком ![]() , а
, а ![]() - их полный заряд. Число равновесных дырок и
их заряд равны
- их полный заряд. Число равновесных дырок и
их заряд равны ![]() и
и ![]() . Таким образом, снова
получаем общее выражение для тока рекомбинации
. Таким образом, снова
получаем общее выражение для тока рекомбинации
![]() (7.8.36)
(7.8.36)
При ![]()
![]() ,
,
![]()
![]()
В этом случае суммарный перенос инжектированных дырок
через базу отсутствует, все они рекомбинируют в базе. В результате в базовом
выводе течёт большой ток (рис. 7.91а).
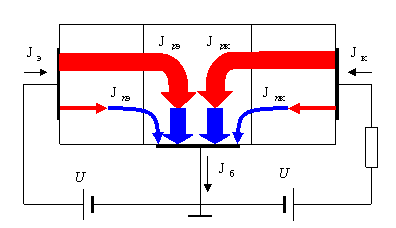
Рис. 7.91а
Токи в pnp-транзисторе в режиме насыщения
при
![]() .
.
Если же ![]() , то через базу от эмиттера к
коллектору течёт сквозной ток. Он уменьшает коллекторный ток инжекции и увеличивает
эмиттерный ток инжекции (рис. 7.91б).
При некотором значении коллекторного смещения сквозной ток полностью
скомпенсирует инжекционный коллекторный ток. Такой режим работы транзистора является переходным от режима
насыщения к активному режиму.
, то через базу от эмиттера к
коллектору течёт сквозной ток. Он уменьшает коллекторный ток инжекции и увеличивает
эмиттерный ток инжекции (рис. 7.91б).
При некотором значении коллекторного смещения сквозной ток полностью
скомпенсирует инжекционный коллекторный ток. Такой режим работы транзистора является переходным от режима
насыщения к активному режиму.
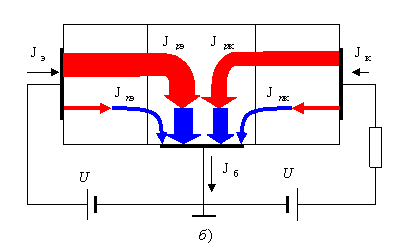
Рис. 7.91б Токи в pnp-транзисторе
в режиме насыщения
7.8.3.4.
СТАЦИОНАРНЫЕ РАСПРЕДЕЛЕНИЯ НОСИТЕЛЕЙ И ТОКИ pnp-ТРАНЗИСТОРА
В РЕЖИМЕ ОТСЕЧКИ
В режиме отсечки оба перехода смещены в обратном направлении.
Концентрации носителей равны нулю на границах обеих ОПЗ. Распределения
носителей в транзисторе показаны на рис. 7.92. Через переходы текут обратные токи
(рис. 7.93)
![]()
![]()
Базовый ток равен их сумме
![]()
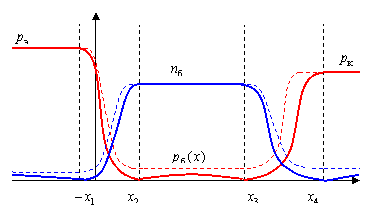
Рис. 7.92 Распределения НЗ в pnp-транзисторе
в режиме отсечки
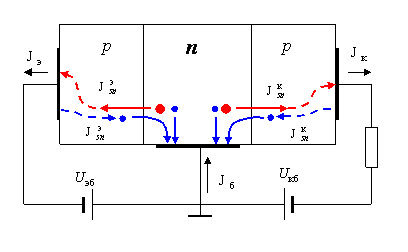
Рис. 7.93 Токи pnp-транзистора в режиме отсечки
7.8.4. ФИЗИЧЕСКИЕ
ПАРАМЕТРЫ ТРАНЗИСТОРА
Физические параметры биполярного транзистора непосредственно
характеризуют процессы, сопровождающие прохождение тока. Их целесообразно
выразить через физические и
геометрические параметры транзисторной структуры. Это позволит глубже уяснить
взаимосвязь различных параметров, возможные пределы их изменения и совершенствования
транзисторов.
7.8.4.1.
ПАРАМЕТРЫ ЭМИТТЕРА
Прямо смещённый эмиттерный переход инжектирует в базу
дырки. Этот процесс характеризуется следующими параметрами:
- коэффициентом инжекции ![]() ;
;
- ёмкостью перехода
![]() ;
;
- дифференциальным сопротивлением перехода ![]() ;
;
- последовательным сопротивлением эмиттера ![]() .
.
Имея выражения для токов в эмиттерном переходе,
![]() (7.8.37)
(7.8.37)
![]() (7.8.38)
(7.8.38)
легко получить выражения для первых трёх параметров.
Подставив токи в определение коэффициента инжекции

и пренебрегая единицей по сравнению с экспонентой,
получим
 (7.8.39)
(7.8.39)
Толщина базы ![]() намного меньше диффузионной длины электронов в
эмиттере
намного меньше диффузионной длины электронов в
эмиттере ![]() , коэффициенты диффузии
носителей в эмиттере и базе одного порядка, но при этом
, коэффициенты диффузии
носителей в эмиттере и базе одного порядка, но при этом ![]() , а
, а ![]() . Чтобы коэффициент инжекции
был как можно ближе к единице, базу следует легировать намного слабее эмиттера,
. Чтобы коэффициент инжекции
был как можно ближе к единице, базу следует легировать намного слабее эмиттера,
![]() , тогда
, тогда
![]() (7.8.40)
(7.8.40)
Минимально допустимый уровень легирования базы
составляет ![]() . При меньших значениях
. При меньших значениях ![]() ток насыщения
ток насыщения
![]()
будет слишком велик, что ухудшает работу транзистора.
Уровень легирования эмиттера, как правило, не превышает ![]() , поэтому для кремниевых
транзисторов
, поэтому для кремниевых
транзисторов ![]() . Реально коэффициент инжекции
не превышает
. Реально коэффициент инжекции
не превышает ![]() .
.
Ёмкость эмиттерного перехода при прямом смещении ![]() обусловлена накоплением ННЗ в базе и эмиттере,
то есть она является диффузионной. Её можно определить аналогично ёмкости p-n –перехода соотношением
обусловлена накоплением ННЗ в базе и эмиттере,
то есть она является диффузионной. Её можно определить аналогично ёмкости p-n –перехода соотношением
![]()
где ![]() - суммарный накопленный избыточный заряд на единицу
площади p-n
– перехода,
- суммарный накопленный избыточный заряд на единицу
площади p-n
– перехода,

Подставив ![]()
![]()
и выполнив интегрирование, получим

Если переход настолько резко несимметричный, что ![]() , то вторым слагаемым в
скобках можно пренебречь. Дифференцируя
, то вторым слагаемым в
скобках можно пренебречь. Дифференцируя ![]() , находим
, находим
![]() (7.8.41)
(7.8.41)
В это выражение можно подставить
соотношение
![]()
полученное из формулы (7.8.38) для дырочной компоненты
эмиттерного тока, после чего оно примет вид
![]() (7.8.42)
(7.8.42)
Отношение ![]() есть величина с размерностью времени, имеющая
смысл среднего времени диффузионного
пролёта базы инжектированными носителями. Тогда
есть величина с размерностью времени, имеющая
смысл среднего времени диффузионного
пролёта базы инжектированными носителями. Тогда
![]() (7.8.43)
(7.8.43)
Из (7.8.40) и (7.8.42) следует, что при уменьшении
толщины базы эффективность эмиттера
возрастает, а диффузионная ёмкость эмиттерного перехода уменьшается. Оба
эффекта благоприятны для транзистора.
Дифференциальное сопротивление эмиттерного перехода
при прямом смещении равно обратной производной от полного эмиттерного тока ![]() по смещению
по смещению ![]() ,
,
 (7.8.44)
(7.8.44)
Если эмиттерный переход неидеальный, то в (7.8.44)
появится коэффициент неидеальности,
![]() (7.8.45)
(7.8.45)
Последовательное сопротивление ![]() определяется толщиной эмиттера
определяется толщиной эмиттера ![]() и уровнем его легирования
и уровнем его легирования ![]() ,
,
![]() (7.8.46)
(7.8.46)
7.8.4.2.
ПАРАМЕТРЫ БАЗЫ
В базе, как установлено выше, происходит диффузия
инжектированных носителей, сопровождающаяся их рекомбинацией. Назначение базы –
передать как можно большую долю эмиттерного тока в коллектор. Это доля
характеризуется коэффициентом переноса
![]()
Подставив выражения для токов (![]() ) и (7.8.28), получим
) и (7.8.28), получим
![]() (7.8.47)
(7.8.47)
Уменьшение толщины базы при постоянном смещении ![]() снова оказывается выгодным,
так как повышает коэффициент переноса. Но слишком тонкой базу нецелесообразно
делать по двум причинам.
снова оказывается выгодным,
так как повышает коэффициент переноса. Но слишком тонкой базу нецелесообразно
делать по двум причинам.
Во-первых, с уменьшением толщины базы возрастают
активное сопротивление ![]() , оказываемое базой токам,
текущим параллельно плоскостям эмиттерного и коллекторного переходов, и входное
дифференциальное сопротивление базы
, оказываемое базой токам,
текущим параллельно плоскостям эмиттерного и коллекторного переходов, и входное
дифференциальное сопротивление базы  . Если база легирована однородно,
то
. Если база легирована однородно,
то
![]() (7.8.48)
(7.8.48)
где l и d - размеры базовой области в направлениях,
перпендикулярных плоскости переходов. Дифференциальное сопротивление найдём, продифференцировав соотношение ![]() ,
,
 (7.8.49)
(7.8.49)
Знаменатель в (7.8.49) можно представить в виде

Для дискретных транзисторов с толщиной базы порядка микрометра первое слагаемое
намного меньше второго, поэтому
![]() (7.8.50)
(7.8.50)
Увеличение ![]() ведёт к росту омических потерь в базе, а
возрастание
ведёт к росту омических потерь в базе, а
возрастание ![]() ослабляет воздействие переменного эмиттерного
смещения на коллекторный ток в соответствии с уравнением
ослабляет воздействие переменного эмиттерного
смещения на коллекторный ток в соответствии с уравнением
![]()
Во-вторых, при слишком тонкой базе и большом обратном
смещении коллекторного перехода возможно расширение коллекторной ОПЗ в базу
вплоть до её смыкания с эмиттерной ОПЗ. Это явление называется проколом базы. Термин отражает физическую
суть явления – в месте прокола
потенциальный барьер между эмиттером и коллектором резко уменьшается, и обе области
соединяются проводящим каналом p-типа,
происходит их короткое замыкание. После прокола базы транзистор не обладает
усилительными свойствами.
Прокол базы есть крайний случай эффекта Эрли – модуляции (изменения) толщины базы
под действием смещения ![]() . Вследствие этого все величины, зависящие от
. Вследствие этого все величины, зависящие от ![]() -
- ![]() - зависят также и от
- зависят также и от ![]() . Эффект Эрли проявляется в
обратном влиянии коллекторного перехода на эмиттерный переход. Это влияние при
неизменном эмиттерном токе можно
изобразить в виде следующей причинно-следственной блок-схемы (рис.7.94). Пусть
коллекторное смещение стало более отрицательным, то есть изменилось на
. Эффект Эрли проявляется в
обратном влиянии коллекторного перехода на эмиттерный переход. Это влияние при
неизменном эмиттерном токе можно
изобразить в виде следующей причинно-следственной блок-схемы (рис.7.94). Пусть
коллекторное смещение стало более отрицательным, то есть изменилось на ![]() . Вследствие этого ОПЗ
расширится в базу на
. Вследствие этого ОПЗ
расширится в базу на ![]() . Толщина базы уменьшится на
такую же величину,
. Толщина базы уменьшится на
такую же величину, ![]() . Эмиттерный ток при этом
поддерживается постоянным, а поскольку он является диффузионным, то неизменным
должен остаться градиент концентрации дырок,
. Эмиттерный ток при этом
поддерживается постоянным, а поскольку он является диффузионным, то неизменным
должен остаться градиент концентрации дырок, ![]() (рис. 7.95). Тогда с неизбежностью приходим к выводу, что должна понизиться граничная
концентрация дырок
(рис. 7.95). Тогда с неизбежностью приходим к выводу, что должна понизиться граничная
концентрация дырок ![]() , а вместе с ней и падение
напряжения на эмиттерном переходе, так что
, а вместе с ней и падение
напряжения на эмиттерном переходе, так что ![]() . Это есть первое следствие эффекта Эрли.
. Это есть первое следствие эффекта Эрли.

Рис. 7.94 Эффект Эрли в биполярном pnp-транзисторе

Рис. 7.95
Модуляция толщины базы при
постоянном эмиттерном токе
Понижение концентрации дырок всюду в базе приведёт к
уменьшению тока рекомбинации ![]() , а, значит, к увеличению
коллекторного тока
, а, значит, к увеличению
коллекторного тока ![]() . Это второе следствие эффекта Эрли. Количественно эффект Эрли можно
охарактеризовать тремя отношениями
. Это второе следствие эффекта Эрли. Количественно эффект Эрли можно
охарактеризовать тремя отношениями

Первое из них определяет коэффициент обратной связи по напряжению. Он характеризует влияние
выходного (коллекторного) напряжения на входное (эмиттерное) напряжение. Второе
отношение называется выходной
проводимостью, а обратная ему величина – выходным сопротивлением транзистора. Оно характеризует влияние выходного
напряжения ![]() на выходной (коллекторный) ток
на выходной (коллекторный) ток ![]() . Третье отношение называется выходной компонентой дифференциального
сопротивления базы. Оно характеризует косвенное влияние коллекторного
напряжения на базовый ток. Получим для него явное выражение и сравним с входной
компонентой дифференциального сопротивления базы
. Третье отношение называется выходной компонентой дифференциального
сопротивления базы. Оно характеризует косвенное влияние коллекторного
напряжения на базовый ток. Получим для него явное выражение и сравним с входной
компонентой дифференциального сопротивления базы ![]() . При
. При ![]() изменение тока коллектора
изменение тока коллектора ![]() равно по абсолютной величине изменению тока
базы
равно по абсолютной величине изменению тока
базы ![]() . Но последнее обусловлено
изменением только тока рекомбинации
. Но последнее обусловлено
изменением только тока рекомбинации ![]() . Таким образом,
. Таким образом, ![]() . Из (7.8.28) и рис. 7.95 следует,
что
. Из (7.8.28) и рис. 7.95 следует,
что
![]()
Так как ![]() , то
, то ![]() . Следовательно,
. Следовательно,

![]() (7.8.51)
(7.8.51)
Коллекторное
напряжение влияет на базовый ток вдвое сильнее, чем эмиттерное.
7.8.4.3.
ПАРАМЕТРЫ КОЛЛЕКТОРА
Назначение коллектора – собрать как можно больше
носителей, инжектированных в базу эмиттером. Для этого площадь коллекторного
перехода ![]() должна быть больше площади эмиттерного
перехода
должна быть больше площади эмиттерного
перехода ![]() . Коллекторный переход должен
также выдерживать большие обратные напряжения, чтобы обеспечить большой коэффициент
усиления по напряжению. Поэтому коллекторная область легируется слабо, чтобы
ОПЗ была широкой, поле в ней - слабым, а напряжение пробоя – высоким.
. Коллекторный переход должен
также выдерживать большие обратные напряжения, чтобы обеспечить большой коэффициент
усиления по напряжению. Поэтому коллекторная область легируется слабо, чтобы
ОПЗ была широкой, поле в ней - слабым, а напряжение пробоя – высоким.
Перечисленные требования противоречивы. Увеличивая
площадь коллектора, мы повышаем
коэффициент передачи тока, но одновременно увеличиваем обратный ток перехода ![]() и барьерную ёмкость
и барьерную ёмкость ![]() . Понижая уровень
легирования
. Понижая уровень
легирования ![]() , мы увеличиваем напряжение
пробоя, и понижаем барьерную ёмкость, но при этом возрастает концентрация
неосновных носителей
, мы увеличиваем напряжение
пробоя, и понижаем барьерную ёмкость, но при этом возрастает концентрация
неосновных носителей ![]() и обратный ток перехода. Поэтому в каждом
конкретном случае разработчики биполярных транзисторов ищут приемлемый компромисс.
и обратный ток перехода. Поэтому в каждом
конкретном случае разработчики биполярных транзисторов ищут приемлемый компромисс.
7.8.4.4.
ФИЗИЧЕСКИЕ ЭКВИВАЛЕНТНЫЕ СХЕМЫ БИПОЛЯРНЫХ ТРАНЗИСТОРОВ
Физическая
эквивалентная схема биполярного транзистора есть совокупность электрически
связанных дискретных компонентов, реагирующая на приложенные смещения так же,
как и распределённая транзисторная структура. Дискретные компоненты эквивалентной схемы моделируют физические
процессы в транзисторе, а численные значения их номиналов совпадают с
рассмотренными выше его физическими параметрами.
При включении транзистора по схеме ОБ используют так
называемую Т - схему (рис. 7.96).

Рис. 7.96 Эквивалентная Т – схема
биполярного транзистора
Схема включает дифференциальные сопротивления
эмиттера, коллектора и базы ![]() , активное сопротивление базы
, активное сопротивление базы ![]() , два идеальных вентиля
, два идеальных вентиля ![]() , генератор напряжения
, генератор напряжения ![]() между эмиттером и базой и генератор тока
между эмиттером и базой и генератор тока ![]() в коллекторной цепи.
в коллекторной цепи.
Физические эквивалентные схемы наглядны и обоснованны.
Он и соединяются с другими элементами и
эквивалентными схемами и полученные таким образом электронные схемы могут быть
рассчитаны методами теории цепей. Но их существенным недостатком является
неуниверсальность (для каждого прибора требуется своя эквивалентная схема) и
невозможность практически измерить базовые сопротивления, так как нельзя выделить
опорную точку А в структуре. Поэтому
большое значение приобрели феноменологические эквивалентные схемы.
7.8.4.5.
БИПОЛЯРНЫЙ ТРАНЗИСТОР КАК ЧЕТЫРЁХПОЛЮСНИК
Четырёхполюсником называется, как известно из
теоретической электротехники, электрическая цепь с двумя парами выводов, к которым
можно присоединять источники тока, источники напряжения, нагрузки, другие четырёхполюсники
(рис. 7.98).

Рис. 7.98 Токи и напряжения в четырёхполюснике
Режим работы четырёхполюсника задаётся четырьмя параметрами
– входным током ![]() , входным напряжением
, входным напряжением ![]() , выходным током
, выходным током ![]() и выходным напряжением
и выходным напряжением ![]() . Внутренней структурой
четырёхполюсника не интересуются либо она может быть неизвестной. Его реакцию
на изменение параметров режима
описывают системой уравнений, связывающей одну пару параметров режима с другой
парой. Связь эта считается линейной. Выбирая разные пары независимых параметров
режима, можно записать шесть систем уравнений. Какую из них предпочесть для
данного прибора, зависит от его физических свойств. Обычно в качестве
независимых выбирают те параметры режима, которые можно менять произвольно, по
своему желанию.
. Внутренней структурой
четырёхполюсника не интересуются либо она может быть неизвестной. Его реакцию
на изменение параметров режима
описывают системой уравнений, связывающей одну пару параметров режима с другой
парой. Связь эта считается линейной. Выбирая разные пары независимых параметров
режима, можно записать шесть систем уравнений. Какую из них предпочесть для
данного прибора, зависит от его физических свойств. Обычно в качестве
независимых выбирают те параметры режима, которые можно менять произвольно, по
своему желанию.
Биполярный транзистор, включенный по схеме ОЭ или ОБ,
является, очевидно, четырёхполюсником (рис. 7.99).

Рис.
7.99 Биполярный транзистор как четырёхполюсник
К входным выводам подключен источник эмиттерного смещения ![]() , к выходным выводам –
источник коллекторного смещения
, к выходным выводам –
источник коллекторного смещения ![]() . Поскольку внутреннее
сопротивление источника всегда намного
больше сопротивления эмиттера и базы, то, применяя закон Ома для входной цепи,
получаем
. Поскольку внутреннее
сопротивление источника всегда намного
больше сопротивления эмиттера и базы, то, применяя закон Ома для входной цепи,
получаем

Изменяя смещение эмиттерного источника, мы произвольно
меняем входной ток транзистора. С другой
стороны, внутреннее сопротивление источника коллекторного смещения намного
меньше сопротивления коллекторного перехода, поэтому из закона Ома для выходной
цепи имеем

Посредством изменения смещения коллекторного источника
мы можем произвольно изменять выходное напряжение ![]() или
или ![]() . Следовательно, входной ток
. Следовательно, входной ток ![]() или
или ![]() и выходное напряжение
и выходное напряжение ![]() или
или ![]() целесообразно принять за независимые параметры
режима. Тогда два других параметра -
целесообразно принять за независимые параметры
режима. Тогда два других параметра - ![]() или
или ![]() и
и ![]() - будут однозначными функциями
первых,
- будут однозначными функциями
первых,
для схемы ОБ ![]() (7.8.52)
(7.8.52)
![]() (7.8.53)
(7.8.53)
для схемы ОЭ ![]() (7.8.54)
(7.8.54)
![]() (7.8.55)
(7.8.55)
Соотношения
(7.8.52) – (7.8.55) определяют восемь семейств характеристик биполярного
транзистора.
Зависимости ![]() при
при ![]() и
и ![]() при
при ![]() называются входными
характеристиками транзистора при его включении соответственно по схеме ОБ и
ОЭ.
называются входными
характеристиками транзистора при его включении соответственно по схеме ОБ и
ОЭ.
Зависимости ![]() при
при ![]() и
и ![]() при
при ![]() называются выходными
характеристиками транзистора.
называются выходными
характеристиками транзистора.
Зависимости ![]() при
при ![]() и
и ![]() при
при ![]() называются характеристиками
прямой передачи транзистора.
называются характеристиками
прямой передачи транзистора.
Зависимости ![]() при
при ![]() и
и ![]() при
при ![]() называются характеристиками
обратной связи по напряжению.
называются характеристиками
обратной связи по напряжению.
Совокупность
четырёх параметров режима, удовлетворяющих уравнениям (7.8.52) – (7.8.55),
определяет рабочую точку транзистора.
Если независимые параметры ![]() или
или ![]() получат малые приращения
получат малые приращения ![]() и
и ![]() , то зависимые параметры
, то зависимые параметры ![]() и
и ![]() получат приращения
получат приращения ![]() и
и ![]() соответственно. Разлагая характеристики
(7.8.52) – (7.8.55) в окрестности рабочей точки в ряд до членов первого
порядка, получим для приращений (переменных составляющих независимых параметров)
уравнения
соответственно. Разлагая характеристики
(7.8.52) – (7.8.55) в окрестности рабочей точки в ряд до членов первого
порядка, получим для приращений (переменных составляющих независимых параметров)
уравнения
 (7.8.56)
(7.8.56)
 (7.8.57)
(7.8.57)
Транзистор при включении по схеме ОБ и ОК
характеризуется набором из четырёх феноменологических h-параметров. Их можно экспериментально определить,
измеряя токи и напряжения в режимах холостого хода по входу и короткого замыкания по выходу. Для схемы ОЭ
получаем,
 (7.8.58)
(7.8.58)
Физический смысл h-параметров прозрачен: ![]() есть входное сопротивление,
есть входное сопротивление, ![]() - выходная проводимость,
- выходная проводимость, ![]() - коэффициент передачи тока в схеме ОЭ,
- коэффициент передачи тока в схеме ОЭ, ![]() - коэффициент обратной связи по напряжению. Системе
уравнений (7.8.57) можно сопоставить эквивалентную схему, состоящую из входного
сопротивления, выходной проводимости, источника тока и источника напряжения (рис.
7.100). Эта схема широко используется при анализе усилительных каскадов.
- коэффициент обратной связи по напряжению. Системе
уравнений (7.8.57) можно сопоставить эквивалентную схему, состоящую из входного
сопротивления, выходной проводимости, источника тока и источника напряжения (рис.
7.100). Эта схема широко используется при анализе усилительных каскадов.

Рис. 7.100 Эквивалентная схема
транзистора-четырёхполюсника
7.8.5.
СТАТИЧЕСКИЕ ХАРАКТЕРИСТИКИ БИПОЛЯРНОГО ТРАНЗИСТОРА
7.8.5.1.
МОДЕЛЬ ЭБЕРСА – МОЛЛА
Знание статических характеристик (7.8.52) – (7.8.55)
абсолютно необходимо для расчёта электронных схем. Но получить для них точные
аналитические выражения, корректно учитывающие все физические процессы в
транзисторе, практически невозможно. Поэтому используют модельный подход -
транзистор заменяют физической или математической моделью, учитывающей основные
процессы, и позволяющей получить замкнутые выражения для эмиттерного,
коллекторного и базового токов. Простейшей и старейшей моделью, предложенной
ещё в 1954 году, является модель Эберса –
Молла. Она содержит только четыре компонента – два идеальных диода и два
генератора токов (рис. 7.101).

Рис. 7.101 Модель Эберса – Молла
биполярного транзистора
Диоды моделируют эмиттерный и коллекторный переходы.
Под воздействием смещений ![]() и
и ![]() через них текут токи
через них текут токи ![]() и
и ![]() . Генераторы токов
. Генераторы токов ![]() и
и ![]() моделируют передачу этих токов через базу
в коллектор и эмиттер.
моделируют передачу этих токов через базу
в коллектор и эмиттер. ![]() - коэффициенты передачи тока в активном и
инверсном режимах соответственно. Принято считать ток во внешнем выводе
положительным, если он втекает в транзистор, и отрицательным в противном
случае. Для эмиттерного, коллекторного и
базового токов можно записать очевидные
соотношения
- коэффициенты передачи тока в активном и
инверсном режимах соответственно. Принято считать ток во внешнем выводе
положительным, если он втекает в транзистор, и отрицательным в противном
случае. Для эмиттерного, коллекторного и
базового токов можно записать очевидные
соотношения
 (7.8.59)
(7.8.59)
Токи диодов описываются уравнениями Шокли

где ![]() и
и ![]() - тепловые
токи эмиттерного и коллекторного переходов. Подставив
- тепловые
токи эмиттерного и коллекторного переходов. Подставив ![]() и
и ![]() в (7.8.59), получим систему уравнений Эберса – Молла
в (7.8.59), получим систему уравнений Эберса – Молла

Они описывают поведение транзистора при любых
соотношениях эмиттерного и коллекторного смещений, то есть в любых режимах.
Тепловые токи можно выразить через обратные токи переходов следующим образом.
Представим, что коллекторная цепь разомкнута, а эмиттерный переход смещён в
обратном направлении. Это значит, что коллекторный переход, ток через который
равен нулю, не влияет на эмиттерный переход, а через последний течёт обратный
ток ![]() . Уравнения (7.8.59) принимают
в этом случае вид
. Уравнения (7.8.59) принимают
в этом случае вид

Исключив из них выражения в скобках,
получим
![]()
Откуда ![]() (7.8.60)
(7.8.60)
Аналогично, если разорвать эмиттерную цепь и сместить
коллекторный переход в обратном
направлении, то эмиттерный ток будет равен нулю, а коллекторный – обратному
току ![]() . Из уравнений
. Из уравнений

находим ![]()
![]() (7.8.61)
(7.8.61)
Таким образом, уравнения Эберса – Молла содержат четыре феноменологических параметра
– два коэффициента передачи тока и два обратных
тока. Они удовлетворяют так
называемому соотношению взаимности
![]() ,
,
поэтому только три из
них являются независимыми. Их численные
значения находят из эксперимента.
7.8.5.2. СТАТИЧЕСКИЕ
ХАРАКТЕРИСТИКИ ТРАНЗИСТОРА В СХЕМЕ ОБ
Из уравнений Эберса - Молла легко получить уравнения
вольтамперных характеристик биполярного транзистора в схеме ОБ. Для этого
умножим первое уравнение на ![]() и вычтем из него второе уравнение,
и вычтем из него второе уравнение,
![]()
Получили
уравнение семейства выходных характеристик транзистора
![]() (7.8.62)
(7.8.62)
Его график показан на рис. 7.102. При нулевом
эмиттерном токе коллекторный ток равен обратному току коллекторного перехода.
При положительном смещении эмиттерного перехода его ток ![]() смещает нулевую характеристику параллельно
самой себе вверх. Цветом выделены области, соответствующие активному режиму,
режиму отсечки и режиму насыщения.
смещает нулевую характеристику параллельно
самой себе вверх. Цветом выделены области, соответствующие активному режиму,
режиму отсечки и режиму насыщения.
![]()
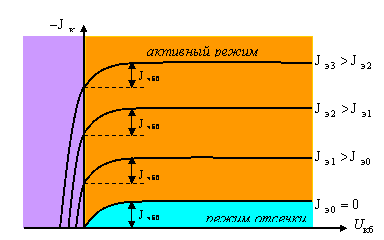
Рис. 7.102 Выходные характеристики биполярного
транзистора
Из (7.8.62) следуют также передаточные характеристики
транзистора ![]() .
.
При ![]() выходная
цепь закорочена, коллекторный ток определяется только эмиттерным током,
выходная
цепь закорочена, коллекторный ток определяется только эмиттерным током,
![]()
Если ![]() (прямое смещение эмиттерного перехода),
то
(прямое смещение эмиттерного перехода),
то ![]() , что означает вытекание тока из коллектора. Этот ток образован экстрагированными
из базы избыточными неосновными носителями. При обратном смещении эмиттерного
перехода эмиттерный ток не превышает по величине
, что означает вытекание тока из коллектора. Этот ток образован экстрагированными
из базы избыточными неосновными носителями. При обратном смещении эмиттерного
перехода эмиттерный ток не превышает по величине ![]() , а ток
, а ток ![]() втекает в
коллектор.
втекает в
коллектор.
При обратном смещении коллекторного перехода
передаточная характеристика смещается вверх максимум на ![]() (рис. 7.103).
(рис. 7.103).
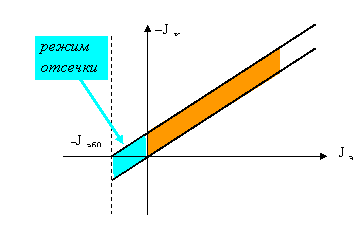
Рис 7.103 Передаточные
характеристики транзистора в схеме ОБ
Первое уравнение Эберса – Молла фактически задает семейство входных характеристик транзистора в схеме ОБ. При ![]() характеристика является диодной,
характеристика является диодной,
![]()
При ![]() она сдвигается вверх на
она сдвигается вверх на ![]() . При
. При ![]() характеристики сдвигаются вниз. Семейство
входных характеристик транзистора показано на рис. 7.104.
характеристики сдвигаются вниз. Семейство
входных характеристик транзистора показано на рис. 7.104.
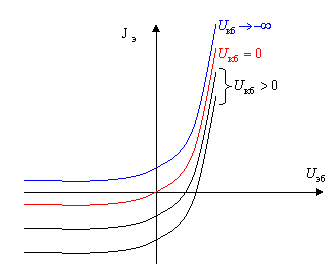
Рис. 7.104 Входные характеристики
транзистора в схеме ОБ
7.8.5.3.
СТАТИЧЕСКИЕ ХАРАКТЕРИСТИКИ ТРАНЗИСТОРА В
СХЕМЕ ОЭ
При включении биполярного транзистора по схеме ОЭ
входным током является базовый ток ![]() , входным напряжением -
разность потенциалов между базой и эмиттером
, входным напряжением -
разность потенциалов между базой и эмиттером ![]() , выходным током – коллекторный
ток
, выходным током – коллекторный
ток ![]() , выходным напряжением –
разность потенциалов между коллектором и эмиттером
, выходным напряжением –
разность потенциалов между коллектором и эмиттером ![]() (рис. 7.105).
(рис. 7.105).
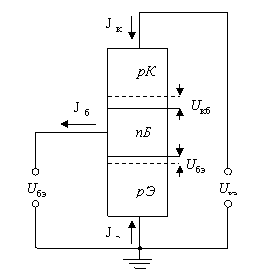
Рис. 7.105
Токи и потенциалы при включении по схеме ОЭ
В качестве независимых переменных выбираем, как
отмечено выше, ![]() и
и ![]() . Характеристики транзистора в
этом случае можно вывести из второго и третьего уравнений Эберса – Молла. При
этом следует учесть, что при отсчёте потенциалов от потенциала эмиттера
. Характеристики транзистора в
этом случае можно вывести из второго и третьего уравнений Эберса – Молла. При
этом следует учесть, что при отсчёте потенциалов от потенциала эмиттера ![]() , а
, а ![]() . Поэтому для схемы ОЭ уравнения
примут вид
. Поэтому для схемы ОЭ уравнения
примут вид

Выразив из третьего уравнения
 ,
,
и подставив в первое и второе уравнения, получим явное
выражение для семейства выходных характеристик биполярного транзистора в схеме
ОЭ,


 (7.8.63)
(7.8.63)
и аналогичное выражение для эмиттерного тока

 (7.8.64)
(7.8.64)
Найдём характерные точки выходной характеристики. При ![]() и
и ![]() транзистор находится в режиме насыщения,
транзистор находится в режиме насыщения,
 (7.8.65)
(7.8.65)
Эмиттерный и коллекторный токи втекают в транзистор, и
в сумме они равны базовому току. При ![]() оба тока равны нулю, как и должно быть.
Коллекторный ток равен нулю при
оба тока равны нулю, как и должно быть.
Коллекторный ток равен нулю при
![]()
Откуда ![]() (7.8.66)
(7.8.66)
При ![]() . Напряжение
. Напряжение ![]() в этой точке положительно,
в этой точке положительно,
![]()
то есть транзистор ещё не вышел из режима насыщения. Переход
в активный режим происходит при ![]() или
или ![]() . Из третьего и второго
уравнений Эберса – Мола находим
. Из третьего и второго
уравнений Эберса – Мола находим
![]() (7.8.67)
(7.8.67)
![]() (7.8.68)
(7.8.68)
В активном режиме при больших отрицательных коллекторных
смещениях ![]() из (7.8.63) коллекторный ток равен
из (7.8.63) коллекторный ток равен
![]() (7.8.69)
(7.8.69)
Коллекторный ток состоит из двух компонент. Сквозной ток ![]() течёт от эмиттера к коллектору при оборванной базе (
течёт от эмиттера к коллектору при оборванной базе (![]() ). В этом случае электроны,
экстрагированные из коллектора, вместе с оставшимися в базе после экстракции из
неё дырок, не могут уйти во внешнюю цепь. Они понижают потенциал базы и вызывают
инжекцию дырок, их которых часть
). В этом случае электроны,
экстрагированные из коллектора, вместе с оставшимися в базе после экстракции из
неё дырок, не могут уйти во внешнюю цепь. Они понижают потенциал базы и вызывают
инжекцию дырок, их которых часть ![]() рекомбинируют с электронами, а остальные дают вклад
в коллекторный ток, так что
рекомбинируют с электронами, а остальные дают вклад
в коллекторный ток, так что
![]()
![]() (7.8.70)
(7.8.70)
Обратный ток коллектора ![]() весьма мал, но при
весьма мал, но при ![]() сквозной ток
сквозной ток ![]() может превышать его в тысячи раз. Такой ток может
быть опасен для электронных схем. Поэтому обрыва базы допускать нельзя. Этот
вывод нашёл отражение в практической рекомендации – при работе со схемами,
находящимися под напряжением, база впаивается первой, а выпаивается последней.
может превышать его в тысячи раз. Такой ток может
быть опасен для электронных схем. Поэтому обрыва базы допускать нельзя. Этот
вывод нашёл отражение в практической рекомендации – при работе со схемами,
находящимися под напряжением, база впаивается первой, а выпаивается последней.
При замкнутой базовой цепи базовый ток также
усиливается в ![]() раз и образует вторую компоненту коллекторного
тока
раз и образует вторую компоненту коллекторного
тока ![]() . Коэффициент
. Коэффициент ![]() называется коэффициентом
усиления по току биполярного транзистора. Он может достигать значения в
несколько тысяч. По этой причине схема ОЭ нашла широкое применение.
называется коэффициентом
усиления по току биполярного транзистора. Он может достигать значения в
несколько тысяч. По этой причине схема ОЭ нашла широкое применение.
Графики семейства выходных ВАХ, рассчитанные по формуле
(7.8.63), показаны на рис. 7.106.

Рис. 7.106 Выходные
ВАХ биполярного транзистора
с параметрами ![]() . Токи –
. Токи –
в единицах ![]() , напряжение – в единицах
, напряжение – в единицах ![]() .
.
Они не вполне адекватно отражают свойства
транзистора в активном режиме, основное
из которых – конечное выходное сопротивление, что проявляется отсутствии
строгого насыщения коллекторного тока. Причина отсутствия насыщения – эффект
Эрли, вследствие которого коэффициент передачи возрастает с ростом коллекторного
напряжения. Он не учитывается в исходной модели Эберса –Молла. Простейший
способ феноменологического введения эффекта Эрли в модель состоит в задании
линейной зависимости коэффициента передачи от коллекторного смещения
![]()
где ![]() -
значение коэффициента передачи при смещении, близком к нулю, а напряжение Эрли
-
значение коэффициента передачи при смещении, близком к нулю, а напряжение Эрли ![]() характеризует скорость его изменения. После
такой модификации выходные характеристики выглядят гораздо более реалистично
(рис. 7.107).
характеризует скорость его изменения. После
такой модификации выходные характеристики выглядят гораздо более реалистично
(рис. 7.107).

Рис.
7.106 Выходные ВАХ
биполярного транзистора
с параметрами![]() . Токи – в единицах
. Токи – в единицах
![]() , напряжения – в единицах
, напряжения – в единицах ![]() .
.
Покажем теперь, что формальные выводы из модели Эберса
– Молла согласуются с качественной физической картиной токов в транзисторе при
включении по схеме ОЭ.
Пусть эмиттер и коллектор закорочены, то есть ![]() , а базовый ток отличен от
нуля. Это значит, что транзистор находится в режиме насыщения, оба перехода
смещены в прямом направлении, так что
, а базовый ток отличен от
нуля. Это значит, что транзистор находится в режиме насыщения, оба перехода
смещены в прямом направлении, так что ![]() . Распределение носителей
имеет вид (рис. 7.107).
. Распределение носителей
имеет вид (рис. 7.107).
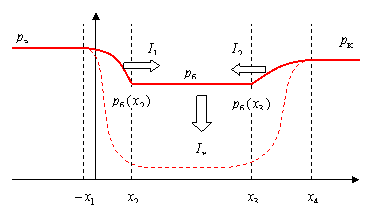
Рис.
7.107 Распределение дырок в pnp-БТ
при ![]() .
.
Приложим теперь между эмиттером и коллектором разность
потенциалов ![]() . Часть
. Часть ![]() её
упадёт на эмиттерном переходе и сместит его в прямом направлении, другая
часть
её
упадёт на эмиттерном переходе и сместит его в прямом направлении, другая
часть ![]() упадёт на коллекторном переходе и смесит его в
обратном направлении. Вследствие этого равенство граничных концентраций
упадёт на коллекторном переходе и смесит его в
обратном направлении. Вследствие этого равенство граничных концентраций ![]() и
и ![]() нарушится. Теперь
нарушится. Теперь

В базе возникнет сквозной диффузионный поток дырок ![]() от эмиттера к коллектору. Он увеличивает
эмиттерный ток и уменьшает коллекторный ток на ту же величину (рис. 7.108).
от эмиттера к коллектору. Он увеличивает
эмиттерный ток и уменьшает коллекторный ток на ту же величину (рис. 7.108).
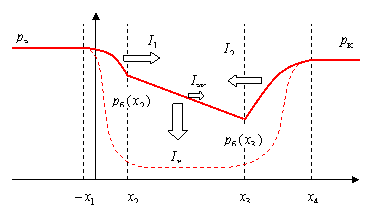
Рис. 7.108
Распределение дырок в pnp - БТ при ![]() .
.
При определённом значении ![]() потоки
потоки ![]() и
и ![]() сравняются, а коллекторный ток
сравняются, а коллекторный ток ![]() станет равным нулю. Из рис. 7.108 видно, что при
этом
станет равным нулю. Из рис. 7.108 видно, что при
этом ![]() , следовательно,
, следовательно, ![]() . Переход в активный режим
происходит при таком коллекторном смещении, когда
. Переход в активный режим
происходит при таком коллекторном смещении, когда ![]() (рис. 7.109).
(рис. 7.109).

Рис. 7.109
Распределение дырок в pnp - БТ при ![]() .
.
В этот момент ![]() , а коллекторный поток дырок
равен сумме сквозному потоку
, а коллекторный поток дырок
равен сумме сквозному потоку ![]() за вычетом рекомбинационного потока
за вычетом рекомбинационного потока ![]() . Этот поток (и ток) вытекают
из коллектора, то есть
. Этот поток (и ток) вытекают
из коллектора, то есть ![]() при
при ![]() или
или ![]() .
.
Семейство входных характеристик биполярного
транзистора в схеме ОЭ ![]() получим из третьего уравнения Эберса – Молла,
получим из третьего уравнения Эберса – Молла,
 (7.8.71)
(7.8.71)
Графики их показаны на рис. 7.110.

Рис. 7.110
Входные характеристики pnp – БТ в схеме ОЭ
7.8.6. БЫСТРОДЕЙСТВИЕ БИПОЛЯРНОГО ТРАНЗИСТОРА
Наряду со способностью усиливать сигналы,
характеризуемой коэффициентом усиления по току ![]() , важнейшим свойством
транзистора является его быстродействие. Оно характеризуется либо предельной
частотой сигнала
, важнейшим свойством
транзистора является его быстродействие. Оно характеризуется либо предельной
частотой сигнала ![]() , который ещё способен усилить
транзистор, либо так называемым временем установления
, который ещё способен усилить
транзистор, либо так называемым временем установления ![]() . Это время от подачи сигнала
на вход транзистора до установления его постоянного значения на выходе (рис.
7.111).
. Это время от подачи сигнала
на вход транзистора до установления его постоянного значения на выходе (рис.
7.111).

Рис. 7.111 К определению быстродействия
транзистора
Если период повторения импульсов ![]() превышает
превышает ![]() , то транзистор успеет воспроизвести и усилить такой
сигнал. Предельная частота равна обратному удвоенному времени установления,
, то транзистор успеет воспроизвести и усилить такой
сигнал. Предельная частота равна обратному удвоенному времени установления, ![]() . Частота повторения импульсов
. Частота повторения импульсов ![]() должна быть
меньше предельной частоты. Если
должна быть
меньше предельной частоты. Если ![]() , то выходной сигнал не успевает установиться и
усиление транзистора резко падает.
, то выходной сигнал не успевает установиться и
усиление транзистора резко падает.
Время установления ![]() зависит от
физических параметров транзистора и схемы его включения. Рассмотрим качественно
физические механизмы, определяющие быстродействие транзистора в схемах ОБ и ОЭ.
зависит от
физических параметров транзистора и схемы его включения. Рассмотрим качественно
физические механизмы, определяющие быстродействие транзистора в схемах ОБ и ОЭ.
7.8.6.1. БЫСТРОДЕЙСТВИЕ В СХЕМЕ ОБ
При ![]() в коллекторной
цепи течёт ток
в коллекторной
цепи течёт ток ![]() , базовый ток равен
, базовый ток равен
![]() . Входной сигнал подаётся в p-эмиттер в
виде импульса тока
. Входной сигнал подаётся в p-эмиттер в
виде импульса тока ![]() в момент
в момент ![]() . Инжектируемые в базу дырки и инжектируемые в эмиттер электроны нарушают нейтральность
базы. Для её восстановления из внешней цепи в базу втекают электроны, ток
которых
. Инжектируемые в базу дырки и инжектируемые в эмиттер электроны нарушают нейтральность
базы. Для её восстановления из внешней цепи в базу втекают электроны, ток
которых ![]() в точности
равен эмиттерному току. Равенство токов
в точности
равен эмиттерному току. Равенство токов ![]() сохраняется в
течение промежутка времени, равного времени пролёта базы
сохраняется в
течение промежутка времени, равного времени пролёта базы ![]() . При этом коллекторный ток по прежнему равен
. При этом коллекторный ток по прежнему равен ![]() , а базовый ток
, а базовый ток ![]() . В момент дырки
достигают коллекторного перехода, и начинается их экстракция в коллектор.
Суммарная скорость поступления дырок в базу резко уменьшается на
. В момент дырки
достигают коллекторного перехода, и начинается их экстракция в коллектор.
Суммарная скорость поступления дырок в базу резко уменьшается на ![]() . Базовый и коллекторный токи принимаю значения
. Базовый и коллекторный токи принимаю значения
![]()
После этого вплоть до окончания импульса токи остаются
неизменными. В момент ![]() эмиттерный ток
скачком падает до нуля, что эквивалентно обрыву эмиттерной цепи. Инжекция дырок
прекращается, экстракция же остаётся практически неизменной. Для поддержания
нейтральности базы накопленные в ней электроны должны уходить во внешний вывод
со скоростью, равной скорости экстракции
эмиттерный ток
скачком падает до нуля, что эквивалентно обрыву эмиттерной цепи. Инжекция дырок
прекращается, экстракция же остаётся практически неизменной. Для поддержания
нейтральности базы накопленные в ней электроны должны уходить во внешний вывод
со скоростью, равной скорости экстракции
![]() .Базовый ток вследствие этого скачком становится
равным
.Базовый ток вследствие этого скачком становится
равным
![]()
Коллекторный ток остаётся прежним. Эти значения токов
поддерживаются в течение времени ![]() , пока не будут экстрагированы все дырки. После этого
в коллекторной цепи протекает только обратный
ток коллекторного перехода, равный в
базовом выводе и в коллекторном выводе.
, пока не будут экстрагированы все дырки. После этого
в коллекторной цепи протекает только обратный
ток коллекторного перехода, равный в
базовом выводе и в коллекторном выводе.
Описанные резкие изменения токов имели бы место, если
бы все дырки пролетали бы базу за одинаковое время ![]() . В реальности существует разброс
. В реальности существует разброс ![]() времён пролёта
около среднего значения
времён пролёта
около среднего значения ![]() . Поэтому базовый и коллекторный токи плавно
изменяются на промежутках
. Поэтому базовый и коллекторный токи плавно
изменяются на промежутках ![]() и
и ![]() . Временные графики эмиттерного, базового и
коллекторного токов показаны на рис. 7.111.
. Временные графики эмиттерного, базового и
коллекторного токов показаны на рис. 7.111.

Рис. 7.111 Реакция pnp-БТ в
схеме ОБ на импульс
эмиттерного тока
Таким образом, для схемы ОБ время установления равно
времени пролёта базы,
![]()
Предельная частота определяется толщиной базы,
![]() (7.8.72)
(7.8.72)
У современных интегральных кремниевых транзисторов
толщина базы составляет ![]() . Подвижность дырок в кремнии
. Подвижность дырок в кремнии ![]() , а коэффициент диффузии
, а коэффициент диффузии ![]() . Тогда для
. Тогда для ![]() получаем оценку
получаем оценку
![]()
7.8.6.2. БЫСТРОДЕЙСТВИЕ В СХЕМЕ ОЭ
Будем считать, что через pnp-транзистор, находящийся в активном режиме, протекают
токи, определяемые рабочей точкой. Подадим в базу в момент ![]() импульс
входного тока
импульс
входного тока ![]() длительность
длительность ![]() . Вошедшие в
базу электроны понизят её потенциал и вызовут инжекцию дырок в таком же
количестве, то есть дырочная компонента эмиттерного тока получит приращение
. Вошедшие в
базу электроны понизят её потенциал и вызовут инжекцию дырок в таком же
количестве, то есть дырочная компонента эмиттерного тока получит приращение ![]() . Это равенство сохраняется в течение времени пролёта
базы дырками, при этом коллекторный ток остаётся неизменным,
. Это равенство сохраняется в течение времени пролёта
базы дырками, при этом коллекторный ток остаётся неизменным, ![]() . В момент
. В момент ![]() дырки начинают
экстрагироваться из базы – из каждых
дырки начинают
экстрагироваться из базы – из каждых ![]() инжектированных
дырок
инжектированных
дырок ![]() уходят в
коллектор. Так как базовый ток остаётся постоянным, то для поддержания
нейтральности базы должен возрасти эмиттерный ток. Рост его будет продолжаться
до достижения в базе такой концентрации
дырок, при которой скорость их рекомбинации будет равна
уходят в
коллектор. Так как базовый ток остаётся постоянным, то для поддержания
нейтральности базы должен возрасти эмиттерный ток. Рост его будет продолжаться
до достижения в базе такой концентрации
дырок, при которой скорость их рекомбинации будет равна ![]() или
или
![]() . Коллекторный ток получит при этом приращение
. Коллекторный ток получит при этом приращение ![]() .
После этого токи остаются постоянными до
окончания входного импульса. Это состояние достигается спустя
.
После этого токи остаются постоянными до
окончания входного импульса. Это состояние достигается спустя ![]() секунд после
прихода импульса базового тока. В момент
секунд после
прихода импульса базового тока. В момент ![]() базовый ток
скачком уменьшается на
базовый ток
скачком уменьшается на ![]() , следовательно, такой же скачок испытает и эмиттерный
ток. Оставшиеся в базе избыточные дырки и электроны не могут из неё уйти и рекомбинируют
в течение времени жизни
, следовательно, такой же скачок испытает и эмиттерный
ток. Оставшиеся в базе избыточные дырки и электроны не могут из неё уйти и рекомбинируют
в течение времени жизни ![]() . При этом вследствие уменьшения их концентрации
убывают токи
. При этом вследствие уменьшения их концентрации
убывают токи ![]() и
и ![]() . Временные графики базового, эмиттерного и
коллекторного токов показаны на рис. 7.112.
. Временные графики базового, эмиттерного и
коллекторного токов показаны на рис. 7.112.

Рис. 7.112 Реакция pnp-БТ в
схеме ОЭ на импульс
базового тока
Таким образом, в схеме ОЭ время установления равно ![]() . Соответственно, предельная частота равна
. Соответственно, предельная частота равна
![]() (7.8.73)
(7.8.73)
Так как ![]() , то
, то ![]() . Для отношения предельных частот находим
. Для отношения предельных частот находим
![]()
Для транзистора с
субмикронной базой

Следовательно, в
схеме ОБ быстродействие транзистора в ![]() раз выше, чем в схеме ОЭ.
раз выше, чем в схеме ОЭ.
При прочих равных условиях npn-транзистор будет более быстродействующим, чем pnp-транзистор,
так как подвижность электронов в, как правило, в несколько раз больше
подвижности дырок.
Дальнейшего повышения быстродействия транзистора можно
достичь, создав в базе электрическое поле, способствующее переносу носителей к
коллектору. Этот принцип реализуется в дрейфовых транзисторах.
7.8.6.2. ДРЕЙФОВЫЙ ТРАНЗИСТОР
В дрейфовом транзисторе легирующая примесь в базе распределена
неоднородно. У эмиттерного перехода её концентрация выше, чем у коллекторного
перехода. Такой профиль примеси получается при диффузии из источника с
постоянной поверхностной концентрацией. На рис. 7.113а показаны распределения
акцепторов ![]() и доноров
и доноров ![]() , сформированные в однородно легированной пластине n-типа с
концентрацией доноров
, сформированные в однородно легированной пластине n-типа с
концентрацией доноров ![]() . В точках
. В точках ![]() и
и ![]() концентрации
доноров и акцепторов сравниваются. В слое
концентрации
доноров и акцепторов сравниваются. В слое ![]() преобладают
доноры, в слое
преобладают
доноры, в слое ![]() выше
концентрация акцепторов, а при
выше
концентрация акцепторов, а при ![]() снова доноры в
большинстве. Эти слои образуют
транзисторную npn-структуру. Первый, самый сильнолегированный, служит
эмиттером, второй - базой, третий – коллектором. Разность концентраций доноров
и акцепторов показана на рис. 7.113б.
снова доноры в
большинстве. Эти слои образуют
транзисторную npn-структуру. Первый, самый сильнолегированный, служит
эмиттером, второй - базой, третий – коллектором. Разность концентраций доноров
и акцепторов показана на рис. 7.113б.
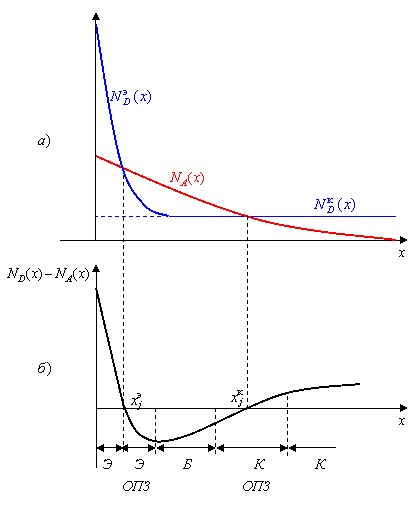
Рис 7.113 Распределение легирующей
примеси в
дрейфовом транзисторе
Точное решение задачи о диффузии примеси в
полубесконечный полупроводник имеет следующий вид,

где ![]() -
продолжительность процесса диффузии,
-
продолжительность процесса диффузии, ![]() - коэффициент
диффузии атомов примеси в полупроводнике. Оперировать с таким решением не очень
удобно, поэтому распределение не скомпенсированных акцепторов в p-базе аппроксимируют экспонентой
- коэффициент
диффузии атомов примеси в полупроводнике. Оперировать с таким решением не очень
удобно, поэтому распределение не скомпенсированных акцепторов в p-базе аппроксимируют экспонентой
![]()
где ![]() - параметр,
характеризующий скорость убывания акцепторов, их «диффузионная длина». Каждый акцептор
поставляет в базу одну дырку, поэтому вблизи эмиттера концентрация дырок
больше, чем вблизи коллектора. Под действием градиента концентрации он диффундируют от эмиттера к коллектору, в
результате у эмиттера образуется отрицательный пространственный заряд
акцепторов, а у коллектора – положительный пространственный заряд дырок. Эти пространственные
заряды создают электрическое поле
- параметр,
характеризующий скорость убывания акцепторов, их «диффузионная длина». Каждый акцептор
поставляет в базу одну дырку, поэтому вблизи эмиттера концентрация дырок
больше, чем вблизи коллектора. Под действием градиента концентрации он диффундируют от эмиттера к коллектору, в
результате у эмиттера образуется отрицательный пространственный заряд
акцепторов, а у коллектора – положительный пространственный заряд дырок. Эти пространственные
заряды создают электрическое поле ![]() , направленное от коллектора к эмиттеру. Оно создаёт
встречный дрейфовый дырочный ток. В состоянии равновесия полный ток равен нулю,
, направленное от коллектора к эмиттеру. Оно создаёт
встречный дрейфовый дырочный ток. В состоянии равновесия полный ток равен нулю,
![]()
Откуда находим
![]()
Параметр ![]() можно выразить
через концентрации акцепторов у эмиттера и коллектора,
можно выразить
через концентрации акцепторов у эмиттера и коллектора,
![]()
Таким образом, ![]()
В активном
режиме электроны, инжектированные в базу, будут переноситься к коллектору посредством
диффузии и дрейфа. Поэтому время полёта ![]() базы будет
меньше, чем при чисто диффузионном переносе. Его можно оценить из соотношения
базы будет
меньше, чем при чисто диффузионном переносе. Его можно оценить из соотношения
![]()
Скорость дрейфа ![]() равна
равна ![]() , тогда
, тогда

Если ![]() , то
, то ![]() , следовательно, предельная частота дрейфового
транзистора возрастает более чем вдвое.
, следовательно, предельная частота дрейфового
транзистора возрастает более чем вдвое.
7.8.7. ПРЕДЕЛЬНЫЕ РЕЖИМЫ И МАКСИМАЛЬНО ДОПУСТИМЫЕ
ПАРАМЕТРЫ ТРАНЗИСТОРА
Важным эксплуатационным свойством биполярного
транзистора является его надёжность. Она характеризуется так называемой наработкой
на отказ – временем безотказной работы в часах. Наработка на отказ зависит от
режима работы транзистора, то есть от токов и напряжений на входе и выходе.
Предельные режимы характеризуются такими токами и напряжениями, при которых ещё
обеспечивается заданная надёжность, но при их превышении транзистор выходит из
строя. Параметры режима связаны характеристиками транзистора. Поэтому для
каждого из них существует максимально допустимые значения ![]() и
и ![]() , соответствующие выходу на предельный режим. Они определяются максимально допустимой
температурой коллекторного перехода
, соответствующие выходу на предельный режим. Они определяются максимально допустимой
температурой коллекторного перехода ![]() . Сама же она
задаётся одним из требований:
. Сама же она
задаётся одним из требований:
- собственная концентрация носителей ![]() при этой
температуре должна быть меньше концентрации примеси в базе
при этой
температуре должна быть меньше концентрации примеси в базе ![]() ;
;
- напряжение теплового пробоя при этой температуре
должно превышать заданное значение.
При ![]() транзистор
утрачивает усилительные качества, так как обратные токи переходов становятся
сравнимыми с токами инжекции. Температуру
перехода к собственной проводимости найдём из условия
транзистор
утрачивает усилительные качества, так как обратные токи переходов становятся
сравнимыми с токами инжекции. Температуру
перехода к собственной проводимости найдём из условия
![]()
из которого после логарифмирования получим
![]() (7.8.74)
(7.8.74)
При преобразованиях использовались формулы ![]() . Введём новую переменную
. Введём новую переменную ![]() и перепишем
(7.8.74) в виде
и перепишем
(7.8.74) в виде
![]() (7.8.75)
(7.8.75)
где ![]() ,
, ![]() . Оценим А и В
для кремния при
. Оценим А и В
для кремния при ![]() .
.
![]() ,
, ![]()
Температура ![]() заведомо меньше
температуры плавления кремния
заведомо меньше
температуры плавления кремния ![]() , следовательно,
, следовательно, ![]() , а
, а ![]() . Поэтому уравнение (7.8.75) можно решить методом последовательных приближений.
Отбрасывая второе слагаемое в знаменателе, получаем в нулевом приближении,
. Поэтому уравнение (7.8.75) можно решить методом последовательных приближений.
Отбрасывая второе слагаемое в знаменателе, получаем в нулевом приближении,
![]()
Последующие приближения находим по формуле
![]() (7.8.76)
(7.8.76)

Процесс итераций сходится к значению ![]() . Таким образом, переход к собственной проводимости
происходит примерно при температуре
. Таким образом, переход к собственной проводимости
происходит примерно при температуре ![]() . Предельная температура
. Предельная температура ![]() коллекторного перехода,
в котором выделяется основное количество тепла, должно быть не выше этого
значения, а реально – примерно вдвое ниже, то есть около
коллекторного перехода,
в котором выделяется основное количество тепла, должно быть не выше этого
значения, а реально – примерно вдвое ниже, то есть около ![]() .
.
Это требование накладывает ограничение на предельную
мощность омических потерь ![]() в переходе. Она
не должна превышать предельную для данного транзистора скорость отвода тепла в
теплосток или внешнюю среду (рис. 7.114).
в переходе. Она
не должна превышать предельную для данного транзистора скорость отвода тепла в
теплосток или внешнюю среду (рис. 7.114).
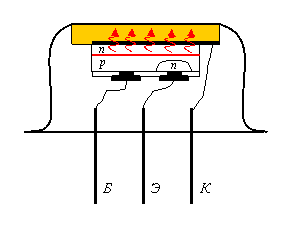
Рис. 7.114
Тепловые потоки в транзисторе
Скорость отвода тепла пропорциональна разности
температур коллектора ![]() и
теплостока
и
теплостока ![]() ,
,
![]()
или коллектора ![]() и окружающей среды
и окружающей среды ![]() ,
,
![]()
Параметры ![]() и
и ![]() суть
теплопроводности, а
суть
теплопроводности, а ![]() и
и ![]() - тепловые
сопротивления сборки. Таким образом, получаем уравнение предельных режимов в
плоскости
- тепловые
сопротивления сборки. Таким образом, получаем уравнение предельных режимов в
плоскости ![]() ,
,
![]() (7.8.77)
(7.8.77)
Оно позволяет очертить область допустимых активных
режимов биполярного транзистора.
Рассмотрим сначала включение в схеме с общей базой.
Минимальный коллекторный ток транзистора равен
![]() . Вычисленное по формуле (7.8.77) напряжение
. Вычисленное по формуле (7.8.77) напряжение ![]() , как правило, превышает напряжение пробоя
, как правило, превышает напряжение пробоя ![]() . Поэтому напряжение
. Поэтому напряжение ![]() задают на
уровне напряжения лавинного пробоя. Следовательно, соответствующий ему
максимальный ток равен
задают на
уровне напряжения лавинного пробоя. Следовательно, соответствующий ему
максимальный ток равен
Минимальное коллекторное напряжение близко к нулю,
следовательно, максимальный допустимый ток, вычисленный по формуле (7.8.77),
оказывается очень большим. Его ограничивают предельным эмиттерным током.
Область допустимых режимов биполярного транзистора в схеме ОБ показана на рис.
7.115.
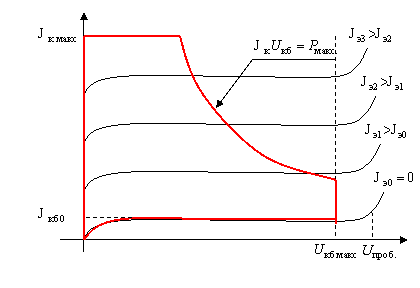
Рис. 7.115
Допустимые активные режимы биполярного транзистора
в схеме ОБ
В схеме ОЭ падение напряжения на эмиттерном переходе ![]() намного
меньше, чем на коллекторном переходе
намного
меньше, чем на коллекторном переходе ![]() , поэтому можно положить
, поэтому можно положить ![]() . Минимальный коллекторный ток равен сквозному току,
. Минимальный коллекторный ток равен сквозному току,
![]()
Максимальное коллекторное напряжени![]() е должно быть
меньше напряжения лавинного пробоя
е должно быть
меньше напряжения лавинного пробоя ![]() . Ему соответствует ток
. Ему соответствует ток ![]() . Минимальное коллекторное напряжение соответствует
выходу ВАХ на пологий участок. При этом
. Минимальное коллекторное напряжение соответствует
выходу ВАХ на пологий участок. При этом ![]() ,
, ![]() . Из уравнений
Эберса –Молла следует уравнение для тока, соответствующего минимальному
коллекторному напряжению,
. Из уравнений
Эберса –Молла следует уравнение для тока, соответствующего минимальному
коллекторному напряжению,
![]()
Область допустимых активных режимов в схеме ОЭ
показана на рис. 7.116.
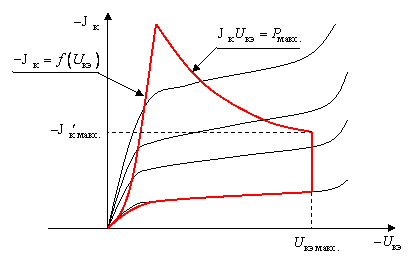
Рис. 7.116
Допустимые активные режимы биполярного транзистора
в схеме ОЭ
7.8.8. УСИЛЕНИЕ ТОКА В БИПОЛЯРНОМ ТРАНЗИСТОРЕ
Выше было показано, что при включении биполярного
транзистора по схеме ОЭ в активном режиме стационарный коллекторный ток связан
с базовым током соотношением (без учёта направления токов)
![]() (7.8.78)
(7.8.78)
Режим задаётся коллекторным напряжением ![]() и базовым током
и базовым током
![]() или
коллекторным током
или
коллекторным током ![]() . На плоскости
ему соответствует рабочая точка А
(рис. 7.117). Она лежит на пересечении выходной ВАХ
. На плоскости
ему соответствует рабочая точка А
(рис. 7.117). Она лежит на пересечении выходной ВАХ ![]() и вертикальной
прямой
и вертикальной
прямой ![]() .
.
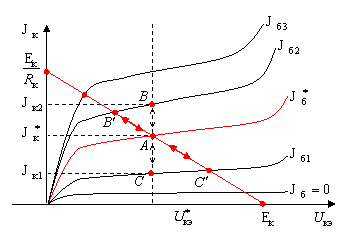
Рис. 7.117 Определение рабочей точки усилителя на БТ
Если входной базовый ток получит приращение ![]() , то коллекторный ток изменится на
, то коллекторный ток изменится на ![]() , причём, как следует из (7.8.78),
, причём, как следует из (7.8.78),
![]()
Изображающая точка
![]() движется при этом по пунктиру от А к
В. Так как
движется при этом по пунктиру от А к
В. Так как ![]() , то
, то ![]() . Это и есть усиление переменной составляющей входного
тока.
. Это и есть усиление переменной составляющей входного
тока.
Для выделения и дальнейшего использования усиленного
сигнала удобнее всего включить в коллекторную цепь нагрузочное сопротивление ![]() . Выходным сигналом является падение напряжения на нагрузке,
но снимается он с транзистора (рис. 7.118).
. Выходным сигналом является падение напряжения на нагрузке,
но снимается он с транзистора (рис. 7.118).

Рис. 7.118
Напряжение коллекторного источника питания ![]() делится между
транзистором и нагрузкой,
делится между
транзистором и нагрузкой,
![]()
Для переменных
составляющих имеем
![]()
При заданном напряжении коллекторного источника
питания ![]() и базовом токе
и базовом токе ![]() положение
рабочей точки А определяется сопротивлением
положение
рабочей точки А определяется сопротивлением
![]() . Найти её можно методом нагрузочной прямой, уже применявшимся
для анализа последовательных цепей с нелинейным элементом. Именно, запишем
(7.8.79) в виде
. Найти её можно методом нагрузочной прямой, уже применявшимся
для анализа последовательных цепей с нелинейным элементом. Именно, запишем
(7.8.79) в виде
![]()
![]()
Левая часть равенства есть ВАХ, правая – нагрузочная
прямая. Последняя также показана на рис.
7.117. При изменении базового тока от ![]() до
до ![]() точка,
соответствующая мгновенным значениям
точка,
соответствующая мгновенным значениям ![]() , движется по нагрузочной прямой от т.А до т.
, движется по нагрузочной прямой от т.А до т.![]() . Точке
. Точке ![]() соответствует ток
соответствует ток ![]() . При изменении базового тока от до
изображающая точка движется по нагрузочной прямой от т.А до т.
. При изменении базового тока от до
изображающая точка движется по нагрузочной прямой от т.А до т.![]() .
.
Сами точки ![]() и
и ![]() могут быть
выбраны в качестве рабочих точек, соответствующих входным токам
могут быть
выбраны в качестве рабочих точек, соответствующих входным токам ![]() и
и ![]() . Но такой выбор нецелесообразен, так как точка
. Но такой выбор нецелесообразен, так как точка ![]() лежит близко к
области режимов насыщения, а точка
лежит близко к
области режимов насыщения, а точка ![]() - близко к
области режимов отсечки. Поэтому при величине входного сигнала, превышающей
- близко к
области режимов отсечки. Поэтому при величине входного сигнала, превышающей ![]() или
или ![]() , транзистор окажется в оном из этих режимов и утратит
эти свойства. Это вызовет радикальное искажение формы выходного сигнала. Если,
например, входной сигнал есть синусоида
, транзистор окажется в оном из этих режимов и утратит
эти свойства. Это вызовет радикальное искажение формы выходного сигнала. Если,
например, входной сигнал есть синусоида ![]() , то при выборе
рабочей точки
, то при выборе
рабочей точки ![]() и
и ![]() выходной сигнал
будет состоять только из отрицательных полуволн.
выходной сигнал
будет состоять только из отрицательных полуволн.
В практических схемах задание рабочей точки
производится с помощью делителя коллекторного напряжения, подключенного параллельно
транзистору и нагрузке (рис. 7.119).

Рис. 7.119 Простейший резистивный усилитель на БТ
Рабочую точку на плоскости ![]() выбирают,
исходя из предполагаемой величины коллекторного напряжения. Базовый ток
выбирают,
исходя из предполагаемой величины коллекторного напряжения. Базовый ток ![]() связан с
падением напряжения
связан с
падением напряжения ![]() на резисторе
на резисторе ![]() посредством
входной характеристики транзистора. Используя её, по заданному
посредством
входной характеристики транзистора. Используя её, по заданному ![]() находим
находим ![]() , а затем из закона Ома
, а затем из закона Ома

получаем соотношение сопротивлений ![]() и
и ![]() .
.
На рис. 7.119 в эмиттерную цепь включён резистор ![]() . Его величина составляет обычно
. Его величина составляет обычно ![]() . Он выполняет важную функцию – нивелирует влияние
изменения температуры окружающей среды на усилитель. Физически это влияние
связано с двумя эффектами – зависимостью от температуры ширины запрещённой
зоны и
температурным размытием фермиевской функции распределения (увеличением доли энергичных электронов). С
ростом температуры
. Он выполняет важную функцию – нивелирует влияние
изменения температуры окружающей среды на усилитель. Физически это влияние
связано с двумя эффектами – зависимостью от температуры ширины запрещённой
зоны и
температурным размытием фермиевской функции распределения (увеличением доли энергичных электронов). С
ростом температуры ![]() убывает по
полуэмпирическому закону
убывает по
полуэмпирическому закону
![]()
где ![]() – постоянные
параметры. Вместе с запрещённой зоной убывает и величина потенциального барьера
p-n –перехода
– постоянные
параметры. Вместе с запрещённой зоной убывает и величина потенциального барьера
p-n –перехода ![]() , а это ведёт к росту тока инжекции. Размытие функции
распределения ведёт к возрастанию собственной концентрации
, а это ведёт к росту тока инжекции. Размытие функции
распределения ведёт к возрастанию собственной концентрации ![]() и, вместе с
ней, обратного тока коллекторного
перехода
и, вместе с
ней, обратного тока коллекторного
перехода ![]() . Вследствие
этих изменений рабочая точка смещается из заданного положения, что может
обусловить ухудшение и даже утрату транзистором усилительных свойств. Разность
потенциалов между базой и эмиттером
равна разности падений напряжений на резисторах
. Вследствие
этих изменений рабочая точка смещается из заданного положения, что может
обусловить ухудшение и даже утрату транзистором усилительных свойств. Разность
потенциалов между базой и эмиттером
равна разности падений напряжений на резисторах![]() и
и ![]() ,
,
![]() . При увеличении эмиттерного тока растёт падение
напряжения
. При увеличении эмиттерного тока растёт падение
напряжения ![]() , следовательно, уменьшается
, следовательно, уменьшается ![]() и ток инжекции.
На схемотехническом языке описанная причинно-следственная цепочка называется
отрицательной обратной связью.
и ток инжекции.
На схемотехническом языке описанная причинно-следственная цепочка называется
отрицательной обратной связью.
Ёмкость ![]() обеспечивает
усиление только переменной составляющей входного сигнала, ёмкость
обеспечивает
усиление только переменной составляющей входного сигнала, ёмкость ![]() выделяет
усиленную переменную составляющую выходного сигнала, а ёмкость
выделяет
усиленную переменную составляющую выходного сигнала, а ёмкость ![]() обеспечивает
обратную связь только по постоянной составляющей коллекторного тока.
обеспечивает
обратную связь только по постоянной составляющей коллекторного тока.
7.9. ПОЛЕВЫЕ ТРАНЗИСТОРЫ
7.9.1.
ОСНОВНЫЕ ИДЕИ И ОПРЕДЕЛЕНИЯ
Рассмотренные в §7.8 биполярные транзисторы
характеризуются следующими родовыми особенностями:
1.
Для их
функционирования важны как основные, так и неосновные носители заряда. Именно
поэтому транзисторы называются биполярными.
2.
Передача тока с
входа (из эмиттера) на выход (в коллектор) осуществляется посредством инжекции,
диффузии, сопровождающейся рекомбинацией, и экстракции ННЗ.
3.
Управление
выходным током осуществляется посредством входного тока. Поэтому биполярный транзистор
есть прибор с токовым управлением.
Перечисленные
особенности определяют как достоинства, так и недостатки биполярных
транзисторов.
Быстродействие транзистора лимитировано либо временем
жизни ННЗ (в схеме ОЭ), либо временем пролёта базы (в схеме ОБ). Возможности
его повышения за счёт уменьшения толщины базы ограничены.
Конечный входной ток обуславливает бесполезные потери
энергии. Это понижает коэффициент полезного действия биполярных транзисторов и
ограничивает их применение в интегральных схемах.
От этих недостатков свободны полевые транзисторы (ПТ) - полупроводниковые
приборы, в которых управление выходным током осуществляется посредством
модуляции проводимости канала электрическим полем. Структурная схема ПТ показана
на рис. 7.117. Прибор представляет собой
полупроводниковый слой - канал - с проводимостью n- или p-типа. По краям канала созданы два омических контакта,
между которыми приложено напряжение ![]() , создающее электрический ток. Контакт, из которого вытекают носители, называется истоком и
обозначается буквой И (по-английски source - S). Контакт, в который втекают носители,
называется стоком, он обозначается буквой С (по-английски drain - D). Токи во внешних выводах называются истоковым
, создающее электрический ток. Контакт, из которого вытекают носители, называется истоком и
обозначается буквой И (по-английски source - S). Контакт, в который втекают носители,
называется стоком, он обозначается буквой С (по-английски drain - D). Токи во внешних выводах называются истоковым ![]() и
стоковым
и
стоковым ![]() . Между истоком и стоком сформирован третий контакт –
затвор З (по-английски gate - G).
Приложенное между ним и истоком напряжение
. Между истоком и стоком сформирован третий контакт –
затвор З (по-английски gate - G).
Приложенное между ним и истоком напряжение ![]() модулирует проводимость
канала, а, следовательно, перераспределяет напряжение источника питания
модулирует проводимость
канала, а, следовательно, перераспределяет напряжение источника питания ![]() между каналом и
нагрузочным сопротивлением
между каналом и
нагрузочным сопротивлением ![]() . Падение напряжения на
. Падение напряжения на ![]() есть выходное
напряжение.
есть выходное
напряжение.

Рис.
7.117 Структурная схема полевого транзистора
Таким образом, модулируя проводимость канала, можно
управлять выходным напряжением. В полевых транзисторах используются эффективные
механизмы модуляции проводимости, позволяющие получить изменения выходного
напряжения ![]() , значительно превосходящие вызвавшие их изменения
входного напряжения
, значительно превосходящие вызвавшие их изменения
входного напряжения ![]() . Это позволяет усиливать напряжение, но усиления по току
полевые транзисторы не дают.
. Это позволяет усиливать напряжение, но усиления по току
полевые транзисторы не дают.
Эти идеи восходят к Джулиусу Лилиенфельду, предложившему и запатентовавшему в 20-е годы
прошлого века конструкцию полевого транзистора в виде плоского конденсатора с
полупроводниковой обкладкой (рис.
7.118).

Рис. 7.118 Полевой транзистор
Лилиенфельда
В
металлическую обкладку конденсатора поле не проникает вследствие высокой
концентрации свободных электронов в ней. В полупроводнике концентрация
свободных носителей на несколько порядков меньше, чем в металле, поэтому поле
проникает на некоторую глубину ![]() . В зависимости
от полярности затворного напряжения поле
. В зависимости
от полярности затворного напряжения поле ![]() либо
притягивает носители из внешней цепи и обогащает ими слой толщиной
либо
притягивает носители из внешней цепи и обогащает ими слой толщиной ![]() , либо отталкивает их во внешнюю цепь и обедняет этот
слой. В результате проводимость канала
, либо отталкивает их во внешнюю цепь и обедняет этот
слой. В результате проводимость канала ![]() изменяется.
Оценим влияние этого изменения на ток с помощью простых соображений. Пусть канал
толщиной
изменяется.
Оценим влияние этого изменения на ток с помощью простых соображений. Пусть канал
толщиной ![]() и длиной
и длиной ![]() однородно
легирован донорами, так что концентрация электронов равна
однородно
легирован донорами, так что концентрация электронов равна ![]() . Проводимость его на единицу ширины при
. Проводимость его на единицу ширины при ![]() будет
будет
![]()
При
![]() поле
уменьшает на
поле
уменьшает на ![]() концентрацию
электронов в слое
концентрацию
электронов в слое ![]() . Теперь канал можно рассматривать как две параллельные
проводимости
. Теперь канал можно рассматривать как две параллельные
проводимости
![]()
![]()
Полная его проводимость равна
![]()
Под действием э.д.с. источника ![]() в канале
протекает ток
в канале
протекает ток
![]()
создающий
на сопротивлении ![]() падение
напряжения
падение
напряжения

Если
обеспечить такую глубину модуляции, что ![]() , то множитель при
, то множитель при ![]() будет очень
большим, так что сопротивлением нагрузки в знаменателе можно пренебречь,
будет очень
большим, так что сопротивлением нагрузки в знаменателе можно пренебречь,
![]()
Приращение
выходного напряжения вследствие модуляции проводимости канала равно
![]()
Откуда
получаем выражение для коэффициента
усиления по напряжению
![]()
Концентрация
носителей в канале очень сильно зависит от затворного напряжения, поэтому
производная весьма велика, так что,
выбирая сопротивление ![]() достаточно
большим, не составляет труда получить значительное усиление напряжения.
достаточно
большим, не составляет труда получить значительное усиление напряжения.
Однако во времена Лилиенфельда эта идея не была
реализована по двум причинам.
Во-первых, тогда полупроводники ещё только входили в
электронику. Технология получения монокристаллов была очень несовершенна.
Минимальная толщина пластины составляла ![]() , а уровень легирования фоновыми примесями - порядка
, а уровень легирования фоновыми примесями - порядка
![]() . Лучше чистить полупроводники и целенаправленно
легировать их физики и химики не умели. Поэтому глубина проникновения поля равнялась
. Лучше чистить полупроводники и целенаправленно
легировать их физики и химики не умели. Поэтому глубина проникновения поля равнялась
![]() , а отношение
, а отношение ![]() . Изменение
. Изменение ![]() вследствие этого
получалось столь малым, что не представляло практического интереса.
вследствие этого
получалось столь малым, что не представляло практического интереса.
Во-вторых, даже столь слабая модуляция проводимости не
была обнаружена экспериментально. Причина этого обставалась непонятой в течение
четверти века, пока её не выяснили в 1954 году американские физики Аллен и
Гобелли. Оказалось, что на свободной поверхности полупроводника (Ален и Гобели
работали с кремнием) существует огромное число так называемых поверхностных
состояний (ПС) - ловушек, способных захватывать и удерживать носители. Если
поверхностные ловушки захватывают электроны из объёма, то они называются
акцепторными ПС. Плотность ПС ![]() достигает
достигает ![]() . А изменение числа электронов в поверхностном слое на
единицу площади при модуляции канала равно
. А изменение числа электронов в поверхностном слое на
единицу площади при модуляции канала равно ![]() . Так как
. Так как ![]() , то любые изменения концентрации носителей компенсируются
за счёт их освобождения с ПС или захвата на ПС. В результате проводимость канала
остаётся неизменной.
, то любые изменения концентрации носителей компенсируются
за счёт их освобождения с ПС или захвата на ПС. В результате проводимость канала
остаётся неизменной.
Из сказанного следует, что для создания работоспособного полевого транзистора необходимо решить две
задачи – избавиться от поверхностных состояний и научиться создавать
полупроводниковые каналы толщиной ![]() . Предложены и реализованы два способа их решения, и,
соответственно два типа полевых транзисторов.
. Предложены и реализованы два способа их решения, и,
соответственно два типа полевых транзисторов.
7.9.2. ПОЛЕВЫЕ ТРАНЗИСТОРЫ С УПРАВЛЯЮЩИМ
p-n –ПЕРЕХОДОМ (ПТУП)
Первое решение было найдено У. Шокли на основе
радикального принципа «есть свободная поверхность – есть проблема, нет свободной
поверхности – нет проблемы». Он предложил ограничивать канал не физической
поверхностью полупроводника, а границей ОПЗ p-n
– перехода (рис. 7.119).
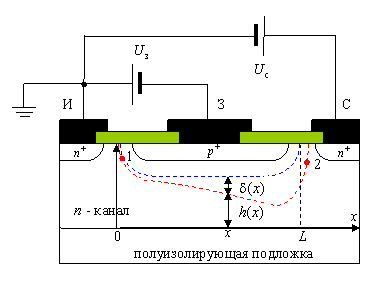
Рис. 7.119 Полевой транзистор Шокли
![]() На высокоомной (полуизолирующей) подложке выращивается
слой полупроводника n-типа. В нём создаются два высоколегированных
На высокоомной (полуизолирующей) подложке выращивается
слой полупроводника n-типа. В нём создаются два высоколегированных ![]() кармана –
исток и сток. Между ними формируется несимметричный
кармана –
исток и сток. Между ними формируется несимметричный ![]() –переход, практически вся ОПЗ которого располагается в
n- области.
Каналом является слой между высокоомной ОПЗ и подложкой. Его равновесная
толщина h, длина L. Модуляция проводимости осуществляется обратным смещением
–переход, практически вся ОПЗ которого располагается в
n- области.
Каналом является слой между высокоомной ОПЗ и подложкой. Его равновесная
толщина h, длина L. Модуляция проводимости осуществляется обратным смещением ![]() перехода
перехода ![]() , который поэтому называется управляющим. Увеличивая
толщину ОПЗ , мы тем самым уменьшаем
сечение канала
, который поэтому называется управляющим. Увеличивая
толщину ОПЗ , мы тем самым уменьшаем
сечение канала ![]() , а, значит, увеличиваем его сопротивление
, а, значит, увеличиваем его сопротивление
![]()
При
некотором значении ![]() ОПЗ полностью
перекроет канал, и его сопротивление станет очень большим, практически
бесконечным.
ОПЗ полностью
перекроет канал, и его сопротивление станет очень большим, практически
бесконечным.
Но, оказывается, проводимость канала может
модулироваться не только затворным, но и стоковым напряжением. Физика этого
эффекта такова.
Толщина ОПЗ в сечении
![]() определяется
разностью потенциалов между
определяется
разностью потенциалов между ![]() -
областью и n-каналом. Если
-
областью и n-каналом. Если ![]() - потенциал
канала в сечении x, а – потенциал
- потенциал
канала в сечении x, а – потенциал ![]() -
области, то
-
области, то

В
состоянии равновесия, при , ОПЗ
симметрична относительно средины канала, так как потенциал в любой его точке равен нулю, а потенциал ![]() -
области равен диффузионному потенциалу с обратным
знаком. Тогда
-
области равен диффузионному потенциалу с обратным
знаком. Тогда ![]() , а
, а
![]()
Граница
равновесной ОПЗ показана на рисунке синим пунктиром.
При протекании тока под действием стокового напряжения
![]() канал
становится неэквипотенциальным. В точке 1 его потенциал практически равен
потенциалу истока (нулю), а в точке 2 он равен
канал
становится неэквипотенциальным. В точке 1 его потенциал практически равен
потенциалу истока (нулю), а в точке 2 он равен
![]() . В точке x потенциал принимает промежуточное значение
. В точке x потенциал принимает промежуточное значение ![]() . Локальная толщина теперь определяется разностью потенциалов
. Локальная толщина теперь определяется разностью потенциалов ![]() . Она равна равновесной толщине вблизи истока и
монотонно увеличивается к стоку. Толщина канала, соответственно, уменьшается от
истока к стоку. Профиль канала при
. Она равна равновесной толщине вблизи истока и
монотонно увеличивается к стоку. Толщина канала, соответственно, уменьшается от
истока к стоку. Профиль канала при ![]() показан на
рисунке красным пунктиром. Если же
показан на
рисунке красным пунктиром. Если же ![]() , то локальная толщина ОПЗ будет равна
, то локальная толщина ОПЗ будет равна
![]() (7.9.1)
(7.9.1)
Следуя У.
Шокли, получим аналитическую зависимость стокового тока от стокового и
затворного напряжений при следующих предположениях:
1. Канал однородно легирован, следовательно, ![]() ;
;
2. Канал длинный, следовательно, продольное поле,
созданное стоковым напряжением, слабое
по сравнению с полем в ОПЗ;
3.
Запишем
падение напряжения на слое ![]() при протекании
тока
при протекании
тока ![]() . Оно равно
. Оно равно
![]() (7.9.2)
(7.9.2)
![]() - сопротивление
слоя. Подставив
- сопротивление
слоя. Подставив ![]() в закон Ома
(7.9.2.) перепишем его в виде
в закон Ома
(7.9.2.) перепишем его в виде
![]()
Локальную
толщину канала ![]() можно выразить
через потенциал с помощью формулы
(7.9.1),
можно выразить
через потенциал с помощью формулы
(7.9.1),

где
введено обозначение ![]() . Таким образом,
. Таким образом,
 (7.9.3)
(7.9.3)
Проинтегрируем
(7.9.3) по длине канала, рассматривая как независимую переменную в левой части
– координату x, а в правой части - локальный потенциал ![]() :
:

Так
как ![]() ,
, ![]() ,
, ![]() , то после интегрирования получаем
, то после интегрирования получаем

Это
и есть семейство стоковых ВАХ ПТУП. Их принято записывать в виде
 (7.9.4)
(7.9.4)
где
![]() - характерный
ток,
- характерный
ток, ![]() - сопротивление
канала толщиной
- сопротивление
канала толщиной ![]() .
.
Зависимость
стокового тока от стокового напряжения при фиксированном затворном напряжении
называется стоковой характеристикой.
График семейства стоковых характеристик показан на рис. 7.120.

Рис.
7.120 Стоковые ВАХ ПТУП
Такое
поведение полностью согласуется с изложенными выше качественными
представлениями. При малых стоковых напряжениях
профиль канала, а, значит, и его сопротивление, остаётся приблизительно
постоянным, поэтому ток линейно зависит от напряжения. Дифференцируя (7.120),
получим
 (7.121)
(7.121)
Из
(7.121) следует, что линейность сохраняется до тех пор, пока можно пренебречь
квадратным корнем по сравнению с единицей, или пока
![]()
Оценим
характерное напряжение ![]() и диффузионный потенциал
и диффузионный потенциал ![]() . Положим
. Положим ![]() ,
, ![]() ,
, ![]() ,
, ![]() , тогда
, тогда

![]()
Таким
образом, линейная зависимость тока от напряжения сохраняется примерно до ![]() .
.
При более высоких напряжениях сопротивление канала
начинает расти, вследствие чего рост тока замедляется. При некотором напряжении ![]() ток выходит на
насыщение. Условие насыщения получаем из (7.121)
ток выходит на
насыщение. Условие насыщения получаем из (7.121)

Откуда ![]() (7.122)
(7.122)
Подставив (7.122) в (7.119), получим

Из
(7.9.4) следует, что при ![]() ,
то есть канал полностью перекрыт. Этого, однако,
не может быть, так как ток растёт вплоть до
,
то есть канал полностью перекрыт. Этого, однако,
не может быть, так как ток растёт вплоть до ![]() и не равен при
этом напряжении нулю. Поэтому заключаем, что сама формула (7.9.4) становится не
справедливой при
и не равен при
этом напряжении нулю. Поэтому заключаем, что сама формула (7.9.4) становится не
справедливой при ![]() . Более точная модель проводимости должна предложить
физический механизм, препятствующий полному перекрытию канала. Такой механизм
действительно есть. Это – зависимость подвижности электрона от ускоряющего
электрического поля. С увеличением напряжённости
поля
. Более точная модель проводимости должна предложить
физический механизм, препятствующий полному перекрытию канала. Такой механизм
действительно есть. Это – зависимость подвижности электрона от ускоряющего
электрического поля. С увеличением напряжённости
поля ![]() частота
рассеяния электрона на атомах возрастает, причём этот рост нелинеен – сначала
частота столкновений растёт пропорционально
частота
рассеяния электрона на атомах возрастает, причём этот рост нелинеен – сначала
частота столкновений растёт пропорционально ![]() , а затем – пропорционально
, а затем – пропорционально ![]() . Причина этого кроется в тонких деталях взаимодействия
свободного электрона с колеблющимися атомами полупроводника. Увеличение частоты
столкновений эквивалентно уменьшению среднего времени свободного пробега
. Причина этого кроется в тонких деталях взаимодействия
свободного электрона с колеблющимися атомами полупроводника. Увеличение частоты
столкновений эквивалентно уменьшению среднего времени свободного пробега ![]() . Средняя дрейфовая скорость электрона равна
. Средняя дрейфовая скорость электрона равна
![]()
В
сильных полях ![]() , поэтому скорость становится независящей от поля,
, поэтому скорость становится независящей от поля, ![]() . Полевую зависимость дрейфовой скорости электронов в
кремнии описывают полуэмпирической зависимостью
. Полевую зависимость дрейфовой скорости электронов в
кремнии описывают полуэмпирической зависимостью

где
![]() - подвижность
электрона в слабом электрическом поле. График её показан на рис. 7.121. В
кремнии
- подвижность
электрона в слабом электрическом поле. График её показан на рис. 7.121. В
кремнии ![]() ,
, ![]() .
.

Рис. 7.121
Зависимость дрейфовой скорости электрона от поля
В канале ПТУП наиболее сильное поле создаётся в самом
узком месте вблизи стока. Как только оно достигнет значения ![]() , ток
, ток ![]() перестаёт
расти. При дальнейшем увеличении стокового напряжения
сужение канала до минимальной толщины
перестаёт
расти. При дальнейшем увеличении стокового напряжения
сужение канала до минимальной толщины ![]() распространяется по направлению к истоку
(рис. 7.122).
распространяется по направлению к истоку
(рис. 7.122).
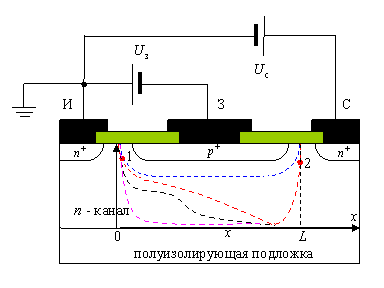
Рис. 7.122. Деформация канала ПТУП при стоковых напряжениях,
бόльших напряжения отсечки
7.9.3. МОП –
ТРАНЗИСТОРЫ
В МОП – транзисторах воплощено второе решение проблемы
поверхностных состояний в приборе Лилиенфельда. Оно состоит в заполнении
воздушного промежутка конденсатора диэлектриком и, следовательно, замене
свободной поверхности полупроводника поверхностью раздела
полупроводник-диэлектрик. Это решение предложили в 1960 году американцы Д. Канн
и М.М. Аттала. Использование диэлектрика целесообразно, если на его границе с
полупроводником плотность поверхностных состояний ![]() не
превышает
не
превышает ![]() . К концу 1950-х годов основным материалом электроники
стал кремний. Сочетание его свойств оказалось поистине уникальным. В частности,
при термическом окислении на поверхности кремния образуется плёнка
. К концу 1950-х годов основным материалом электроники
стал кремний. Сочетание его свойств оказалось поистине уникальным. В частности,
при термическом окислении на поверхности кремния образуется плёнка ![]() с плотностью
поверхностных состояний на границе оксид-полупроводник, удовлетворяющей
указанному условию. После напыления на оксид слоя металла получается МОП (Металл-Оксид-Полупроводник) - конденсатор, один из четырёх базовых
элементов электроники. МОП-конденсатор является основным элементом
МОП-транзистора. К краям конденсатора примыкают два сильнолегированных кармана
с проводимостью, противоположной проводимости подложки. Один из них является истоком,
другой – стоком. Если исток и сток соединить областью с тем же типом
проводимости, то образуется МОП-транзистор
с встроенным, или нормально открытым каналом (рис. 7.123).
с плотностью
поверхностных состояний на границе оксид-полупроводник, удовлетворяющей
указанному условию. После напыления на оксид слоя металла получается МОП (Металл-Оксид-Полупроводник) - конденсатор, один из четырёх базовых
элементов электроники. МОП-конденсатор является основным элементом
МОП-транзистора. К краям конденсатора примыкают два сильнолегированных кармана
с проводимостью, противоположной проводимости подложки. Один из них является истоком,
другой – стоком. Если исток и сток соединить областью с тем же типом
проводимости, то образуется МОП-транзистор
с встроенным, или нормально открытым каналом (рис. 7.123).
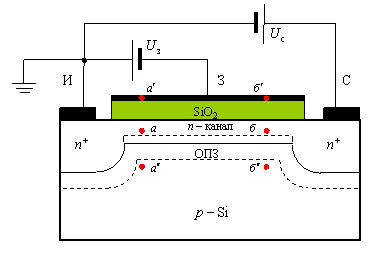
Рис. 7.123 МОП-транзистор с встроенным n-каналом
Методом
ионной имплантации можно создать канал толщиной
![]() .
.
Если истоковый и стоковый карманы не соединены каналом
с тем же типом проводимости, то получается МОП-транзистор
с индуцированным, или нормально закрытым, каналом (рис. 7.124).
Под действием одного только стокового напряжения ![]() в
МОП-транзисторе с встроенным каналом, как и в ПТУП, течёт стоковый ток
в
МОП-транзисторе с встроенным каналом, как и в ПТУП, течёт стоковый ток ![]() . При малых
. При малых ![]() зависимость
зависимость ![]() омическая, так
как канал однороден. Однако с увеличением стокового напряжения начинает
сказываться его неэквипотенциальность. Потенциал монотонно возрастает от нуля
вблизи истока до
омическая, так
как канал однороден. Однако с увеличением стокового напряжения начинает
сказываться его неэквипотенциальность. Потенциал монотонно возрастает от нуля
вблизи истока до ![]() вблизи стока. Соответственно
возрастают и разности потенциалов
вблизи стока. Соответственно
возрастают и разности потенциалов ![]() и
и ![]() между каналом
и затвором и каналом и подложкой, так как
потенциалы затвора, подложки и истока равны нулю.
между каналом
и затвором и каналом и подложкой, так как
потенциалы затвора, подложки и истока равны нулю.
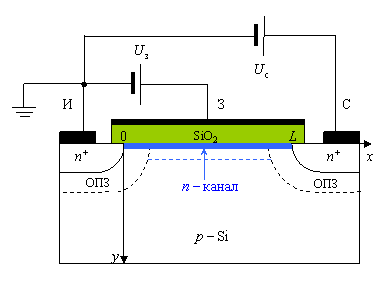
Рис.
7.124 МОП-транзистор с индуцированным n-каналом
В
сечении ![]()
![]() , в
сечении
, в
сечении ![]()
![]() . Поэтому происходит расширение ОПЗ в канал как со
стороны подложки, так и со стороны диэлектрика (рис.7.125).
. Поэтому происходит расширение ОПЗ в канал как со
стороны подложки, так и со стороны диэлектрика (рис.7.125).
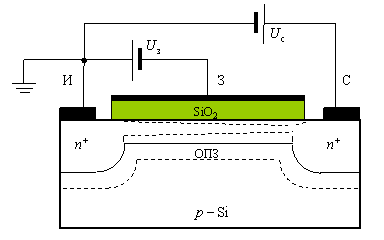
Рис.
7.125 МОП-транзистор в триодном режиме
Этот
эффект полностью аналогичен деформации канала ПТУП. Следствием его является
замедление роста тока. При стоковом напряжении, большем характерного напряжения
отсечки ![]() ток растёт
линейно, но скорость роста намного меньше, чем на омическом участке ВАХ (рис.
7.126).
ток растёт
линейно, но скорость роста намного меньше, чем на омическом участке ВАХ (рис.
7.126).

Рис.
7.126 Стоковые ВАХ МОП-транзистора
с
встроенным n-каналом
Подача
на затвор отрицательного смещения
приведёт к дополнительному однородному сужению канала со стороны
диэлектрика и, следовательно, к уменьшению стокового тока. Напряжение отсечки
при этом монотонно уменьшается.
Рассмотрим теперь процессы в МОП-транзисторе с
индуцированным каналом.
В направлении оси
вблизи границы раздела ![]() имеем
имеем ![]() - структуру.
Она эквивалентна двум встречно включенным диодам, поэтому при стоковых
напряжениях
- структуру.
Она эквивалентна двум встречно включенным диодам, поэтому при стоковых
напряжениях ![]() , меньших напряжения пробоя
, меньших напряжения пробоя ![]() - перехода и
- перехода и ![]() стоковый ток
пренебрежимо мал. Но при положительных затворных напряжениях к границе раздела
будут притягиваться из полупроводника неосновные носители – электроны, а
основыне носители – дырки – будут отталкиваться от поверхности в объём. При
некотором значении затворного напряжения
стоковый ток
пренебрежимо мал. Но при положительных затворных напряжениях к границе раздела
будут притягиваться из полупроводника неосновные носители – электроны, а
основыне носители – дырки – будут отталкиваться от поверхности в объём. При
некотором значении затворного напряжения
![]() плотность
электронов в приповерхностном слое превысит плотность дырок. Это явление
называется инверсией типа проводимости.
Дальнейшее увеличение затворного напряжения приведёт к обогащению приповерхностного
слоя электронами и образованию канала n-типа, соединяющего исток и сток. Толщина этого канала
составляет всего
плотность
электронов в приповерхностном слое превысит плотность дырок. Это явление
называется инверсией типа проводимости.
Дальнейшее увеличение затворного напряжения приведёт к обогащению приповерхностного
слоя электронами и образованию канала n-типа, соединяющего исток и сток. Толщина этого канала
составляет всего ![]() , поэтому он является практически двумерным. Электроны
в канале образуют двумерный электронный газ (2МЭГ – по-русски, 2DEG –
по-английски). Свойства двумерного электронного газа существенно отличаются от
свойств электронов в объёмном полупроводнике. Движение поперёк канала является
финитным (ограниченным) и, следовательно, энергия поперечного движения
, поэтому он является практически двумерным. Электроны
в канале образуют двумерный электронный газ (2МЭГ – по-русски, 2DEG –
по-английски). Свойства двумерного электронного газа существенно отличаются от
свойств электронов в объёмном полупроводнике. Движение поперёк канала является
финитным (ограниченным) и, следовательно, энергия поперечного движения ![]() квантуется, то
есть принимает только некоторые дискретные значения
квантуется, то
есть принимает только некоторые дискретные значения ![]() . При реальных параметрах канала в нём имеется не
более трёх уровней размерного квантования (
. При реальных параметрах канала в нём имеется не
более трёх уровней размерного квантования (![]() ). Движение вдоль канала ничем не ограничено (инфинитно),
поэтому энергия продольного движения изменяется непрерывно. Таким образом,
число доступных для электрона состояний движения в канале намного меньше, чем в
объёме полупроводника. Следовательно, у электрона меньше возможностей перейти в
другое состояние с потерей энергии. Это обстоятельство выражается в значительно большей подвижности двумерного
электронного газа по сравнению с объёмными электронами. Несмотря на небольшую
толщину, инверсный канал способен пропускать значительный ток.
). Движение вдоль канала ничем не ограничено (инфинитно),
поэтому энергия продольного движения изменяется непрерывно. Таким образом,
число доступных для электрона состояний движения в канале намного меньше, чем в
объёме полупроводника. Следовательно, у электрона меньше возможностей перейти в
другое состояние с потерей энергии. Это обстоятельство выражается в значительно большей подвижности двумерного
электронного газа по сравнению с объёмными электронами. Несмотря на небольшую
толщину, инверсный канал способен пропускать значительный ток.
Стоковое напряжение модулирует проводимость канала.
Физический механизм модуляции можно наглядно представить как вытягивание
электронов из канала в стоковую ![]() -область. В результате плотность их в пристоковой
части канала понижается, а его толщина уменьшается. При стоковом напряжении
-область. В результате плотность их в пристоковой
части канала понижается, а его толщина уменьшается. При стоковом напряжении ![]() толщина канала
вблизи стока становится равной нулю, а при
толщина канала
вблизи стока становится равной нулю, а при ![]() между истоком и
стоком образуется обеднённая область с проводимостью p-типа (рис.
7.127). Ток при этом растёт медленно и линейно. Увеличение затворного
напряжения повышает плотность носителей в канале и, следовательно, стоковый
ток. Семейство стоковых характеристик МОП-транзистора с индуцированным n-каналом
показано на рис. 7.128.
между истоком и
стоком образуется обеднённая область с проводимостью p-типа (рис.
7.127). Ток при этом растёт медленно и линейно. Увеличение затворного
напряжения повышает плотность носителей в канале и, следовательно, стоковый
ток. Семейство стоковых характеристик МОП-транзистора с индуцированным n-каналом
показано на рис. 7.128.
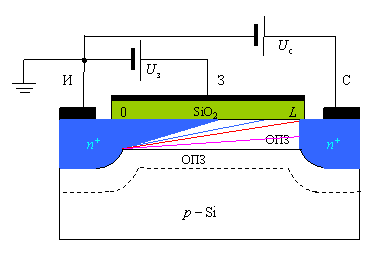
Рис. 7.127 Модуляция индуцированного n-канала
МОП-транзистора.
Цветом показаны инвертированной
части канала при
![]() (---);
(---);![]() (---);
(---);![]() (---);
(---);![]() (---).
(---).

Рис. 7.128 Стоковые ВАХ
МОП-транзистора
с
индуцированным n-каналом
Зависимость
стокового тока от затворного напряжения называется стокозатворной или передаточной
характеристикой полевого транзистора.